走査電子顕微鏡にナノプローブを搭載
半導体不良箇所特定はSEMの時代へ
65nm 世代の微細プロセスに対応した電気特性の評価や、抵抗異常個所などの検出を、「ナノマニピュレーション法」や「電子ビーム吸収電流法」などを用いて不良箇所の固定を行う半導体故障解析装置です。
特長
試料照射電流を大きく可変させることが可能なため、吸収電流の少ない試料においても、画質の良い吸収電流像を得ることが可能です。
不良箇所特定手法として、吸収電流(電流、電圧)検出法、電位コントラスト法、EBIC 法等の多様な機能を搭載しています。
電子線アシストによるマーキング機能を搭載、0.1µm の配線にも正確にマーキング可能です。
CAD ナビゲーションシステムの搭載可能

90nm プロセス製品 (配線 Open)解析事例
A) 実製品(7 層)レイアウト図から吸収電流を得るための PAD を最上層に作成
B) レイアウト図の配線パターンと、吸収電流像の配線パターンを比較し、異常箇所を検出
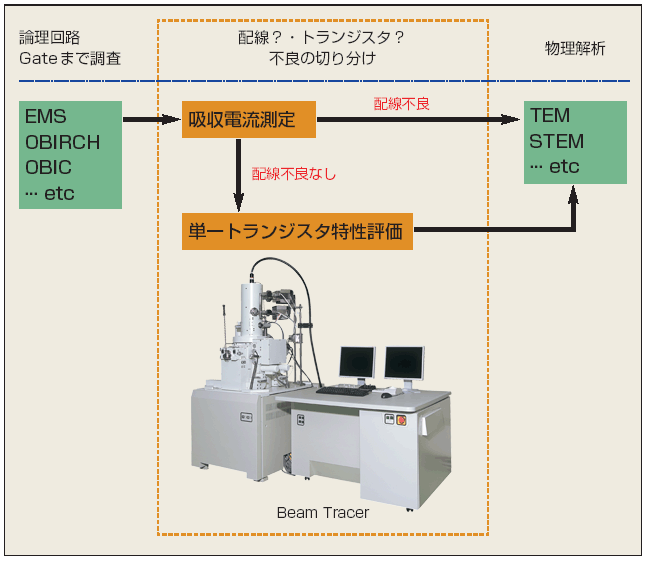
故障解析フロー例

マーキング例
不良箇所特定後に任意の箇所に微小で正確なマーキングを行うことにより、その後の物理解析の位置出しを容易にします。

測定画面例
左:二次電子像、右:吸収電流像
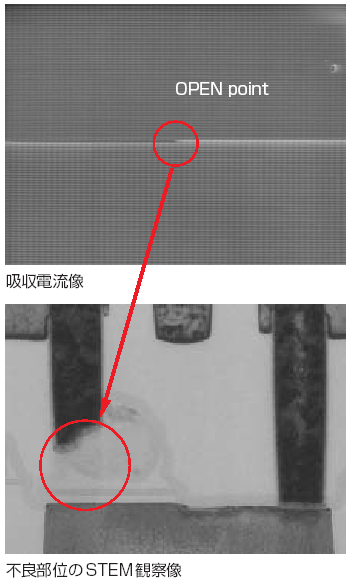
OPEN 箇所不良解析事例
仕様・オプション
| 観察系 | |
|---|---|
| プローピング時二次電子像分解能 | 3nm (加速電圧 15kV) |
| プロービング時 WD | 10mm |
| 倍率 | ×25~500,000 |
| 像の種類 | 二次電子像、吸収電流像、EBIC 像、他 |
| 加速電圧、照射電流 | 0.5~30kV、10-12~2×10-7A |
| プローブ系 | |
| 駆動距離 | X,Y 20mm
Z 15mm |
| 最小移動ステップ | 5nm以下 |
| 試料サイズ | チップ 20×20mm (最大) |

