研究開発に適した電子ビーム蒸着装置です。
様々なオプション機構を追加することで幅広い用途に使用可能です。
蒸着源は、電子ビーム蒸着源(電子銃)、ボンバード蒸着源、抵抗加熱蒸着源を選択できます。
電子銃とボンバード蒸着源、電子銃と抵抗加熱源の組み合わせも可能です。
特長
電子ビーム蒸着源 (電子銃)
抵抗加熱や誘導加熱では蒸発させることができない高融点金属や、熱伝導率の低い酸化物・昇華性材料など、様々な無機材料を蒸発させることができます。
水冷銅ルツボ内の蒸着材料を電子ビームで直接加熱するため、ルツボとの反応がありません。
高速で出力制御ができるため、抵抗加熱ではできない精密な膜厚制御や蒸着レート制御が可能です。
スパッタリングやCVDと比較し、成膜レートが1桁以上高く、1µm以上の厚膜成膜も容易です。
電子銃やルツボ、電子銃電源は選択できます。標準的なEBG-102UB6S電子銃は高速スキャン機能を有し、12ml×6点ルツボが付属しています。

EBG-102UB6S
電子銃と反射電子トラップの組み合わせ
電子銃と反射電子トラップを組み合わせることで、基板に入射する反射電子量を著しく低減させられます。
反射電子を低減させることで、以下の効果が見込めます。
基板温度の上昇を抑制できます。レジストパターン上に蒸着するリフトオフプロセスに向いています。
反射電子ダメージの影響を受けやすい基材や下地層への成膜に向いています。
密着性が向上します。
電子ビーム蒸着時のレジストの変形は、反射電子入射による温度上昇が原因です。
反射電子トラップにより、反射電子を抑制し、安定したリフトオフ蒸着が可能になります。MEMS 等の電極膜形成に最適です。
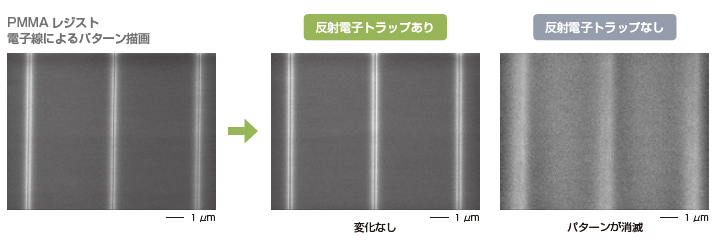
ボンバード蒸着源
蒸着材料を充填したライナーの裏面に、電子ビームを照射し、電子衝撃 (ボンバード)によりライナーを加熱します。
蒸着材料には直接電子ビームを当てません。間接加熱方式のため、以下の特長があります。
反射電子やX線のダメージを抑える事ができます。
通常の電子ビーム蒸着では、スプラッシュの発生しやすい蒸着材料でも、低欠陥成膜できます。
間接加熱のため、電子ビームを照射すると分解されてしまう蒸着材料でも、分解・組成ずれがありません。
蒸着材料の分解がないため、光学吸収が少ないです。
電子ビームによる間接加熱のため、レート制御できます。抵抗加熱に比べて安定成膜できます。
高融点金属など、蒸着材料に制約があります。
ボンバード方式による加熱原理 (イメージ図)

製品情報
抵抗加熱蒸着源 (オプション)
最大2基、搭載可能です(電源出力:3kW)。
2基同時蒸着はできません。
基板ホルダー
ご希望の基板サイズ・枚数に合わせて、基板ホルダーを製作します。
[製作例]
中心駆動基板ホルダー回転 (平板式)
最大φ4インチ基板 × 4枚セット可プラネタリ式基板ホルダー回転
自公転ユニット × 3箇所 (各ユニットに2インチ基板3枚セット可)
付け替えて使用することができます。
基板寸法・基板枚数の変更、基板加熱、基板冷却、基板ホルダー傾斜等も対応できます。

平板基板ホルダー

プラネタリードーム
制御系
(標準)水晶式膜厚コントローラーによる自動成膜
膜厚コントローラーに成膜プロセスをプログラミングし、成膜速度や膜厚を高精度に制御できます。
水晶膜厚センサーは、シングルセンサー、デュアルセンサーから選択可能です。
マニュアル操作によるビーム出力も可能です。
タッチパネルから以下の操作が行えます。
全自動排気
ルツボ駆動や基板回転機構の制御と状態表示
各種インターロック / アラームの状態表示

RF電源 (オプション)
RF電源 RF-12010 (750W)
プラズマを発生させ、イオンプレーティング成膜を行うことができます。密着性や膜密度を向上させ、高機能膜薄膜を成膜することができます。
a) コイル式:電子銃ルツボ~基板間にコイルを配置
b) 基板印加式:基板ホルダーにRF 印加
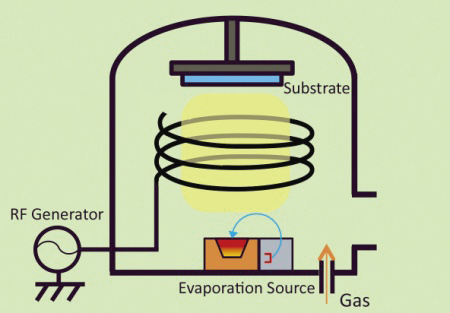
コイル式
光学式膜厚モニター (オプション)
光学式膜厚モニターを取り付けることができます。
フィルター切り替え式、グレーティング式の選択が可能です。
ハースライナー (オプション)
ルツボ容量を変更できるライナーを取り付け可能です。
ハースライナーで断熱効果を持たせることにより、低出力でも一定の蒸着レートが得られやすくなります。
アルミニウムを繰り返し蒸着できるライナーもあります。
ロードロック (オプション)
蒸着室を真空に保ちながら基板交換を可能にします。
搬入・搬出室にセットした基板を蒸着室へ、スイッチ操作にて自動制御でセット可能です。
カスタム仕様 (オプション)
お客様仕様に合わせて製作できますので、別途ご相談ください。
仕様・オプション
仕様

| 項目 | ボックスタイプ | ベルジャータイプ | 多元同時蒸着タイプ | 連続巻取タイプ (Roll to Roll) |
|---|---|---|---|---|
| 蒸発源(標準) | EBG-102UB6S 電子銃 ×1 JST-10F 電子銃電源 ×1 |
EBG-102UB6S 電子銃 ×1 JST-10F 電子銃電源 ×1 |
EBG-203UB6S電子銃 ×2 JST-10F電子銃電源 ×1 |
JEBG-303UA電子銃 ×1 JST-16F電子銃電源 ×1 |
| 蒸発源(オプション) | 抵抗加熱 ×2 | 抵抗加熱 ×2 | 抵抗加熱 ×3 | ボンバード蒸着源 |
| チャンバー寸法 | φ500mm × 770mmH | φ500mm × 500mmH | φ750mm × 1,000mmH | W 695mm × D 520mm × H 975mm |
| 搭載品 | 水晶式膜厚コントローラー | 水晶式膜厚モニター |
水晶式膜厚コントローラー 基板加熱機構
|
(オプション) 水晶式膜厚コントローラー |
| 基板ホルダー | 中心駆動式基板回転(平板) プラネタリ式基板回転 |
φ200mm平面基板 | 中心駆動式基板回転(平板) | 基材幅:130mm 最大巻径:φ150mm |
| 真空性能 | 到達圧力:8 × 10-5Pa 以下、成膜圧力:5 × 10-2Pa 以下 | |||
| 排気系 | ターボ分子ポンプ (1,400L/sec) ×1、ロータリーポンプ ×1 | 油拡散ポンプ ×1 メカニカルブースターポンプ ×1 ロータリーポンプ ×1 |
油拡散ポンプ ×1 ロータリーポンプ ×1 (オプション)ターボ分子ポンプ クライオパネル |
|
| 設置寸法 | W 2,000mm × D 1,000mm × H 2,200mm | W 1,800mm × D 1,000mm × H 2,450mm | W 4,000mm × D 4,000mm × H 2,500mm | W 2,400mm × D 1,300mm × H 1,900mm |
| 総質量 | 1,200kg 以下 | 約 960kg | 2,500kg | 1,200kg 以下 |
搭載機器仕様や真空チャンバー寸法などお客様仕様にて製作が可能です。別途ご相談ください。
オプションにつきましては、特長に詳細を記載しております。
カタログダウンロード
ギャラリー

関連製品

反射電子トラップ
電子ビーム蒸着過程では、蒸着材料に入射した電子の一部が反射電子(後方散乱電子)として放出され、基板に到達すると基板へのダメージや温度上昇、膜の密着性低下等に繋がる場合があります。反射電子トラップは、電子銃と組み合わせて基板に入射する反射電子量を著しく低減させられるユニットです。既設の蒸着装置に後付けすることも可能です。
反射電子を低減させることで、以下の効果が見込めます。
基板温度の上昇を抑制できます。レジストパターン上に蒸着するリフトオフプロセスに向いています。
反射電子ダメージの影響を受けやすい基材や下地層への成膜に向いています。
密着性が向上します。