
FEATURE
試料作製から観察分析までの
円滑な作業を提供
FIB加工機能の充実、新鏡筒採用によるSEM観察性能の本質的な向上、連携機能強化による操作性改善を実現
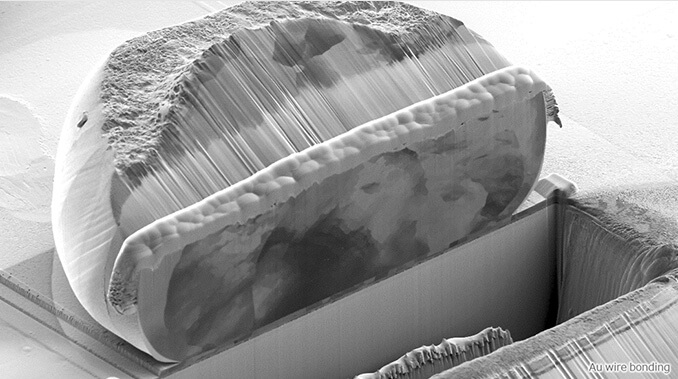
FIB:加工機能の充実
- ・制御系の刷新
ベクタースキャンにより任意形状を美しく加工安定した三次元観察・分析を容易に - ・最大90 nA の大電流
試料の高速加工を提供
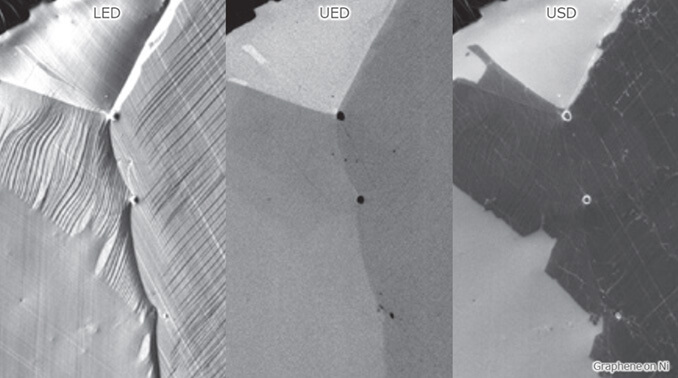
SEM : 新鏡筒による性能向上
- ・低加速高分解能化
ハイブリッドコニカル対物レンズとGENTLEBEAM™の採用により低加速条件で高い分解能(1 kV/1.6 nm)を達成 - ・多様な像取得
新たにUED/USD検出器を追加。物性・化学組成・結晶構造などを反映した多様なSEM像取得が可能に
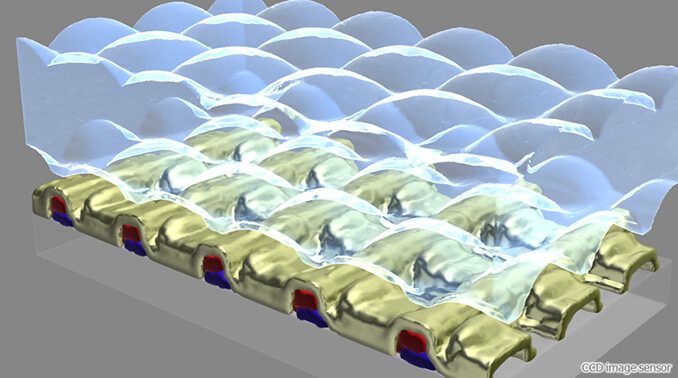
3D : 三次元観察&解析
- ・制御系の刷新
ベクタースキャンにより任意形状を美しく加工安定した三次元観察・分析を容易に - ・最大90 nA の大電流
試料の高速加工を提供
APPLICATION
FIB-SEM ならではの
多彩なソリューション
断面試料作製、TEM試料作製、三次元観察、三次元EDS、三次元EBSD、微細形状加工など多様なアプリケーションを提供
Cross Section
複合ビーム加工装置であるJIB-4700F を用いると保護膜の作製・試料のミリング・断面の観察と分析を一貫して行うことができます。
FIB 鏡筒は最大90 nA のGa イオンビーム照射による加工ができます。大電流での加工は、特に大領域の試料作製に威力を発揮します。
TEM Sample
JIB-4700F とマニピュレータシステムの組み合わせによりTEM試料作製がスムーズに行えます。
スループットを損わずに、FIB加工中の状況を高分解能FE-SEMでモニターできます。TEM用の薄膜試料作成時の終点検出、深さ方向の最適化等効率の良い作業を提供します。
3D-EDS Analysis
試料表面垂直に入射したFIB による加工とSEM ビームを利用したEDS 分析を自動で連続的に行います。
SEM 鏡筒は、大電流においても高い分解能を維持しますので、高速なEDS分析が可能です。
3D-EBSD Analysis
ユニークな配置のEBSD 検出器*がステージ移動のない加工と分析を可能にします。そのため、時間短縮と高いデータ位置精度が実現します。
※オプションアッチメント