試料作製をサポートするソフトウェア機能
IB2020-03
複合ビーム加工観察装置JIB-4700Fのグラフィカルユーザーインターフェース(GUI)は、SEM、FIB両方の操作がしやすいように設計されており、装置の性能が最大限に引き出せる。SEM、FIBの機能は色分けされており、ひと目で分かるようにデザインされている。表示モードは4画面表示(Fig.2)、2画面表示(Fig.1)、1画面表示と必要に応じて切り替えられ、4画面表示により複数の検出器による画像を同時に表示できる。一度の走査で各検出器の画像取得が同時に行える。それにより、試料の特徴を逃がさず捉えられ、試料にあった適切な試料作製が可能となる。

Fig.1 JIB-4700FのGUI(2画面表示)
左側: FIB観察像。TEM薄片試料を上方から観察。
右側: SEM観察像。TEM薄片試料の断面を観察。
FIB加工中のようすをSEM像で観察できるので、加工終点を逃さず捉えられる。

Fig.2 JIB-4700FのGUI(4画面表示)
左上: SEM LED像: 凹凸が観察される。右上: FIB LED像
左下: SEM UED像: 組成が観察される。右下: SEM USD像: 表面情報が観察される。
UED: 上方検出器、USD*: 上方二次電子検出器
ステージナビゲーションシステム*
試料ホルダー全体のカラー写真(Fig.3)を撮り、視野探しに利用できる。写真上で目的の場所をダブルクリックするとステージがその位置に移動する。
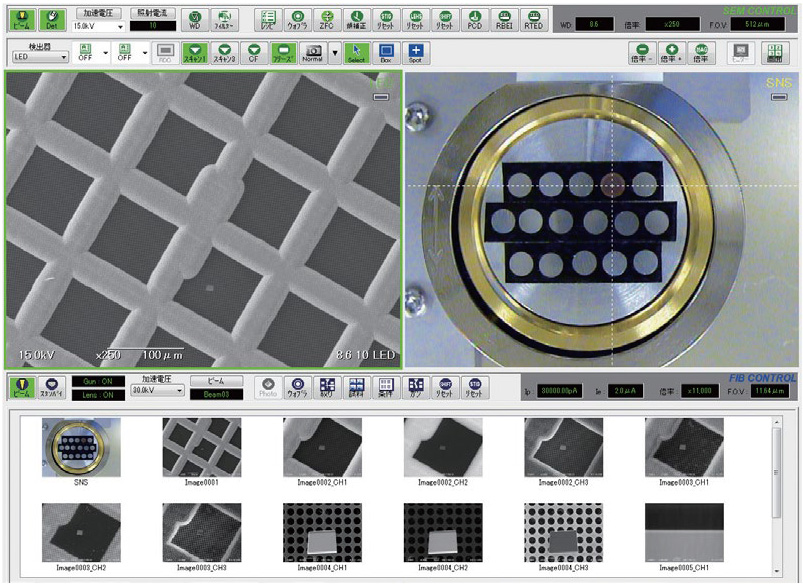
Fig.3 ステージナビゲーションシステム
ピクチャーオーバーレイソフトウェア
光学顕微鏡など他の観察装置で取得した画像を観察像に重ねることができる(Fig.4)。SEM像やFIB像では識別できない試料部位であっても、容易に加工位置決めが可能である。
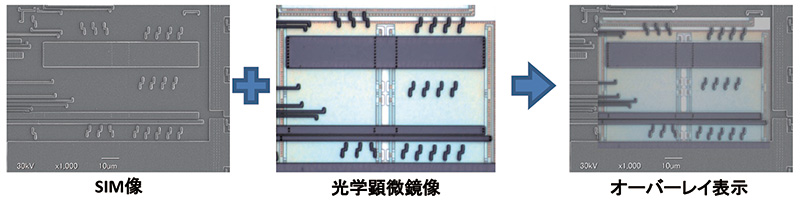
Fig.4 ピクチャーオーバーレイソフトウェア
* オプションアタッチメント
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 724.4KB
