超高分解能を実現した“原子分解能電子顕微鏡JEM-ARM300F”の開発
日本電子 news Vol.46 No.5
沢田 英敬、奥西 栄治、志村 直軌、佐藤 一仁、森下 茂幸、佐々木 健夫、神保 雄、河野 祐二、細川 史生、成瀬 達雄、湯浅 修一、有馬 則和、脇俊 作、片境 浩二、小林 正明、田中 宏典、田中 裕之、外山 勝弘、近藤 行人、金山 俊克
日本電子(株)EM事業ユニット
はじめに
電子顕微鏡において収差補正装置が具現化[1,2]されて以来、原子分解能での構造解析や化学分析がより広く実施されるようになった。2006年から始まった分解能50pmを目指したJST CREST R005プロジェクト(プロジェクトリーダー:高柳邦夫教授)において、装置開発に参画し、最高加速電圧300kVの安定化冷陰極電界放出型電子銃、高分解能鏡筒、安定化電源、高分解能用収差補正装置、収差補正制御ソフト等を開発し[3,4]、従来の分解能を超える観察[5,6]や、STEM環状明視野観察法による軽元素カラムの検知結果[7]を報告してきた。このように収差補正技術が成熟していく中で、2009年にはSTEM収差補正装置を標準搭載した最高加速電圧200 kVの原子分解能分析電子顕微鏡JEM-ARM200F(分解能80pm)を“汎用機”として開発した。 JEM-ARM200Fはサブオングストロームを切る構造解析能力および高感度原子分解能分析技術を有し、世界の科学者によって様々な応用データが数多く取得されている。
今回我々は、R005とJEM-ARM200Fで培った収差補正技術・原子分解能技術を礎に、さらに分解能の高い最高加速電圧300kVの原子分解能電子顕微鏡JEM-ARM300Fを開発した。本装置にSTEM収差補正装置を搭載した場合、保証分解能は63pmである(保証分解能としては世界最高)。安定度や分解能の向上により、単により細かい構造解析が可能になるだけでなく、より定量的な解析や信頼性の高いデータ取得が可能となる。本報告では、開発した装置の特長や基本的な性能データを紹介する。
開発装置の特徴と性能
Fig.1(a)は、開発したJEM-ARM300Fの外観である。最高加速電圧が従来より高いだけでなく光学系や排気系等の総合的な性能がARMシリーズ最高峰 であることから“GRAND ARM”の愛称で呼んでいる。Fig.1(c)は装置の構成概要であり、Fig.1(d)は真空系概要を示している。

【Fig. 1 (a)原子分解能JEM-ARM300Fの外観。(b)冷陰極電界放出型電子銃のフラッシング後,トータルエミッション10 μAに設定した後のプローブ電流の変化(赤)を測定したグラフ。水色の線はトータルエミッション値で、この減少率も参考値として示した。(c)JEM-ARM300Fの構成概要図。(d)JEM-ARM300Fの真空系統図。】
高性能冷陰極電界放出型電子銃(HyperCF 300)
加速電圧300kVの電子源としては、高輝度・低色収差を実現するため、冷陰極電界放出型電子銃(HyperCF300:High performance cold field emission gun for accelerating voltage of 300kV)を標準で装備している。冷陰極電子銃を安定に駆動するためには、吸着ガスが生み出すエミッション電流の不安定要因を低減する必要があり、従来のショットキー型電界放出電子銃に比べて、より高い真空度が必要となっている[8]。本電子銃は、エミッター付近に装備した排気速度の大きい非蒸散型ゲッターポンプ(NEG:Non evaporative getter pump)、加速管部を排気する排気速度200L/sのスパッタイオンポンプ、カラムからのガス流入を防ぐための第一中間室SIP(SIP Int1)に加えて、電子銃側に第二中間室SIP(SIP Int2)を装備して,差動排気系を構成している[Fig.1(d)]。これにより、カラムから電子銃へのガス流入が極端に少なくなり、電子線の電流の安定駆動が可能となった。フラッシング後、エミッション電流 10μAに設定後、電流の安定度を測定し、Fig.1(b)に示した。縦軸は測定初めの電流に対する割合で示されている。赤線で示すように、ガス吸着により電流が減少しているもののフラッシング4H後でも90%以上の電流が保持されており、安定度が向上した冷陰極電子銃源を実現している。コンディショニングの操作は手動ではなくGUIから行えるように、モーター駆動のコンディショニングロッドが標準装備されており、メンテナンスに必要なアノードショートを自動的に行うことが可能である。
6-SIPs&TMP 排気系
電子顕微鏡鏡筒部においては、Stage部を排気する排気速度150L/sのSIPに加えて、コンデンサーレンズ部(CL)と、中間レンズ部(IL)に、それぞれ差動排気を実現するためのSIPを装備している[Fig.1(d)]。IL部のSIPは、像観察室(Detecting Chamber)からStage部へのガス導入を防ぎ、CL部のSIPは電子銃部に対するカラム部からのガス流入をさらに下げる目的で導入している。試料予備排気、鏡筒部粗排気、Bake時の排気系はターボ分子ポンプ(TMP: Turbo molecular pump)を動作させるシークエンスとなっており、試料排気やカラムのドライ排気を実現し、真空の質を向上させている(本TMPは、検鏡時には停止)。さらに、オプションで像観察室を排気する油拡散ポンプ(DP: Diffusion pump)もTMPに変更可能である。以上の排気系により、試料排気部のSIPでは2 ~ 10×10-6 Paの圧力、冷陰極電子銃の加速管下部では、4 ~ 10×10-9 Paの圧力が実現できている。このように冷陰極電界放出型電子銃を搭載した高真空電子顕微鏡には6個のSIPからなる6-SIPs&TMP排気系が有効である。
軌道拡張型12極子球面収差補正装置(ETA Corrector)
JEM-ARM300FはSTEM(照射系)およびTEM(結像系)に、球面収差補正装置がオプションで装備できる。この補正装置は、R005プロジェクトで開発した軌道拡張型12極子球面収差補正装置(ETA Corrector: Expanding Trajectory Aberration Corrector)[9]で あ る(Fig.2)。ETA Correctorは、厚みの違う12極子を2段装備し、これにより試料に近づくにつれて軌道が拡張する光学系を実現している。軌道拡張により、前段の光学要素が作る擾乱要因や色収差やノイズ等が試料面上で縮小される光学系であり、分解能を阻害する要因を試料に対して小さくすることが出来る。12極子は3回非点の強度と大きさを自由に変更できる特性を持つので残留3回非点を補正できる。また、二段の12極子の間のクロスオーバー位置に偏向器が置かれているため、微細な2回非点をビーム移動や他の収差への影響なしに独立に補正することが可能である。

【Fig. 2 ETA Corrector の構造と収差補正光学系(a)12極子(Dodeca-pole)の模式図。(b)光学系模式図。二枚の12極子の厚みが異なることが特徴で、試料に近づくにつれて電子線の軌道が広がる。ETAのギリシャ文字ηは、厚みの異なる二枚の多極子も模式的に示している。(c)照射系の光学系、TLLはTransfer lens long、TLRはTransfer lens rotation、TLSはTransfer lens shortを示している。CMTは転送コンデンサーミニレンズを示す。(d) 結像系の光学系。OMTは転送対物ミニレンズを表す。】
幅広い加速電圧
JEM-ARM300Fでは、加速電圧300kVと80kVが標準であり、すべての装置において出荷前にこれらの加速電圧での調整が行われる。Fig.3(a)は、加速電圧300kVにて [211]方向から観察したGaN 結晶のHAADF(高角度環状暗視野)STEM観察像である。63pmのGa-Ga原子間隔を明瞭に分離観察できている。Fig.4(a)は加速電圧300kVで観察したβ-Si3N4の高分解能観察TEM像であり、SiからSub-Å離れたNの位置を明瞭に分離できている。このように300kVは超高分解能観察に有効である。Fig.3(c)は加速電圧80kVで観察したグラフェンの暗視野STEM観察、Fig.4(b)は高分解能TEM観察例であり、ソフトマテリアル材料観察には低加速での観察が(ダメージ低減のため)適する。単色性の高い冷陰極電界放出型電子銃による色収差を抑えた低色収差イメージングは低加速において有効であり高分解能観察を可能にしている。さらに、オプションとして160kVの加速電圧設定を用意している。Fig.3(b)は、加速電圧160kVにて観察したSi多結晶試料の観察例である。半導体系試料においては、十分な透過能と分解能を兼ね備えた加速電圧160kVでの観察・分析が有効である。
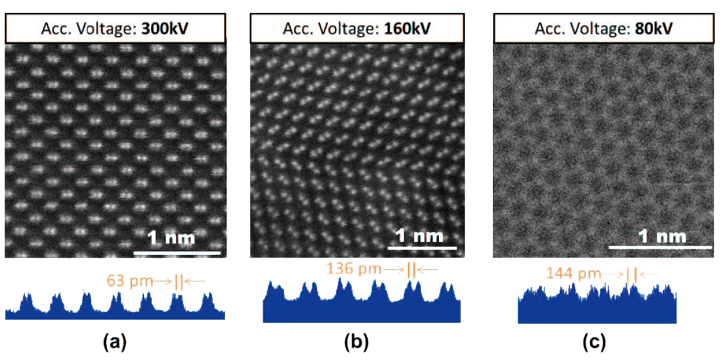
【Fig. 3 高分解能暗視野STEM像(Raw data) (a)加速電圧300 kVで観察したGaN [211] (b)加速電圧160 kVで観察したSi(111)Σ3結晶粒界 (c)加速電圧80 kVで観察したグラフェン(炭素原子一層)。それぞれの像の下に強度ラインプロファイルを示した。】
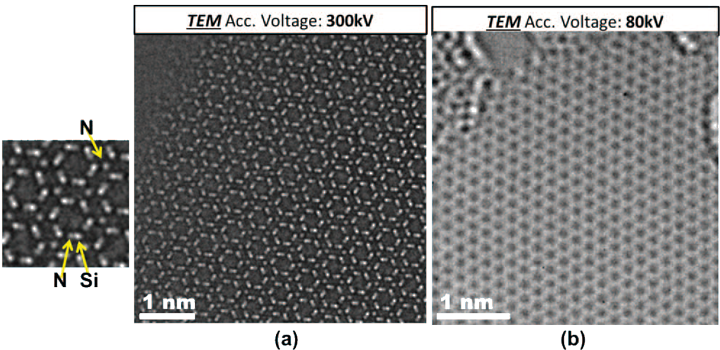
【Fig. 4 高分解能TEM (Raw data)(a)加速電圧300 kVで観察したβ-Si3N4の高分解能像。左側に拡大像を示す。(b)加速電圧80 kVで観察したモノレイヤーのグラフェンの高分解能像。両者とも過焦点での観察であるので、白いコントラストが原子位置に相当する。】
新しく設計した二つの対物レンズと超高分解能観察
EM-ARM300Fに対して、我々は二つの新しい対物レンズポールピースを設計・開発した(<1>超高分解能構成FHP: full high resolution pole pieceと <2>高分解能分析構成WGP: wide gap pole piece)。FHPは色収差が小さい対物レンズであり、球面収差補正することでサブÅの超高分解能を達成した。FHP対物レンズを含む照射系の色収差は、(加速電圧300kVにおいて)1.35mmと非常に小さい値 (従来比65%)である。WGPは、分析性能を強化した対物レンズでEDSの検出立体角が大きく、また厚さのある特殊ホルダーの利用も対応できるようにギャップ間のスペースが大きいのが特徴である。
Fig.5は、超高分解能構成の対物レンズを使い加速電圧300kVにて観察した超高分解能暗視野STEM像である。(a)136pm Si-Siダンベル、(b)82pm Ge-Geダンベル、(c)78pm Ge-Geダンベル、(d)63pm Ga-GaダンベルとSub-Åのダンベルを明瞭に分離できていることを実証した。さらに、Sub-50pmの原子間隔を分解することを検証するためにGeとSi結晶を[114]方位から観察し、Sub-50pmの分解能をSTEM像で達成した[6,10,11]。これらの結果を(e-f)に示す。場所による違いがあるものの、47pmと45pmの分離が確認できる。これらの像のフーリエ変換のPower spectrumでは、それぞれのダンベルに相当するスポットを確認し、ラインプロファイル(Fig.5(e-f)の右図)でもダンベルの分離を確認している[12]。
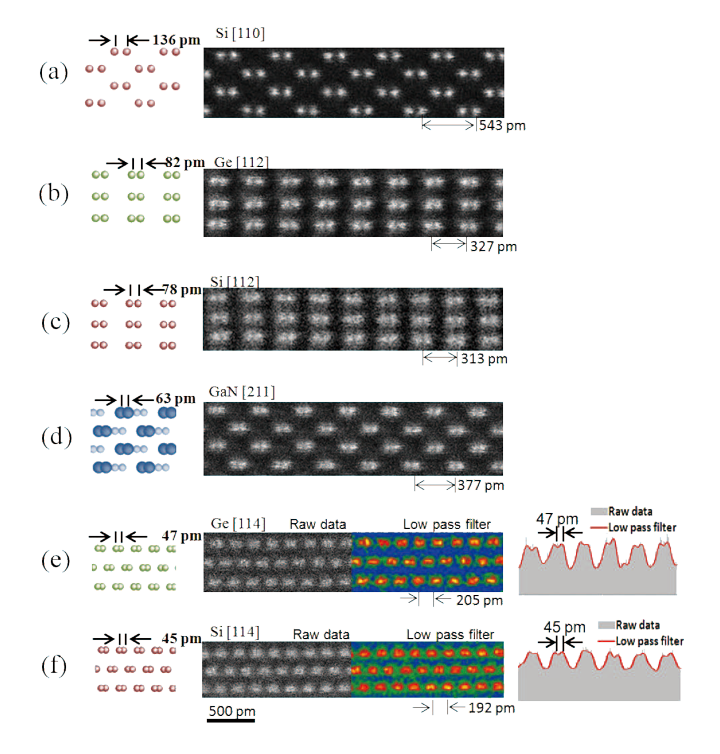
【Fig. 5 加速電圧300 kVで観察した高分解能暗視野STEM像 <Raw data> (a)Si[110]試料。(b)Ge[112]。(c)Si[112]。(d)GaN[211]。(e)Ge[114]。(f)Si[114]。それぞれのダンベル間隔を左の構造模式図で示している。】
おわりに
新規に開発した原子分解能電子顕微鏡JEM-ARM300Fの特長と超高分解能性能を中心に述べた。300kV、160kVおよび80kVという幅広い加速電圧で、冷陰極電界放出型電子銃を用いた色収差の少ない原子分解能のイメージングが可能であることを実証した。本装置が、超高分解能装置のプラットフォームとして幅広く世界の科学者のデータ取得のお役に立てれば幸いである。
謝辞
東京工業大学理学部高柳邦夫教授、谷城康眞先生、他のメンバーの方には、本装置開発にあたり、基礎となったJST CREST R005プロジェクトの共同開発に携わって頂き、さらにその後もご指導頂き大変お世話になりました。ここに御礼申し上げます。東北大学名誉教授田中通義先生には、当時JST CRESTの領域研究総括として指揮およびプロジェクトの機器開発を導いていただき、誠にありがとうございました。東京大学幾原雄一教授、柴田直哉准教授には、 GRAND ARMの開発にご協力いただき、感謝申し上げます。
参考文献
[ 1 ] Haider, M., Uhlemann, S., Schwan, E., Rose, H., Kabius, B., and Urban, K. ; Electron microscopy image enhanced. Nature , 392, 768-769(1998).
[ 2 ] Krivanek, O. L., Dellby, N., and Lupini, A. R. ;Towards sub-angstrom beams. Ultramicroscopy ,78, 1-11(1999).
[ 3 ] Takayanagi, K., Oshima, Y., Tanaka, T., Tanishiro,Y., Sawada, H., Hosokawa, H., Tomita, T., Kaneyama, T., and, Kondo, Y. ; Lithium Atom Microscopy at Sub-50 pm Resolution. JEOL News , 45,2-7(2010).
[ 4 ] Takayanagi, K., Kim, S., Lee, S., Oshima, Y.,Tanaka, T., Tanishiro, Y., Sawada, H., Hosokawa, F., Tomita, T., Kaneyama T., and Kondo Y. ; Electron microscopy at a sub-50 pm resolution. J. Electron Microsc ., 60,S239-S244(2011).
[ 5 ] Sawada, H., Hosokawa, F., Kaneyama, T., Ishizawa,T., Terao, M., Kawazoe, M., Sannomiya, T., Tomita, T., Kondo, Y., Tanaka, T., Oshima, Y., Tanishiro, Y., Yamamoto, N., and Takayanagi, K. ; Achieving 63 pm resolution in scanning transmission electron microscope with spherical aberration corrector. Jpn. J. Appl. Phys ., 46, L568-570(2007).
[ 6 ] Sawada, H., Tanishiro, Y., Ohashi, N., Tomita,T., Hosokawa, F., Kaneyama, T., Kondo, Y., and Takayanagi, K. ; STEM Imaging of 47-pm Separated Atomic Columns by Spherical Aberration-Corrected Electron Microscope with 300 kV Cold Field Emission Gun. J. Electron Microsc ., 58, 357-361(2009).
[ 7 ] Oshima, Y., Sawada, H., Hosokawa, F., Okunishi, E., Kaneyama, T., Kondo, Y., Niitaka, S., Takagi,H., Tanishiro, Y., and Takayanagi, K. ; Direct imaging of lithium atoms in LiV2O4 by spherical aberration-corrected electron microscopy. J. Electron Microsc . 59, 457-461(2010).
[ 8 ] Kohno, Y., Okunishi, E., Tomita, T., Ishikawa, I., Kaneyama, T., Ohkura, Y.,Kondo, Y., Isabell, T. ; Development of a cold field-emission gun for a 200 kV atomic resolution electron microscope. Microsc. Anal . 24, S9–S13(2010).
[ 9 ] Hosokawa, F., Sawada, H., Kondo, Y., Takayanagi, K.,Suenaga, K. ; Development of Cs and Cc correctors for transmission electron microscopy, Microscopy , 62, 23–41(2013).
[10] O'Keefe, M., Allard, L., Blom, D. ; HRTEM imaging of atoms at sub-Angstrom resolution. J. Electron Microsc . 54, 169-180(2005).
[11] Erni, R., Rossell, M. D., Kisielowski, C., and Dahmen, U. ; Atomic-resolution imaging with a sub-50-pm electron probe. Physical Review Letter , 102, 096101(2009).
[12] Sawada, H., Shimura, N., Satoh, K., Okunishi,E., Hosokawa, F., Shibata, N., and Ikuhara, Y. ; Resolving 45 pm with 300 kV Aberration Corrected STEM Using Si Crystalline Specimen. Microscopy and Microanalysis(Supplemental) , to be published(2014).
