SpiralTOF™を用いたレーザー脱離イオン化法による有機薄膜分析
日本電子 news Vol.46 No.7
佐藤 貴弥
日本電子(株)MS事業ユニット
レーザー脱離イオン化-飛行時間質量分析法(LDI-TOFMS)は、イオン化時の開裂が少なく、有機物の分子量、分子構造などの情報を得ることができる手法として有機質量分析法では一般的である。特にイオン化を促進するためのマトリックスを用いる手法は、マトリックス支援レーザー脱離イオン化-飛行時間質量分析法(MALDI-TOFMS)として、分子量数千~数十万までのタンパク質、ペプチドなどをイオン化できることからバイオ市場で広く普及している他、材料分析市場でも合成高分子ポリマーの解析などに利用されている。最近までLDI-TOFMS、MALDI-TOFMSは可溶試料の分子量確認を行うことがほとんどであったが、レーザー照射位置を2次元で走査しマススペクトルを取得することで特定の分子量をもつ化合物の局在を可視化できるイメージング質量分析法の技術向上が進み、その応用範囲が広がっている。イメージング質量分析法の技術向上は、バイオ市場において生体組織切片を対象として進んでいるが、今後は材料分析市場への展開が期待されている。ここで、材料分析市場にはすでに様々な表面分析手法が存在する。LDI-TOFMSを表面分析法の1つとして検討していくためには、既存の表面分析手法との比較を行い、有用性を示していくことが不可欠である。本報告では、有機EL材料の薄膜のLDI-TOFMSによる解析事例を、飛行時間二次イオン質量分析法(TOF-SIMS)、 X線光電子分光法(XPS)、走査型電子顕微鏡/エネルギー分散型X線分析法(SEM/EDS)と比較しながら有効性について検討を行った。LDI-TOFMSは破壊分析であるので、サンプル表面に与える影響についてもあわせて検討を行った。
はじめに
表面分析手法は、試料表面に電子、イオン、光を照射し、試料表面に存在する物質との相互作用によりその形態や物性を調べる手法である。形態を観察するためには、光学顕微鏡、電子顕微鏡が主に用いられている。また、物性を調べる手法としては、入射粒子と検出信号により、電子線マイクロアナライザ(EPMA)、オージェ電子分光法(AES)、X線光電子分光法(XPS)、飛行時間型二次イオン質量分析法(TOF-SIMS)などの様々な手法が存在する。近年、有機半導体、有機EL、有機薄膜太陽電池など、電子部品中に有機化合物が構成されるケースが多くなっており、今後もその利用は拡大すると考えられる。それに伴い、製品の検査や不良品(劣化)の分析はますます重要となってくる。表面分析手法の中には、AESやXPSなど有機化合物の結合状態、官能基情報が得られる手法もあるが、有機化合物の構造解析までは難しい。表面分析手法に利用されている質量分析技術としてはTOF-SIMSがある。SIMSはイオン化時にフラグメンテーション(分子の開裂)が起こりやすいことから、有機物の分析への適用は困難であった。最近では、金属クラスターやガスクラスターを一次イオンビームとして用いる手法が実用化している。これらは、生成した二次イオンのフラグメンテーションを抑制する効果がある一次イオン源を搭載したTOF-SIMSにより、解析対象が無機物から有機化合物へ展開することが期待されている。
本報告で紹介するのは、レーザー脱離イオン化-飛行時間質量分析法(Laser Desorption Ionization-Time of flight mass spectrometry, LDI-TOFMS)である。レーザー脱離を用いた技術としては、サンプルとイオン化を支援する化合物(マトリックス)を適切に組み合わせることで、広範な化合物、特に分子量数千から数十万の有機化合物のイオン化が可能なマトリックス支援レーザー脱離イオン化-飛行時間質量分析法(Matrix Assisted LDI-TOFMS, MALDI-TOFMS)がより一般的に知られており、タンパク質やペプチドの解析を目的として2000年頃に爆発的に普及した。また材料解析分野においても、合成高分子ポリマーの解析において利用されてきている。これら高分子有機化合物の測定では、マトリックスの利用が必要不可欠なため、レーザーを用いたイオン化といえばMALDIをさす場合が多い。しかし、マトリックスを使用せずに、レーザー照射のみでイオン化できる化合物も存在し、その場合は単にLDIと呼ばれている。
質量分析法の多くは、可溶試料を対象とする。MALDI-TOFMSもサンプル溶液とマトリックス溶液を混合し結晶化して分析を行う。この結晶にレーザーを照射することで、サンプル中に含まれる種々の有機化合物をイオン化し、質量分析を行う。最近では、試料表面の有機化合物の局在情報を得ることができるMALDI-TOFMSを用いたイメージング質量分析法 [1,2]の技術が向上し、この普及が進んでいる。イメージング質量分析法では、サンプル上にマトリックスを均一に噴霧し、このサンプルに対してレーザー照射位置を2次元に走査しながらマススペクトルを取得する。この結果、サンプルに含まれる特定化合物の2次元分布情報を取得することが可能となる。イメージング質量分析法は、黎明期よりタンパク質、ペプチド、脂質あるいは薬剤動態などバイオ市場でアプリケーションが拡大しており、現在もその対象のほとんどは生体組織切片である。一方で生体組織切片での手法確立に伴い、徐々に材料解析市場への適用が検討され始めており、薄膜や固体表面の有機化合物の局在情報の可視化が期待されている。材料解析市場においてイメージング質量分析法をより有効な手法としていくためには、従来利用されている表面分析法との有効性比較やクロスチェックが非常に重要である。本報告では、JMS-S3000“SpiralTOF”を用いて、LDI-TOFMSを表面分析法の1つの手法として検討するための基礎実験を行ったので報告する。サンプルには有機EL部材の化合物の薄膜を用い、XPS、TOF-SIMSから得られる情報の比較、またレーザー照射が薄膜表面に与える影響についても検討を行った。
サンプル
LDI-TOFMS、TOF-SIMS、XPSの結果を比較するため、有機ELの正孔輸送層の材料であるN,N' -Di(1-naphthyl)-N,N' -diphenylbenzidine(α-NPD)を、600nmの厚さでシリコン基板に蒸着したもの(以下 α-NPD/Siとする)をサンプルとして使用した。またLDIの試料表面への影響を検討するサンプルとして、シリコン基板上にやはり有機ELの正孔輸送層の材料である4,4’,4’’-Tris[2-naphthyl(phenyl) amino] triphenylamine(2-TNATA)を700nm、さらにその上からα-NPDを1300nm蒸着したサンプル(以下 α -NPD/2-TNATA/Siとする)を使用した。
LDI-TOFMS、TOF-SIMS、XPSによる有機薄膜分析
LDI-TOFMSに は、JMS-S3000 “SpiralTOF” を 使 用 した。Fig.1(a)にSpiralTOFの外観図を示した。SpiralTOFの最大の特長は、JEOLオリジナルのらせん型のイオン軌道(Fig. 1(b)))であり、それは4つの階層状の扇形電場により形成されている。1周回の飛行距離は2.093mであり、実効飛行距離は8周回で17mを実現している。ここで、TOFMSの質量分解能は飛行距離に比例する。一般的なリフレクトロンTOFMSの実効飛行距離は数m程度であるのに対して、17mの実効飛行距離を有するSpiralTOFはMALDI-TOFMSの中では世界最高の質量分解能を実現できる。またイオン軌道を形成している扇形電場により、飛行中に開裂したイオンを排除することができるため、ノイズの少ないマススペクトルを得ることもできる。さらにTOF-TOFオプション[4]を装着することで、タンデム質量分析(MS/MS)による構造解析も可能である。SpiralTOFのMS/MSは、高エネルギー衝突誘起解離法とよばれ、MS/MSの中でも構造情報を多く得られることで知られている。SpiralTOFは、Newport社 Nd:YLF 349nm をイオン化用のレーザーとして搭載している。試料表面へのレーザー照射径はおおよそ20μmであり、レーザー 100%で60μJが照射される。α -NPDと2-TNATAはマトリックスを必要とせずイオン化するので、本報告での実験は、LDI-TOFMSとしてマススペクトルを取得した。α-NPD/Si上でレーザー照射位置を固定し、レーザー照射250回分を積算したマススペクトル(m/z 10~800)をFig. 2(a)に示す。マススペクトルにはα-NPDを示す分子イオンのみが観測され、イオン化時点でのフラグメンテーションが非常に少ないことが分かる。次に、TOF-TOFオプションを使用し、観測された分子イオンを選択してプロダクトイオンスペクトルを取得した。開裂生成したフラグメントイオンを観測した結果と推定される開裂部位をFig. 2(b)に示す。高エネルギー衝突誘起解離法により、多くの情報が得られており、構造推定に十分であることが分かる。
TOF-SIMSは、京都大学・松尾グループにてJMS-T100LP “AccuTOF LC-plus” をベースに改造・製作された装置を使用した[5]。装置外観図をFig.3(a)に示した。加速電圧10kVのアルゴンクラスターイオンを一次イオンとして、α -NPD/Siに照射し、生成した二次イオンのマススペクトル(m/z 0~800)をFig.3(b)に示す。TOF-SIMSのマススペクトルには、LDI-TOFMSと比較して低質量領域(m/z 100~500)に多くのピークが観測されている。これらの由来は2つ考えられる。1つはα-NPDのイオン化時に生成したフラグメントイオンである。これは、Fig. 2(b)のプロダクトイオンスペクトルのパターンとTOF-SIMSのマススペクトルが比較的類似していることから推測できる。またもう1つは、TOF-SIMSは測定対象が表面から10nm以下の最表面分析であるため、表面に付着した有機物由来のイオンの可能性である。一次イオンにアルゴンクラスターを用いているので、TOF-SIMSの中でも最もイオン化時の開裂の少ない手法ではあるが、LDI-TOFMSと比べるとフラグメンテーションの影響や表面汚染の影響が顕著にマススペクトル上に現れることを考える必要がある。TOF-SIMSは分子イオンあるいは主たるフラグメントイオンをモニタすることで、マッピング、深さ方向分析などが可能である。たとえばマッピングの空間分解能は1μm以下を達成でき、現在のMALDI-TOFMSを用いたイメージング質量分析法の性能(典型的には数10μm)よりも高い。しかしながら、フラグメントや表面汚染由来のバックグランドが多く観測されることを考えると、イオン化した主成分のみへの適用に限定される。劣化解析など主成分から派生して生じる化合物は、その量が決して多くないことが予想されるので、フラグメントイオンや表面汚染との区別が困難になる可能性が高い。
XPSには、JPS-9010を使用した。その外観図はFig.4(a)に示した。分析領域は1mmφとし、α-NPD/Siを測定した結果をFig.4(b)、(c)に示す。Fig.4(b)は、ワイドスペクトル(エネルギー分解能 Ag3d5/2 1.7eV)であり、α -NPDの構成元素であるC、Nのピークが顕著に観測されている。TOF-SIMSと同じく最表面分析であるXPSでは、基板のシリコン由来のピークは観測されていない。さらにCのピーク周辺についてはナロースペクトル(エネルギー分解能Ag3d5/2 0.5eV)も取得した。その結果、C-C結合およびC-N結合由来のピークを混合した形で観測することができた。XPSでは元素情報とともに結合状態の情報も得ることができる。さらに、LDI-TOFMSやTOF-SIMSなど質量分析法と比較すると、XPSは非破壊分析であり、イオン化による不確定さがないため定量分析も可能である。しかし、限られた元素の組み合わせでできている有機化合物では、混合物の定量分析は容易ではない。特に劣化物などの組成が大きく変化しない形でマイナーな成分として混合すると、その分離はより難しくなると予想される。
以上のように、LDI-TOFMSと既存の表面分析法であるTOF-SIMS、XPSとを比較した。有機化合物分析におけるLDI-TOFMSの利点は、マススペクトルから分子イオンを主に確認できること、またMS/MSを行うことで構造解析が可能な点である。これらの特長は、試料表面に存在する有機混合物の分析において特に力を発揮し、劣化解析においては主成分からの劣化生成物であるマイナーな成分の分析を可能とすることが期待される。

【Fig.1(a) JMS-S3000の外観図(リニアTOFオプションとTOF-TOFオプション装着時)と(b)らせん型のイオン軌道図。】

【Fig.2 (a)LDI-TOFMSによるα-NPDのマススペクトル。α-NPDの分子情報を示すピークが明確に観測されている。(b)α-NPDのMS/MSスペクトル。α-NPDの構造をよく反映したピークが観測されている。】

【Fig.3 (a)京都大学松尾グループ所有のTOF-SIMSと(b)TOF-SIMSによるα-NPDのマススペクトル。α-NPDの分子情報を示すピークのほかにα-NPDのフラグメントイオンや表面汚染由来と思われるピークが多数観測されている。】

【Fig.4 (a)JPS-9010 の外観図と(b)α-NPD/Siのワイドスペクトル。α-NPDを構成する元素であるC、Nが顕著に観測された。(c)α-NPD/SiのナロースペクトルまたC近傍のナロースペクトルからはC-C、C-Nの結合状態を示すピークが観測された。】
レーザー照射による試料表面への影響
次に、レーザー照射による試料表面への影響について、走査型電子顕微鏡/エネルギー分散型X線分析装置(SEM/EDS)を用いて確認した。使用した装置は、Fig.5(a)に示したOXFORD Instruments社AZtec Energy Standard X-Max 50を搭載したSEM JSM-7001FTTLLVである。レーザー強度40%で250回のレーザー照射を行った後の照射痕のSEM像をFig.5(b)に示す。SEM像から、レーザー照射後は35μmφで有機薄膜層が消失している様子が観測できた。さらにEDSで照射痕とその周辺の有機薄膜が残す領域を分析した結果を、Fig.5(c)とFig.5 (d)に示す。前者からはSi、後者からはCが主に確認でき、レーザー照射によって有機層が貫通していることが確認できた。
次にレーザー照射位置固定、レーザー強度40%にて、α -NPD/2TNATA/Siの マススペクトルを取得した。レーザー照射回数とα-NPD、2-TNATAの分子イオンのレーザー照射回数に対するイオン強度推移をプロットしたものをFig.6(a)に示す。上層のα-NPDはレーザー照射回数に従い、イオン強度が減衰しているのが分かる。また下層の2-TNATAは、レーザー照射100回程度でマススペクトル上に観測され始めた。レーザー照射回数0-50回と100-150回の積算マススペクトルをFig.6(b)、(c)にそれぞれ示した。両者を比較すると、それぞれのフラグメントイオンはほとんど観測されておらず、2-TNATAの出現が明確である。下層の2-TNATAが観測され始めたのちも上層のα-NPDが観測されていることを考えると、レーザー照射回数が増加するに従って、イオン化領域は深さ方向とともに平面方向へも広がっていることが示唆される。次にレーザー強度を変化させた時、2-TNATAが出現するレーザー照射回数をプロットした結果をFig.7に示す。レーザー強度が強くなるに従い、少ないレーザー照射回数で2-TNATAが出現することが分かる。すなわち、深さ方向の影響は、レーザー照射回数とレーザー強度に影響されることが分かる。
これらの結果から、レーザー照射条件(レーザー強度、回数)により表面への影響は大きく変わることが分かった。深さ方向については概ね100nm ~ 1μmの領域の総合した情報を得ていることになる。これはXPSやTOF-SIMSの最表面分析と比べると、かなり大きい。レーザー照射回数やレーザー強度を増加させると、深さ方向のみならず平面方向のイオン化領域も増えるため、マッピングを行う場合には注意が必要である。
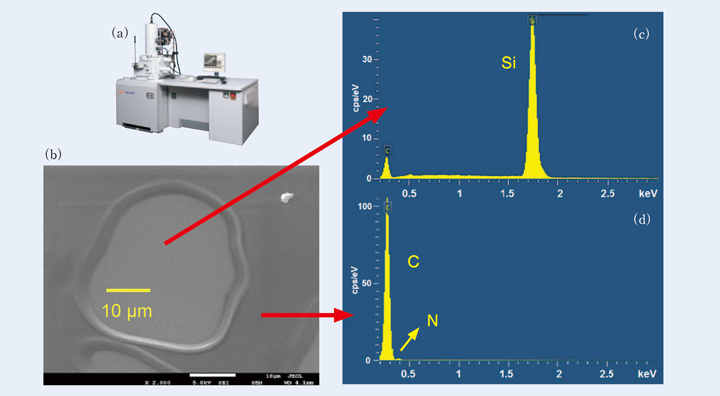
【Fig.5 (a)JSM-7001FTTLLVの外観図。(b)レーザー強度40%で250回レーザー照射した後の照射痕を観察したSEM像 。(c)レーザー照射痕の領域およびレーザー照射痕周辺のEDSによる分析結果。レーザー照射痕からはSiが、周辺部からはCが主に観測されていることから、レーザー照射により有機薄膜は貫通している。】

【Fig.6 (a)α-NPD/2-TNATA/Siをレーザー照射位置固定で測定した場合の、α-NPDおよび2-TNATAのイオン強度推移。またレーザー照射回数 0-50回、100-150回のマススペクトルをそれぞれ(b)、(c)に示す。】
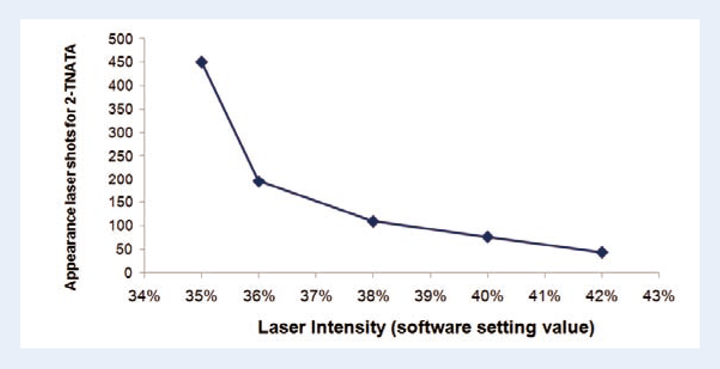
【Fig.7 レーザー強度を変化させた場合の2-TNATAが観測されはじめるレーザー照射回数。レーザー強度が増えると表面への影響は大きくなる。】
まとめ
本報告では、LDI-TOFMSとXPS, TOF-SIMSを用いた有機薄膜分析の比較検討を行った。XPSは得られる情報が元素・結合状態のみであること、TOF-SIMSはフラグメントイオンによりマススペクトルが複雑化することから、多成分系への適用は容易ではない。それに対して、LDI-TOFMSは分子イオンが主たる成分として観測できるため、多成分分析にも適していると考えられる。電子部品中の有機化合物の劣化解析では、全体の元素構成比自体は大きく変わらないと予想されるので、分子イオンの確認ができ、MS/MS測定による構造解析が可能なLDI-TOFMSは劣化成分を特定する重要な手段になりうる。また、劣化により生成する成分のイオン量は、主成分と比較して多くないことも考えられるので、イオン化時にフラグメントイオンがほとんど発生しないLDI-TOFMSを用いることにより、明確な解析が期待できる。
また、レーザー照射後の状態をSEMで観測した結果、有機EL部材の薄膜の深さ方向について100nm以上の空間領域を総合した情報を得ていることが分かった。深さ方向への影響は、レーザー強度や照射回数に依存するが、XPSやTOF-SIMSといった10nm以下の深さでの分析が主となる表面分析法に比べてかなり大きい。深さ方向に構造をもつ薄膜の分析において、最表面分析であるXPSやTOF-SIMSを用いる場合、イオンエッチングとの併用が必要であるが、深さ方向の情報を制御することは可能である。これに対してLDI-TOFMSは、XPS、TOF-SIMSなどと比べれば深さ方向の情報を明確に得られないと考えられるが、同じ階層に含まれる化合物を分類することは可能と考えられる。
(MA)LDI-TOFMSは、マスイメージング技術の進歩とともに、試料表面の二次元的な化合物の分布を取得することが可能となってきている。今後、薄膜状のサンプルに対するイオン化、表面に与える影響などの知見を深めていくことで、表面分析法の1つ技法として応用することができる。

【Table1 表面分析法とLDI-TOFMSの比較。】
謝辞
有機薄膜サンプルおよびTOF-SIMSのマススペクトルは、 京都大学工学研究科附属量子理工学教育研究センター 松尾グループより提供いただきました。
参考文献
[ 1 ] Caprioli, R.M., Farmer, T.B., Gile, J.: Molecularimaging of biological samples: localization of peptides and proteins using MALDI-TOF MS. Anal. Chem . 69, 4751–4760 (1997).
[ 2 ] Jungmann, J.H., Heeren, R.M.A.: Emerging technologies in mass spectrometry imaging. J. Proteomics 75, 5077–5092 (2012).
[ 3 ] T. Satoh, T. Sato, J. Tamura, “Development of ahigh-Performance MALDI-TOF mass spectrometer utilizing a spiral ion trajectory”: J. Am. Soc. Mass Spectrom ., 18, 1318 –1323, (2007).
[ 4 ] T. Satoh, T Sato, A. Kubo, J. Tamura, “Tandem Time-of-Flight Mass Spectrometer with High Precursor Ion Selectivity Employing Spiral Ion Trajectory and Improved Offset Parabolic Reflectron”: J. Am. Soc. Mass Spectrom ., 22,797-803, (2011).
[ 5 ] K. Ichiki, J. Tamura, T. Seki, T. Aoki, J. Matsuo, “Development of gas cluster ion beam irradiationsystem with an orthogonal acceleration TOF instrument” Surface and Interface Analysis , 45(1), 522-524 (2013).
