電子線トモグラフィーによる半導体材料の解析
日本電子news Vol.50 No.6
青山 佳敬1、大西 市朗1、遠藤 徳明1、奥西 栄治1、佐々木 健夫2、岩澤 頼信3、近藤 行人1
1 日本電子(株) EM事業ユニット 2 JEOL (U.K.) LTD. 3 日本電子(株) 周辺機器事業ユニット
近年、半導体デバイスは集積度を高めるために三次元(3D)的に設計されている。従って半導体の開発や品質管理をする上で素子の3D構造をナノスケールの分解能で観察することが不可欠である。EDSトモグラフィーは電子線トモグラフィーとEDSによる元素分析を組み合わせて三次元の元素マップを得る手法であり、X線の検出器(SDD)が大面積化され、高速でEDSマップが取得できるに従い様々な分野に適用されている。EDSトモグラフィーは連続傾斜元素マップを取得するために試料ステージを傾斜させる必要があるが、特定の傾斜角度においてはSDDがグリッドバーや試料ホルダーの影になるため、X線の検出効率が低下し、3D元素マップにアーティファクトを発生させる原因となっている。本研究ではTEMおよびEDS検出システムに改良を施すことにより遮蔽の効果を除去し、精度の高いEDSトモグラム取得システムの確立を試みた。
はじめに
多くの工業製品がコンピューター制御されるようになり、電子機器 の中心を担う半導体デバイスは更なる高速化と省電力化が望まれている。半導体素子を小型化・集積化することによりCPUやメモリーの小型化、高速化、省電力が達成されており、近年では14 nmピッチの半導体デバイスが報告されている。このような最新の半導体デバイスは素子を効率よく集積化させるために三次元的に配置した設計になっている[1、2]。そのため半導体の開発や故障解析を行うには従来の二次元像観察による構造解析では十分とは言えず、ナノスケールの空間分解能で三次元構造解析をする必要がある。電子線トモグラフィー (Electron Tomography: ET)は透過電子顕微鏡法(Transmission Electron Microscopy: TEM)と計算機トモグラフィー (Computerized Tomography: CT)を組み合わせて三次元微細構造を観察する手法である。試料ステージを傾斜させながらTEM像を取得し、得られた連続傾斜像に逆投影法を適用して再構成することにより三次元構造を得る[3]。ETはサブナノメートルの三次元分解能で構造解析することが可能であり、三次元的な構造を有する最新の半導体材料の構造解析に有効である[4、5]。さらにETとエネルギー分散型X線分光法(Energy Dispersive X-ray Spectroscopy: EDS)を組み合わせて3D元素マップを得るEDSトモグラフィーを適用する試みが行われ始めている[6-9]。EDSトモグラフィーは試料を連続的に傾斜し、各傾斜角度で元素マップを取得し、得られた連続傾斜元素マップから3D元素マップを再構成する手法である[10、11]。EDSトモグラフィーは2000年代には既に報告されていたが、当時のEDS検出器はSi(Li)のEDS検出器であり、検出器の大きさが限られていたため、検出感度が低くかつ信号処理速度も遅いため、連続傾斜EDSマップを取得するためには長時間電子線を試料に照射する必要があった。そのため、電子線ダメージやコンタミネーションの影響が深刻であり構造解析を行う試料は限られていた。しかし近年、シリコンドリフト検出器(Silicon Drift Detector: SDD)が開発され信号処理速度が大幅に向上し、大面積の検出器も製作可能になったこと、TEM内に複数のEDS検出器を導入することが可能になったことにより、Si(Li)EDS検出器が使われていた時代に比べ現在は13 ~ 16倍ほど高速にEDSマップが取得できるようになった[12、13]。これにより金属や半導体材料などについてはEDSトモグラフィーによる3D元素マップを取得することが盛んに行われる様になってきた。しかしながら電子線照射に弱い生体試料やソフトマテリアルは依然としてEDSトモグラフィーによる解析を適用することは難しい状況にある。
また、EDSトモグラフィーは三次元構造解析をする手法として有効であるが、元素位置を特定する定性的な解析に利用されるに留まっており三次元定量解析はほとんど行われていない。EDSトモグラフィーは三次元定量解析を妨げる2つの問題すなわち、X線の試料自身による吸収とある特定の傾斜角での検出器に対するX線の遮蔽があるからである[14]。Fig. 1(a)はEDS分析における三次元定量解析を妨げる要因の一つであるX線吸収の効果を示す模式図である。黒の矢印は電子線照射によって発生した特性X線がSDDへ向かう場合の経路を示しており、試料が対称的な構造の場合、SDDに近い側と遠い側で発生するX線量は等しくなる。しかしSDDから遠い側は試料内部を透過するときに試料自身に吸収されるためSDDで検出されるX線量は低下することになり、遠い方は濃度が低下する定量結果を生じさせることになる。従来の二次元EDS分析であれば試料を十分に薄く加工することにより吸収の効果を低減することが可能であるがEDSトモグラフィーでは薄く加工するほど三次元的な情報が失われてしまうので、試料が厚い状態における三次元定量解析の精度が求められるわけである。最近の研究ではEDSトモグラフィーにおける吸収の効果をデータ取得後の計算処理によって除去する手法が試みられている[15]。Fig. 1(b)は三次元定量解析を阻むもう一つの要因である遮蔽の効果を示す模式図である。通常、TEM試料は3 mmφのグリッドに担持され、グリッドは試料ホルダーに固定されるが、従来のEDS検出システムではSDDが傾斜軸の両側に配置されており(Fig. 2(a))、EDSトモグラムを取得するために試料ステージを傾斜すると特定の傾斜角度でSDDがグリッドバーや試料ホルダーの影になりX線が遮蔽されEDSマップの強度が低下する。結果的に三次元構造にアーティファクトを生じさせることになる。この遮蔽の効果を除去するには傾斜角度ごとに遮蔽される効果を見積もり、EDSマップの強度を補正する必要がある。EDSトモグラフィーを用いて精度の高い三次元構造解析および三次元定量解析を行うためにはこれら吸収と遮蔽の効果を除去する必要がある。
本研究ではTEMとそのアタッチメントの改良と新しいEDS検出システムを構築することなどの装置側の改良により遮蔽の効果を低減することを試みた。Fig. 2(b)は本研究で提案する新しいEDS検出システムである。2つのSDDが傾斜軸上(SDD2)および傾斜軸の右側(SDD1)にそれぞれ配置されている。傾斜軸の右側に配置されたSDD1は従来と変わらず試料ステージを傾斜したときに遮蔽の効果が現れるが、傾斜軸上に配置したSDD2は傾斜角度に依らず一定の感度が得られるはずである。そこで本研究の目的は、傾斜軸上にSDDを配置した新しいEDS検出システムをTEMに導入し遮蔽の効果がないことを確かめるとともに半導体試料にこのEDS検出システムを適用しEDSトモグラムを得ることとする。
Fig.1 EDSトモグラフィーにおける定量解析を妨げる2つの現象を示す模式図
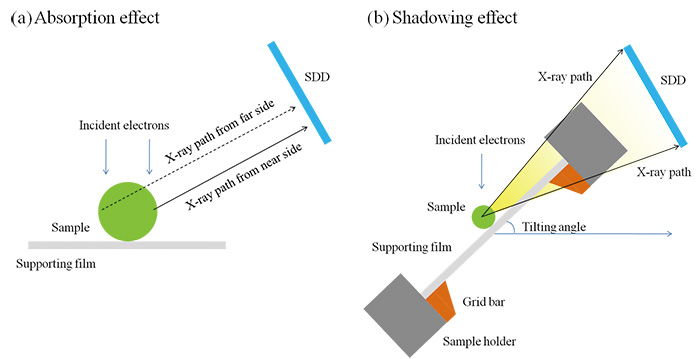
- 電子線が試料に照射されて発生した特性X線は矢印で示すレイパスを通りSDDで検出される。このときSDDから遠い側から発生したX線の一部は試料自身により吸収されてしまう。
- EDSトモグラフィーでは、連続的に試料傾斜してEDSマップを取得する。このとき特定の角度でSDDが試料ホルダーやグリッドバーの影に隠れX線の検出量が低下する。これら吸収と遮蔽の影響はEDSトモグラフィーによる3D元素マップにアーティファクトを生じさせる。
Fig.2

- 従来のEDSトモグラフィーシステムのSDDの配置。試料ステージの傾斜軸の左右にSDDが配置されている。
- 本研究で採用した新しいEDSトモグラフィーシステムのSDDの配置。SDD1は従来の配置と同じであるがSDD2は傾斜軸上に配置されている。SDD2は試料の傾斜角度に対して立体角の変化が少なく遮蔽の効果のないEDSトモグラムの取得が可能である。
実験
本研究で用いた装置は冷陰極電界放出型電子銃と球面収差補正装置、2つのSDDを装備した加速電圧300 kVのTEM(JEM-ARM300F、日本電子製)である(Fig. 3)。2つのSDDは前述したように傾斜軸上と傾斜軸の右側にそれぞれ配置されている(Fig. 2(b))。遮蔽の効果を除去するために傾斜軸上のSDD2のみでEDSトモグラムを取得することを試みるので、1本のSDDでも十分な立体角を確保できるように素子面積が158 mm2の大面積SDDを採用した。またX線は距離の2乗に反比例して減衰していくので、X線源であるTEM試料とSDDを近づけることがEDSマップの取得速度を速め、電子線ダメージによる試料の破壊を抑えるために有効になる。本実験では対物レンズの上極と下極を従来よりも細身に、上極と下極間のギャップを幅広に設計した対物レンズ(Wide Gap Pole Piece: WGP)を採用したことによりSDDを試料ホルダーに従来よりも近づけることが可能になり、EDSマップの取得効率を向上させている。また試料ホルダーはEDSトモグラフィー用に新しく開発した高傾斜分析ホルダーを用いた。このホルダーは±70°以上の高傾斜が可能でありながら先端が細く薄く設計されているため試料から発生したX線を遮蔽しにくい構造をしている。これら3つの改良により、本研究で用いたEDS検出システムにおいてSDD1およびSDD2の立体角はそれぞれ1.106 sr,1.108 srを達成しており[13]、傾斜軸上に配置されたSDD2のみを用いたとしてもEDSトモグラムを十分に早く取得できるシステムが構築されたと言える。
実験には塗膜試料と半導体試料の2種類のTEM試料を用いた。塗膜試料は遮蔽の効果を測定するために用いた。硬化した塗膜をエポキシ樹脂で包埋しミクロトームを用いて、300 nmの厚みに薄切した後、3 mmφの一般的な銅グリッドに転写してTEM試料とした。EDSマップは加速電圧300 kV、電流値300 pAの条件で取得した。EDS傾斜シリーズはトモグラフィー用自動取得ソフトウェア(TEMography,SYSTEM IN FRONTIER社製)を用いて自動で取得した。傾斜角度範囲は±60°、角度ステップは5°、EDSマップのサイズは256×256ピクセルである。総取得時間は190分である。取得したすべてのEDSマップはEDS解析用ソフトウェア(アナリシスステーションTM、日本電子製)を用いてバッチ処理により一括でネットカウントマップに変換した(*ネットカウントマップはバックグランウンドを除去し、オーバーラップしているX線のピークをデコンボリューションして各元素ごとのピークに分離し算出された各元素のカウントをマップにしたものである)。EDS傾斜シリーズと同時取得したHAADF-STEM像の連続傾斜シリーズをまず三次元再構成し、その位置合わせ条件と再構成条件をEDS傾斜シリーズに適用してそれぞれの元素について3D元素マップを得た。ゆえにぞれぞれの3D元素マップは取得から再構成まで同一の条件で行われている。三次元再構成アルゴリズムは逐次再構成法であるSIRT(Simultaneous Iterative Reconstruction Technique)を用いた。
次の実験対象として、三次元構造を持つ代表的なトライゲートの半導体素子、FinFETを用いた。ウェハーをダイアモンドカッターで小片に加工し、機械研磨で薄片化した後、アルゴンイオンスパッタ装置(イオンスライサTM、日本電子製)を用いて薄膜に加工しTEM試料とした[16]。傾斜シリーズの位置合わせのために5 nmφの金コロイド粒子をTEM試料に散布している。EDS傾斜シリーズの取得は加速電圧200 kVで行い傾斜角度範囲±64°、角度ステップ4°で計33枚のEDSマップを取得した。傾斜軸上に配置されたSDD2のみでEDSマップを取得した。総取得時間は120分だった。三次元再構成の手順は前段落で述べた塗膜試料と同じである。
Fig.3 本研究で用いたEDSトモグラフィーシステムの構成の外観写真

- 球面収差補正装置を装備した300 kVタイプのTEM(JEM-ARM300F、日本電子製)。
- 大面積SDD。検出面積は158 mm2であり、TEMに2個装着されている。
- EDSトモグラフィー用高傾斜分析ホルダー。±70°以上の高傾斜が可能であり、先端が細く薄く加工されているので試料からSDD2へ向かうX線を遮蔽しにくい構造になっている。
結果および考察
本研究で用いた塗膜試料のHAADF-STEM像をFig. 4(a)に示す。シリカ粒子の凝集体に直径100-500 nmの酸化Ti粒子と酸化鉄の小片が分散している。この視野から傾斜角度範囲±60°、5°ステップでEDSマップを取得し三次元再構成した結果がFig. 4(b)である。黄色の粒子は酸化Ti、緑色はシリカ粒子の凝集体、マゼンタ色の小片は酸化鉄に相当する。X線の遮蔽の効果を測定するために酸化Ti粒子に着目しFig. 5を得た。Fig. 5は横軸に試料ステージの傾斜角度、縦軸にTiマップの総カウント数をプロットしている。どの角度から取得したEDSマップであっても酸化Ti粒子の体積は不変であるので、遮蔽の効果がない理想的なEDS検出システムであれば試料ステージの傾斜角度に依らず常に一定のカウント数になるはずである。傾斜軸の右側に配置されたSDD1は‒20°付近でTiのカウント数が4割ほど低下しておりX線の遮蔽の影響が現れていることがわかる。一方、傾斜軸上に配置されたSDD2は±60°の範囲でほぼ一定になっている。このことから傾斜軸上に配置された1本のSDDを用いることで遮蔽の影響を除去できていることが確認された。試料ステージを高い角度に傾斜したときに総カウント数がやや下がっているが、これは傾斜させたことにより試料が厚くなり、試料自身の吸収の影響が無視できなくなっている影響と思われる。
次に新しいEDS検出システムを実試料に適用するために、半導体試料のEDSトモグラムの取得を行った。EDSマップの取得には傾斜軸上に配置されたSDD2のみを用いている。試料はFinFETであり、断面方向から観察したHAADF-STEM像がFig. 6(a)である。HAADF-STEM像中の白色の粒子は位置合せ用に散布した金コロイド粒子である。この視野において連続傾斜EDSマップを取得し、三次元再構成して得られた3D元素マップがFig. 6(b)-Fig. 6(h)である。絶縁膜である窒素マップは軽元素のためSN比が低いものの、 GeマップやTiマップ、Wマップは高いSN比の3D元素マップが得られており、構造を明確に捉えることができている。Fig. 7にはFig. 6(h)で示したFinFETの3D元素マップをいくつかの方向から切り出した断面を示す。Fig. 7(a)はチャンネルに垂直なY-cut断面で、カットした位置は下図のZ-cut断面の黄線で示してあるようにSi/Geストレッサーのある場所である。ストレッサー (Ge: 黄色)とチャンネル(Si: 紺色)の元素分布をとらえることができている。Fig. 7(b)はチャンネルのほぼ中央の断面である。チャンネルとゲート電極(W: 緑)とその間の窒化膜(N: マゼンタ)、酸化膜(O: シアン)の元素分布が確認される。
本研究ではTEMとEDS検出システムを改良することによりX線の遮蔽の効果を除去することに成功した。しかし、三次元定量解析を高精度で行うには試料自身によるX線の吸収の効果も除去しなければならない。Fig. 8はX線の吸収の効果を示す結果である。塗膜試料の連続傾斜EDSマップを汎用のTEM(JEM-F200: 日本電子製)で取得し3D元素マップを得た。Ti粒子の直径がそれぞれ115 nm、190 nm、315 nmの粒子を抜き出し、得られた3D元素マップに対してボクセルごとにCliff-Lorimer法を適用し三次元定量解析を行った。粒子径が115 nmのときはTiと酸素の元素比が1対2になっておりTiO2であることを示しているが、粒子径が大きくなると酸素の割合が低下している。これは酸素のK線がTi粒子自身に吸収されたためと考えられる。EDSトモグラフィーは三次元構造を明らかにするために有効であるが、三次元定量解析を行うためには吸収の効果を精度よく補正する手法の確立が不可欠と言える。
Fig.4

- 塗膜試料のHAADF-STEM像。
- 塗膜試料の3D元素マップ。黄色の粒子は酸化Ti、緑色はシリカ粒子の凝集体、マゼンタ色の小片は酸化鉄に相当する。
Fig.5 新しいEDS検出システムにおける遮蔽の影響を調査した結果

横軸に試料ステージの傾斜角度、縦軸に塗膜試料のTiマップの総カウント数をプロットしている。傾斜軸の右側に配置されたSDD1は遮蔽の影響により‒20°付近でカウントが4割ほど低下している。傾斜軸上に配置されたSDD2は±60°の角度範囲でカウントがほぼ一定になっており遮蔽の影響が少ないことがわかる。
Fig.6
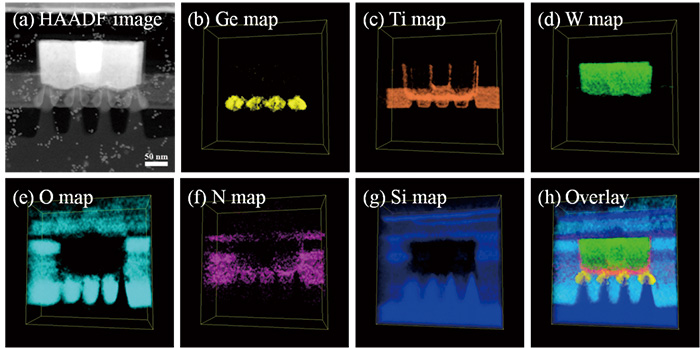
- FinFET試料のHAADF-STEM像。画像全体にある白色の粒子は位置合せのために散布した金コロイド粒子である。
- Geマップ
- Tiマップ
- Wマップ
- 酸素マップ
- 窒素マップ
- Siマップ
- 3D元素マップの重ね合わせ(Ge、Ti、W、O、N、Si)。
Fig.7 FinFET試料の3D元素マップ

Si基板の面に対して垂直なZ方向から観察した再構成断面を(a’)および(b’)とする。(a’)および(b’)中の黄色の直線で切り取った断面を観察した3D元素マップをそれぞれ(a),(b)とする。
Fig.8
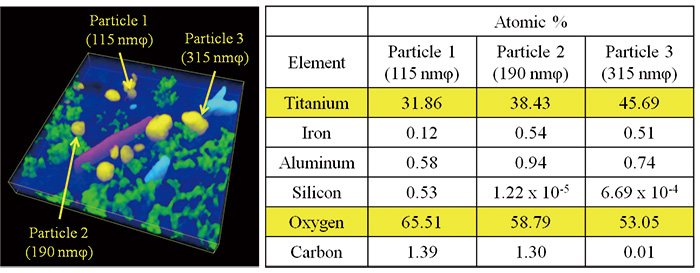
- 塗膜試料を200 kV TEM (JEM-F200、日本電子製)で取得した3D元素マップ。
- 3D元素マップ(a)中のTi粒子をピックアップして3D定量解析した結果。粒径が大きくなるほど酸素の定量結果が低くなっており、吸収の効果が寄与していると考えられる。
結論
SDDを傾斜軸上に配置した新しいEDS検出システムを300 kV TEMに導入した。EDS検出器には素子面積が158 mm2の大面積SDDを採用し、新しく開発したEDSトモグラフィー用高傾斜分析ホルダーを用いることでそれぞれ単独の検出器で1.1 sr以上の立体角が得られ、1本のSDDでも十分に早くEDSトモグラムが取得できるシステムが構築された。塗膜試料のEDSトモグラムを傾斜軸上に配置されたSDDのみで取得しTiマップの総カウント数を測定したところ、傾斜角度に寄らずほぼ一定になっており、遮蔽の効果がないことが確かめられた。またFinFET試料に新しいEDS検出システムを適用し、EDSトモグラムを得ることに成功した。WやGe、Tiなどは明瞭に3D元素マップが得られている。軽元素である窒素はSN比が低く、明瞭に三次元構造解析するには更なるX線の高収集率化が望まれる。新しいEDS検出システムを汎用の200 kV TEMに適用し塗膜試料のEDSトモグラムを取得しTi粒子に対して三次元定量分析を行ったところ、酸化Ti粒子の粒径が大きいほど酸素の元素比が低下しており、吸収の効果が現れていると考えられる。本研究では遮蔽の効果を除去することに成功したが、EDSトモグラフィーを用いて精度の高い三次元定量解析を行うためには吸収の効果を補正する手法を確立する必要があると思われる。
参考文献
- D. Hisamoto, W. C. Lee, J. Kedzierski, E. Anderson, H Takeuchi, K Asano, T. J. King, J. Bokor and C. Hu, "A folded-channel MOSFET for deep-sub-tenth micron era", IEDM Tech. Dig., (1998) pp. 1032-1034.
- H. Tanaka, M. Kido, K. Yahashi, M. Oomura, R. Katsumata, M. Kito, Y. Fukuzumi, M. Sato, Y. Nagata, Y. Matsuoka, "Bit Cost Scalable Technology with Punch and Plug Process for Ultra High Density Flash Memory" Proceedings of the Symposium on VLSI Technology, (2007) pp. 14-15.
- A. M. Cormack,"Representation of a function by its integrals, with some radiological applications", J. Applied Physics, 34 (1963) pp. 2722-2727.
- M. Hayashida, L. Gunawan, M. Malac, C. Pawlowicz and M. Couillard, "High-accuracy electron tomography of semiconductor devices", Microsc. Microanal . 21, 3 (2015) pp. 1609-1610.
- B. Fu, M. Gribelyuk, L. Dumas, C. Fang, N. LaManque, L. Hodgkins and E. Chen, "The Combination of STEM Tomography and STEM/EDS Analysis of NiSi Formation Related Defects in Semiconductor Wafer-foundries", Microsc. Microanal . 22, 3 (2016).
- K. Lepinay, F. Lorut, R. Pantel and T. Epicier, "Chemical 3D tomography of 28 nm high K metal gate transistor: STEM XEDS experimental method and results", Micron 47 (2013) pp. 43‒49.
- G. Haberfehlner, A. Orthacker, M. Albu, J. Li, G Kothleitner,"Nanoscale voxel spectroscopy by simultaneous EELS and EDS tomography", Nanoscale 6 23 (2014) pp. 14563‒14569.
- A. Genc, L. Kovarik, M. Gu, H. Cheng, P. Plachinda, L. Pullan, B. Freitag and C. Wang, "XEDS STEM tomography for 3D chemical characterization of nanoscale particles", Ultramicroscopy 131 (2013) pp. 24‒32.
- B. Goris, L. Polavarapu, S. Bals, G. Van Tendeloo and L. Liz-Marzan, "Monitoring galvanic replacement through three-dimensional morphological and chemical mapping", Nano Lett . 14, 6 (2014) pp. 3220‒3226.
- G. Möbus, R. Doole, B. Inkson, "Spectroscopic electron tomography", Ultramicroscopy, 96, 3‒4 (2003) pp. 433‒451.
- Z. Saghi, X. Xu, Y. Peng, B. Inkson and G. Möbus, "Three-dimensional chemical analysis of tungsten probes by energy dispersive x-ray nanotomography", Appl. Phys. Lett. 91 (2007) p. 25.
- L. Strueder, P. Lechner and P. Leutenegger, "Silicon drift detector̶the key to new experiments", Naturwissenschaften 85, 11 (1998) pp. 539‒543.
- I. Ohnishi, K. Miyatake, Y. Jimbo, Y. Iwasawa, M. Morita, T. Sasaki, H. Sawada and E. Okunishi, "Ultrahighly Efficient X-Ray Detection System of Two Very Large Sized SDDs for Aberration Corrected 300 kV Microscope", Proceedings of Microscopy & Microanalysis 2016, 22, S3 (2016) pp. 318-319.
- C. S. M. Yeoh, D. Rossouw, Z. Saghi, P. Burdet, R. K. Leary and P. A. Midgley, "The dark side of EDX Tomography: Modeling Detector Shadowing to Aid 3D Elemental Signal Analysis", Microsc. Microanal. 21, 3 (2015) pp. 759‒764.
- Pierre Burdet, Z. Saghi, A. N. Filippin, A. Borrás and P. A. Midgley, "A novel 3D absorption correction method for quantitative EDX-STEM tomography", Ultramicroscopy 160 (2016) pp. 118‒129.
- A. Yasuhara, "Development of Ion Slicer (Thin-Film Specimen Preparation Equipment)", JEOL News 40 (2005) pp. 46-49.
