高空間分解能走査形電子顕微鏡を用いたナノ構造材の評価・解析
日本電子news Vol.49 No.1
寺崎 治1、朝比奈 俊輔2、作田 祐介2、高橋 秀之2、堤 建一2、工藤 政都3、Robert W. Corkery4,5、Yanhang Ma1
1上海科学技術大学、2日本電子株式会社、3日本電子テクニクス株式会社、4Department of Chemistry, KTH(Royal Intitute of Technology), Sweden、5Applied Mathematics Department, Australian National University, Australia
走査電子顕微鏡(Scanning Electron Microscopy: SEM)は細く集束した電子線を試料表面に照射・走査し表面から放出された二次電子、反射電子、特性X線など試料表面での凹凸・組成・結晶構造・化学結合情報をナノスケールの空間分解能で観測する手法である[1, 2]。入射電子のエネルギーを下げると電子線照射損傷や絶縁体の像への悪影響を抑え、同時に表面からの情報を選択的に得る事が出来る[3]。最近では電子光学技術の進展により1 keV程度のエネルギーの入射電子であっても1.0 nm以下の空間分解能が、併せて電子線や特性X線の分光手法の発展により組成情報・結晶情報・化学結合情報などを場所の関数として取得することが可能になっている。本稿では、最新のFE-SEMを用いた表面構造観察に加え、低加速電圧条件下で取得された像のコントラストの起源をAuger Electron Spectroscopy (AES)で、また組成および化学結合情報をそれぞれEDSや軟X線分光器の特性X線分光器を用いて取得し、ナノ構造材料が示す特性の理解に取り組んだ。
実験 低加速電圧SEMの電子光学系
まず、SEMの分解能は、電子プローブ径の大きさが何によって支配されているか考えてみる[4]。その主要要素の1つは「電子照射系」の性能や機能による因子である。電子照射系は電子銃、複数の電子レンズ、絞り、偏向器等で構成され、電子銃から放出された電子群を細い電子プローブとして試料に照射する。
エミッタから放射された電子をある程度方向の揃った電子ビームとして取り出す部分を電子銃と呼ぶ。電子銃では、 電子が1つの点から生成される点光源を作るのが理想である。しかし実際には完全に理想的な点光源ではなく、エミッタとその電極類の形状や印加電圧を工夫し電界の分布を最適化して可能な限り小さな円板状光源を作る。この円板を仮想光源と呼び、それに続く各電子レンズは、この仮想光源(の各点からの電子)を試料面上で可能な限り集束し電子プローブとして結像させる。
電子プローブ内での電流分布をできるだけ電子光学軸上に集中させるため、軸から外れた周辺部をカットする絞りを電子照射系に設置する。電子銃から放射されその絞りを通過する全ての電子(電流量をプローブ電流量ipとする)を含む円錐の半頂角を物側開き角αoと定義する。コンデンサレンズの強さを変えてαo、ひいてはipを変えることができる。
試料面上に円錐状に電子線が集束されるとき、その円錐の半頂角は分解能を議論する際に重要なパラメータとなり、像側開き角と定義しαi 表す。後述するように、像側開き角にはプローブ電流に依存してプローブ径を最小にする最適な値が存在する。従って、開き角制御レンズと対物レンズの強さを調整して最適な像側開き角とするように設定する。
電子レンズのコイルで生成された磁場は電子にその軌道を回転させながら常に中心力として働き光軸方向に曲げるので電子レンズは常に凸レンズである(Fig. 1(a))。また、αoやαiの値はミリラジアンのオーダーで非常に小さいがこの図は光軸に垂直な方向に拡大して示してある。
また、図示していないが、対物レンズの上または下に電子プローブを試料面上で走査するための偏向器や電子ビームの進行方向の光軸からのずれを補正するための偏向器などが設けられている。
試料面上での電子プローブ径は無限に小さくすることはできず、以下に述べる輝度制限、および電子レンズの不完全さや電子自身が波動的な性質を持つため各種光学収差の制限による拡がりを持つ。以下にそれらの制限を簡単に示す。
電子銃から発射される電子源は点光源ではなく有限の大きさを持つことによる制限である。電子銃の輝度Bは単位立体角、単位面積当たりの電子電流量として定義される量である。一方、電子ビームのどこの断面で見ても輝度は不変である(輝度不変の法則)から、Bは物面側(電子銃側)で定義したものと、像面側(試料面側)で定義したものとが等しい。すなわち

ここで、doは電子の仮想光源の直径、dgは輝度制限に起因する試料面上でのプローブ径である*。(1)式から

輝度Bの値は加速電圧が低いほど低下する。
aiが微少量であるから電子レンズの球面収差による拡がりdsは次式で近似出来る。

Csは対物レンズの(像面側で定義した)球面収差係数である。
球面収差とは、電子軌道が光軸から遠く離れるほど、光軸に近い軌道の電子に較べ大きく曲げられ手前で光軸を横切ってしまうことに起因するプローブの拡がりである。
Csは、レンズの各種ディメンジョンと動作条件によって決まり同じレンズでも、電子レンズの焦点距離が長いほど球面収差係数Csは大きくなる。
電子エミッタから放出される電子のエネルギーには、エミッタの温度に対応した熱的ゆらぎがある。このゆらぎが原因となるプローブ径の拡がりを色収差による拡がりdcとよび

ここで、Vは電子の加速電圧、δVは電子が対物レンズを通過する時のエネルギーの拡がり(電子銃から放出された時のエネルギー幅)、Ccは対物レンズの(像面側で定義した)色収差係数である。
色収差は、電子はエネルギーが大きくなると曲げにくくなりレンズの焦点距離が長くなることからくるものである。
球面収差係数と同様に、Ccはレンズの各種ディメンジョンと動作条件によって決まり、やはり焦点距離が長いほど色収差係数Ccは大きくなる。また、δVは加速電圧に依存しないので低加速電圧になると、色収差による拡がりはさらに大きくなる。
電子線は質量を有する物質波(de Broglie)であるために回折現象を生じる。電子プローブは絞りでその外側を遮断されているから、そこで回折現象が生じてプローブ径が拡がる。その拡がりの径をdd、電子線の波長をλとすると、

である。低加速電圧になるほど電子線の波長が長くなるため、回折収差は大きくなる。(λ~(1.5/V)1/2 (nm): Vの単位はVolt)
これらの制限項が重畳し最終的なプローブ径dpが決まる。それぞれがガウス関数で近似出来る独立事象であるから総体としてそれらの畳み込みGaussianのconvolutionで表現される。従ってdpは(2)~(5)で与えられたプローブ径の2乗和の平方根として、近似的に次のように表すことができる。

この式は半経験的に得られたものであるが、実際と良く合う。この式の右辺にはαi2、αi2およびαi6が含むのでdpの極小値を持つαiが存在しその極小値を与えるαiを最適開き角と呼んでいる。
特に高分解能SEMでは常に最適開き角が得られるように電子光学的なレンズ系や絞り径を制御しているが、そのためには絞りから後ろに少なくとも二つのレンズが必要(二つの自由度が必要)である。そこで、「開き角制御レンズ」を設け、これと対物レンズの両方の強さを調整して最適な像側開き角とするように設定する。しかし廉価型SEMの場合にはこのレンズが組み込まれていない場合も多く、何種類かの絞り径を切り替えて、プローブ電流値の広い範囲でできるだけ最適開き角に近い設定ができるようにする。
入射電圧を低くすると、λの増大によって回折収差が増大する。また、輝度が低下するために、輝度制限項が大きくなるとともに最適開き角も大きくなる。このため、(3)、(4)式で与えられる収差項が増大するため全般的にプローブ径が大きく(分解能が悪く)なってしまう。
これらのうちどの項の影響が支配的になるかは、電子銃の種類やプローブ電流量の条件によって異なるので一概には言えない。
輝度制限項は電界放出型の電子銃ではあまり影響しないが、熱電子放出型の電子銃では、対物レンズの収差係数の大きさにもよるが、プローブ電流量の全範囲に渡って支配的な要素となる場合もある。
また、電界放出型の場合には角電流密度が大きいが、プローブ電流をμAオーダーまで大きく取ろうとすると物側開き角が大きくなり、主にコンデンサレンズの球面収差が強く効いてきてプローブ径が急激に大きくなってしまう。
低加速電圧でビーム径を小さく保つ手法の一つとして、減速法(Gentle Beam: GBと呼ぶ)が考えられ、その原理図をFig. 1 (b) に示す。電子を対物レンズ内では高加速電圧で通過させ、試料 面に発生させた静電場で減速をさせる磁場電場の複合レンズとなり球面収差係数Csと色収差係数Ccを低減ができる。[2, 5]。例えば、加速電圧が3 kV(Gun に‒3 kV を印加)、試料バイアスが‒2 kV とする。この時試料に到達する電子のエネルギーは1 keVとなる。さらに、JEOL製FE-SEMであるJSM-7800FPRIMEは中間加速法を組み合わせた電子光学系を有する。この手法をスーパーハイブリッドレンズ(SHL)とも呼ぶ。中間加速法は電子銃と試料との相対的な電位差を入射電圧値として定めた上で、電子照射系の内部を通過する時の電子の電圧を一時的に高くし、その間に行われる電子光学的な収束作用における各種収差をできるだけ小さい状態に保ち、最終的に試料面に照射される電子プローブ径を極力小さくする手法である。その原理上、対物レンズは電磁界重畳型となる[6]。このSHLは対物レンズに入る前から出るまでの間を加速する。Fig. 1(c)にその模式図と各検出器配置を示した。この対物レンズをスーパーハイブリッドレンズ(SHL)とも呼ぶ。前項で述べたGB法と組み合わせることによって、インレンズやセミインレンズ対物レンズのような制約を受けることのない汎用的な対物レンズを採用しても、低入射電圧で高い空間分解能を得ることが可能となる。
Fig. 1 Schematic drawing of electron optics and detectors.
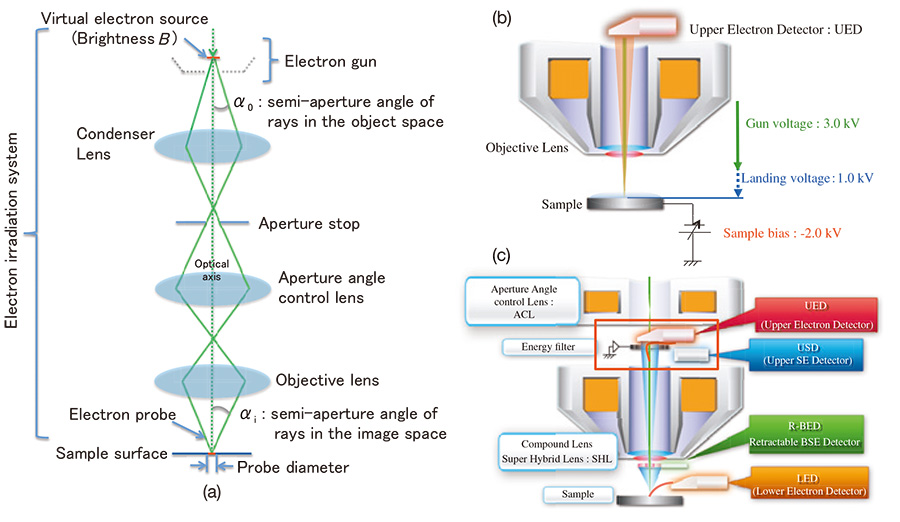
二次電子と反射電子の区別
最近のFE-SEMはカラム内にグリッド(エネルギーフィルター)と検出器を設置し二次電子(SE)と反射電子(BSE)を選別して検出することが可能となる。即ち、対物レンズ直上に設置されたUEDとUSDの間に配置されたグリットに指定の電圧を印加し電子のエネルギーによりSEはUSDでBSEはUEDで検出可能にしている。このUEDを用いると低加速電圧でも反射電子像がS/Nよく取得ができる。 Fig. 2にRuとPtクラスターを担持したCarbonの反射電子像を示す。矢印で示したクラスターは3 kVの反射電子像で明るいコントラストとして観測されるが1 kVでは見えていない。これは反射電子のエネルギーにより脱出深さが異なることを示している。エネルギー 1 keV, 3 keV の電子の脱出深さをそれぞれ t1, t3 とするとこの金属クラスターの深さ t が t1 < t < t3 であることを示している。このように入射電圧を変更しながら観察した粒子の深さ情報を得る方法は有用である。
Fig. 2 Filtered images on Ru and Pt at Carbon.
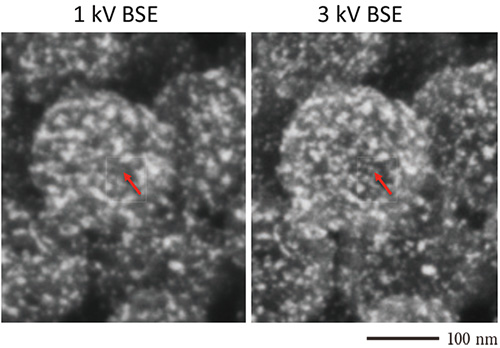
Sample: Ru and Pt at Carbon, Detector: UED Filter bias: -500 V
低加速・入射電圧でSEM観察する際の試料準備
ナノ構造材料、特に電気的絶縁体の粉末をSEM観察する際に粒子表面から試料台までの実効的電気伝導性を高めるため試料台と試料の調整に注意すべき点がある。ここで、低入射電圧でSEM像を高分解能観察する場合に簡便で有用な手法を、絶縁体であるゼオライト FAUのナノ粒子を例に試料処理上の注意点を述べる。
試料を保持する台として高純度カーボンを用いる。カーボン台は研磨紙で磨いた後更に光沢が認められる程度に濾紙を用い磨く。次に、粉末試料をエタノールに分散し、超音波洗浄機で十分撹拌した後カーボン台に滴下し、150°Cで20分程度加熱する。この加熱処理により分散液を十分取り除く事の重要性を、SEM像(SE image)を「加熱あり」と「加熱なし」を比較した結果をFig. 3に示す。この比較から加熱をすると、カーボン台はその表面の凹凸が観察される程清浄になり同時にカーボン台および試料内部から試料表面へのコンタミネーション成分の移動が抑制され、より鮮明な像が得られていることが見て取れる。
Fig. 3 Comparison with without and with heating.
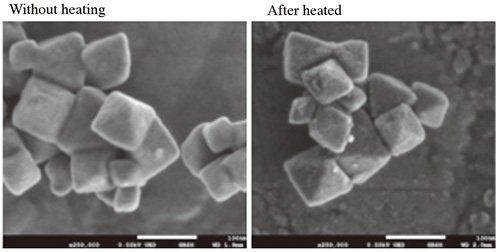
Sample: Zeolite FAU, Heating condition: 150°C for 20 min
観察条件の選定
低加速電圧SEM観察では加速電圧(電子銃)と試料入射電圧 (Impact energy)の選定が特に大きなポイントとなる。目的とする構造を把握するために最適な試料深さを見極めて加速電圧、試料バイアス電圧の設定をすることが重要となる。
その例として、Fig. 4(a)にmicroporous titanosilicate (Ti16Si80O208 (Na, K)n, ETS-10)を入射電圧 0.4 kV, 0.8 kV, 1.6 kVで同一視野を観察した結果を、Fig.4(b)に同条件でのモンテカルロシミュレーション結果を示した[8]。低入射電圧の0.4 kVでは表面のステップが明瞭に確認される。さらに0.8 kVに上げることでエッジ効果が大きくなり、非常に細かな凹凸構造が強調されて見える。1.6 kVでは内部構造を反映したような結晶コントラストが確認された。このように取得したい情報に合わせて観察条件を設定することはナノ構造材料の解析とって重要なファクターとなる。
Fig. 4
(a) Comparison of different landing voltages.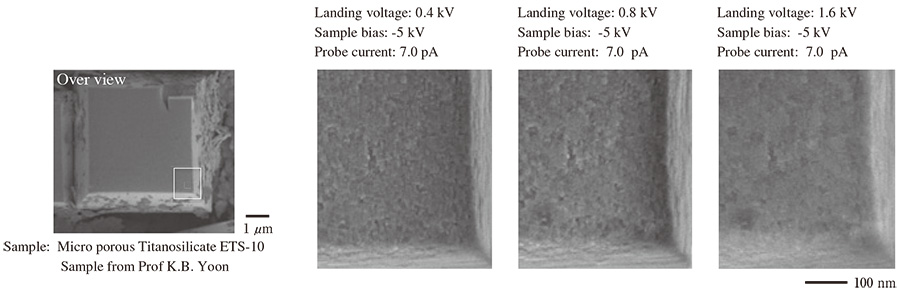
(b) Monte Carlo simulation at each landing voltage.

Auger Electron Spectroscopy(AES)法による低加速電圧 SEM
AESは静電半球型の検出器を用いて電子分光を行なう[9]。電圧をかけた半球内に電子を導入し減速させながら分光するため、高いエネルギー分解能を有する電子スペクトルが得られる。ここでは、AESで得た減速法下での電子のスペクトルから低加速電圧SEMにおけるコントラストの成因や分解能について考える。
Fig. 5にカーボン(Carbon)の半分に金(Au)をスパッターした試料のFE-SEM像とその強度プロファイルを重ねて示す。Landing voltage 500 VではCarbonはGoldより暗く、220 VにするとCarbonの方が明るくなる、歴史的に出射電子の運動エネルギーが~ 50 eV より小さいか大きいかで区別している。BSEの主成分は電子が試料内の散乱過程でエネルギーを失わない弾性散乱、一方、SEは非弾性散乱しエネルギーを失いながらも表面近傍から脱出できた電子で多くの場合、~ 20 eVにピークを持つ。
Fig. 6に同じ入射電圧条件下(入射電圧: 500 V, 220 V, Bias ‒280 V)で取得したAESスペクトルを示す。ここで、Biasが作る場は電子に対し試料に入射されるまで減速場、試料から出射後は加速場として作用する。‒280 VのBiasを掛けるとこの場により500 Vで加速された入射電子のエネルギーは試料表面で220 eV(500-280)となる。Biasを掛けた下段のスペクトルでSEが、~ 20 eV(SE3)および、~ 300 eV(SE1とSE2)に分解される事を次のFig. 7で考える。 Interaction volumeから出射するBSEエネルギーは試料表面直下では220 eVであるがBias により加速されて500 eV(220+280)となり、 Biasの有無に関わらず同じ値をとる。一方、試料表面から出射した二次電子(SE1+SE2)は、Biasで加速されてエネルギーが~ 300 eV(~ 20+280)に、また加速された二次電子や反射電子が顕微鏡内の部品に衝突し新たに生成した二次電子(SE3)は~ 20 eVにそれぞれピークを持つ。SE3の強度がSE1+SE2の強度の半分にも及び SE3の成分を減少させることに加えSE1の成分を(SE1+SE2)から選択的に補足することが二次電子像高分解能化の要点といえる。 Fig.6(a)で、入射電圧500 Vでは二次電子(SE)と反射電子(BSE)も共にAuの方が高いカウントを示している。一方で、Fig. 6(b)の入射電圧 220 V(減速場‒280 V)ではSEとBSE共にCの方がAuより高い。特に、BSEに関してCが2倍程度強度を示した。このスペクトルは試料を30°傾斜した状態で取得したものであり、FE-SEMと全く同一系ではないが、同一条件で得られたFE-SEMの像コントラストは AESで得られたスペクロトルの関係と一致している。今後詳細な解析を行っていく予定であるが、低入射電子エネルギー SEMにおける像コントラスト解釈の一助になる手法であると考えている。
Fig. 5 Contrast of different landing voltages.
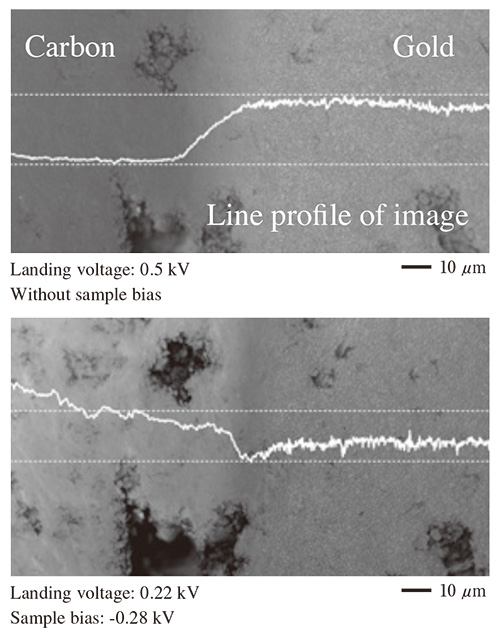
Fig. 6 Comparison of AES spectrum with and without deceleration method.
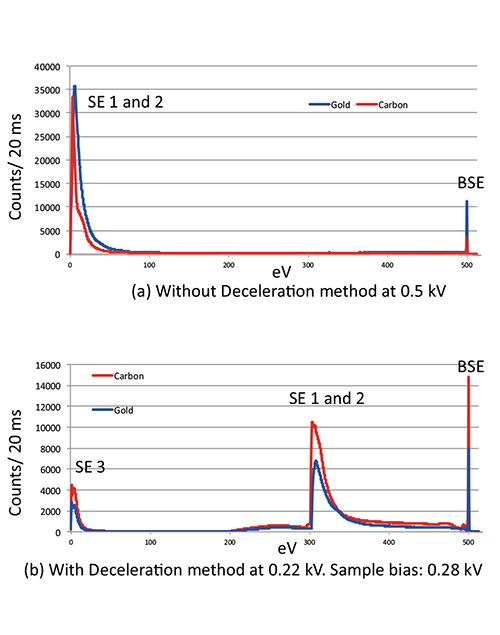
Fig. 7 Schematic drawing where BSE/SEs and characteristic X-ray are produced inside and outside of sample

長焦点モード(Large Depth of Focus: LDF)
SEMは他の光学機器に較べ焦点深度が大きい事が知られており、焦点深度を決める主要な因子は試料上への像側開き角(αi)である。通常のSEMでは対物レンズを用いて、電子線を試料上に収束するが、今回新たに対物レンズの直上に導入したAperture angle Control Lens(ACL)を対物レンズの代わりに用いると(LDFモード)試料上の開き角を非常に小さく出来る。その様子を電子線の光路図で模式的に示した(Fig. 8)。その結果LDFモードを用いると周辺の歪みを抑制した非常に焦点深度が深い情報が得られる。その例を蝶の燐粉を使って示す。通常の観察手法では空間分解能は良好なものの、焦点深度が浅い。一方、LDFを用いると焦点深度が深く、画像の歪みも抑制され高さが大きく異なる材料であっても観察や分析が可能となっている。Fig. 9には通常モードとLDFモードで取得した蝶の鱗粉の観察結果を示す。試料はオスミウムコーティング後観察を行なった。Side、Topからの観察において、低倍率の条件下ではLDFモードはフォーカスを大きく外すことなく、長焦点距離で観察できたことがわかる。特に矢印①で示した箇所はその差が顕著である。また、通常モードでは矢印②で示した観察像の周囲に若干の歪みが見られるが、LDFモードでは歪みが殆ど見られない。
Fig. 8 Principle of LDF mode.
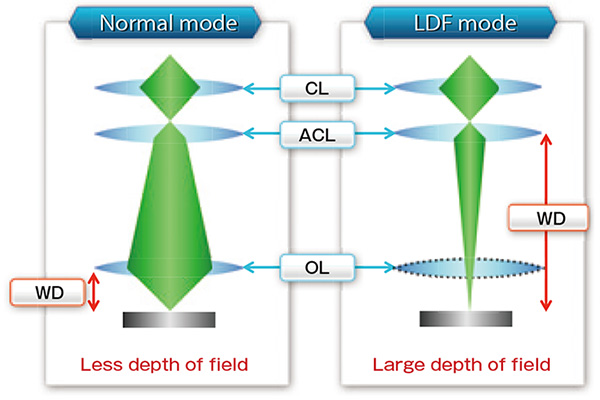
Fig. 9 SEM images: Comparison between Normal- and LDF-mode
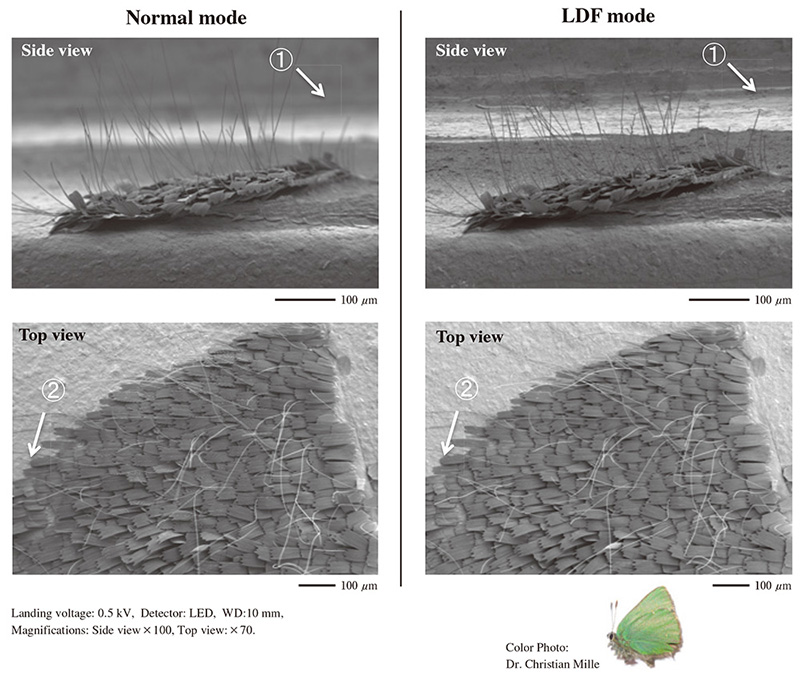
鱗粉の観察結果
子供時代に誰もが蝶を追いかけた想い出があるだろう。蝶は種毎に異なった不思議な色と模様を示し、それを捕まえると指に色のついた粉(鱗粉)を残し綺麗な翅の色が褪せる。同時に超疎水(撥水)性の翅は雨に濡れる姿に変わる。止まった時に緑色を示す蝶 Callophrys rubi(C. rubi)の翅を焦点深度の深い条件で観察すると翅膜面にそれを屋根瓦の様に庇って展開する鱗粉(鱗片ともいう)と垂直方向に伸びる鱗毛が広範囲に観察される。通常モードで撮った像と較べると長焦点モードでは焦点深度が非常に深くなり、また周辺部の歪み量が少なくなった事は上面・側面像から一目瞭然である。鱗粉(~ 20 μm × ~ 160 μm)と鱗毛を拡大してみると内部構造には相似性が見られ、どちらも同様な姿で翅膜面にソケット状に連結して居る(Fig. 10)。まるで小型木造船の舟底の様に平行に走る太い桟とそれに直交して間隔を保ちながら補強する多数の細い桟 (ridges and cross ribs)、 帆柱が垂直に伸びるが如く翅の構造が 手に取るように観察される(Fig. 11)。更に、通常屈折率の異なる物質が周期的に配列した時に見られる構造色はオパールに見られるように強く指向性を示すが、止まったC. rubiの翅がどの方向からもほぼおなじ構造色(緑色)を示す理由であるsingle gyroid (unit-cell ~ 340 nm)が切片試料で良く見える[7]。
Fig. 10 Details of Butterfly with topological contrast by LED
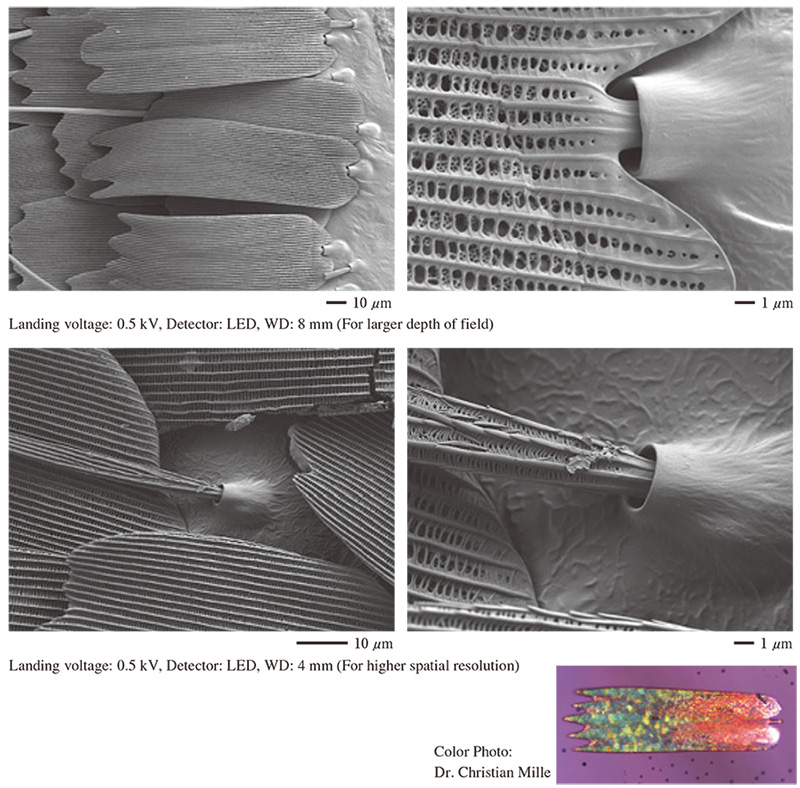
Fig. 11 Details of the cross sectioned scale.
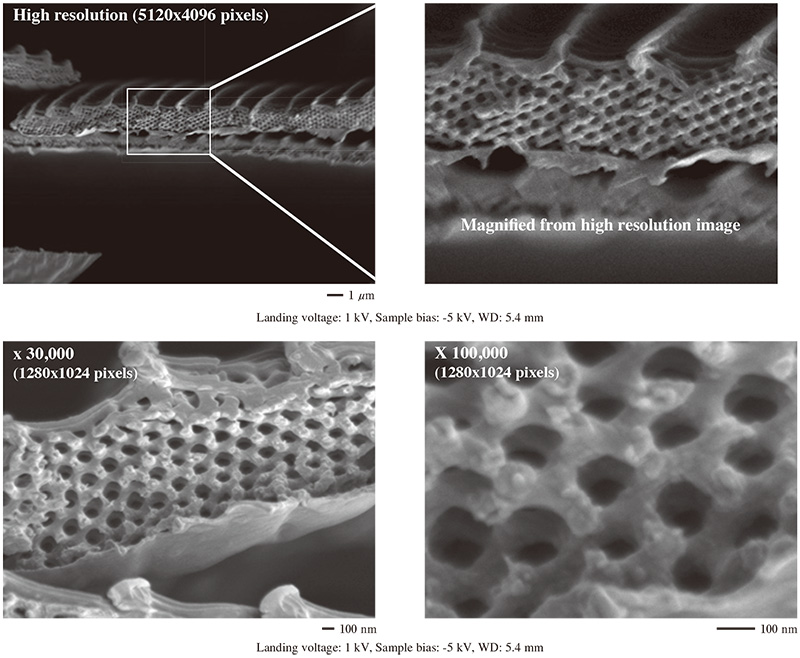
高立体角EDS検出器によるナノ構造の分析
Si-Li検出器からカウンターのDead timeが短いドリフト検出器(SDD)が開発され、大きなDynamic-range(高カウントレート)でX線を検出できるようになった。さらに、検出素子の大きさや形の選択に自由度が拡がり、より高立体角の検出器が設計できるようになった。現在、最大の受光面積は150 cm2に到達し、さらに複数の検出器を組み合わせ検出速度の向上はもちろんのこと、検出器への他部品による影やケラレの影響も抑制した検出器が開発されている。また、検出器保護用のBe窓の無いWindowless検出器の登場により低原子番号原子(これまで検出不可能の金属Li)も検出できその定量化も可能になりつつある。
ここで、Co-ZIF-8@Zn-ZIF-67の例を示す(Zeolitic Imidazolate Framework: ZIF)。Co-ZIF-8とZn-ZIF-67はCoおよびZn金属クラスターを有する事を除けば同じ結晶構造(空間群)と同じ結晶外形(rhomb-dodecahedron)を示し、更に格子定数もほぼ同じであるため粉末X線回折実験からは区別がつかない。結晶をArイオンミリングで加工し、その断面で得た反射電子像とelemental map をFig. 12に示す。断面作製には、JEOL製IB-19520CCPを用いた。試料は‒120 ℃以下で冷却しながらArイオン(加速電圧:4 kV 加工時間:4時間)による加工を行なった。この像からZIF-8@ZIF-67結晶は表面にCo、内部はZnクラスターで形成されたZIFでCo-ZIF-8とZn-ZIF-67が結晶方位を保って成長(epitaxial-growth)しCore Shell構造を形成したことがこの実験で初めて明らかにされた。また、表面のCo酸化物は矢印①で示した薄い部分と矢印②で示した100 nm程度の均一な層があることがわかる。
次に高立体角(約0.2 sr)のEDS検出器を用いて高空間分解能で元素マッピングを試みた。試料はRuとPtナノクラスターを担持したCarbonである(Fig. 13)。ここでは3つのOxford製 X-Max 150 mm2(合計の有効面積450 mm2)を用いた。高空間分解能を得るため入射電圧は30 kVである。高立体角(約0.2 sr)のEDS検出器を用いることで、30分間マッピングを行なった結果、約5 nmのPt粒子のマッピングに成功した[10]。これまでSEMでは困難であった数nmのナノ構造で元素マップが可能となって来た事を示している。
Fig. 12 EDS analysis for cross section of Co-ZIF-8@Zn-ZIF-67.
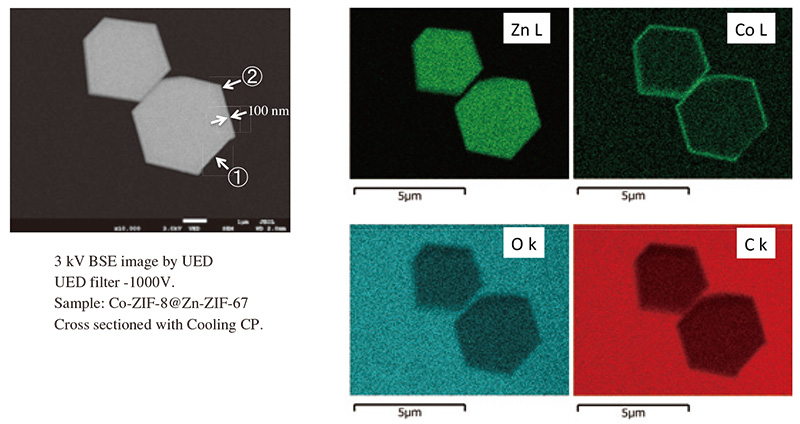
Landing voltage: 3 kV, Probe current: 100 pA, Acquisition timet: 30 min, Detector: Oxford 150 mm2
Fig. 13 High spatial resolution EDS map with high solid angle EDS
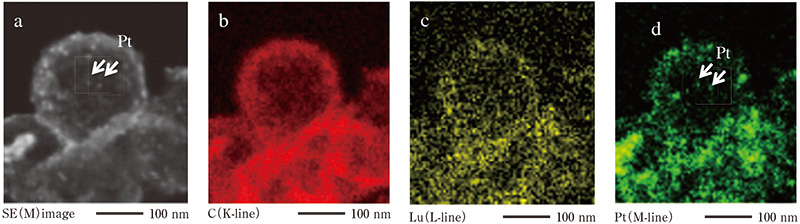
SE image of Pt/Ru@Polymer (a) and EDS maps of C (K-line) in Red (b), Ru (L-line) in Yellow (c) and Pt (M-line) in Green (d), taken at acc. voltage: 30 kV for 8 min using SDD with 3 units of 150 mm2.
Scale bars: 100 nm, Samples: Prof. Ferdi Schüth
Pt-Ni nanoframework
これはProf. Peidong Yang(UC Berkeley)groupが、Ni3Pt nano-crystalから出発してoxygen reduction reaction(ORR)で二桁も大きな活性を示すポーラスなPt3Ni nano-frameworkを作製した論文[11]に刺激されたものである。彼らの試料について低エネルギーを含めSEM観察し、その有効性を示す結果をFig. 14に示す。試料A(Ni3Pt nano-crystal)をoleylamine中でoleylamineでcapされた一様サイズのnano-crystalを作製しそれを非極性液(hexane や chloroform)中に放置すると、時間と共に試料C(Pt3Ni nano-framework)に致り、その経過がSEM観察ではっきり見える。即ち出発試料AはほぼNi3Ptの組成のA1構造 (disorder fcc structure)合金で、そのナノ結晶は模式的に示したfcc のWigner Seitz Cell状の外形を示す。一方、試料C(組成分析の結果: Pt3Ni)では緑線で示したCellの縁の部分を、Ptが優先的に占めて残ったポーラス Pt3Ni nano-frameworkである。この結果はSEMの観察条件を適切に選べば、Scienceで記述された構造評価部に相当する多くの有用な情報が得られ、特に3次元的な空間情報はより明瞭に得られる事を示している。
Fig. 14 Analysis of nano frameworks of Ni-Pt alloy.
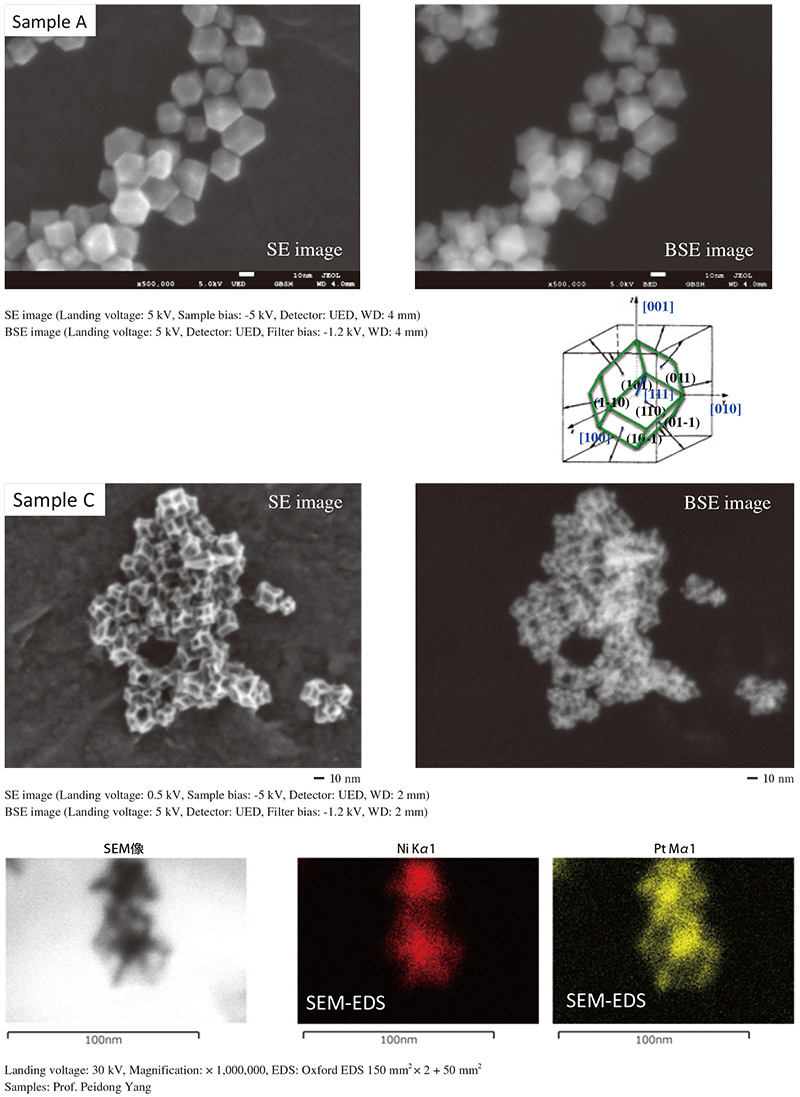
軟X線分光法による分析
さらに、X線分析技術においても革新が進んでおり、最近では、軟X線分光器(Soft X-ray Emission Spectroscopy: SXES)をFE-SEMに導入した新しい解析法が用いられ始めている[12, 13]。このSXESは0.3 eVと高いエネルギー分解能を持ち、価電子帯での電子の遷移状態を反映した情報が得られるため化学状態分析が行える。測定原理をFig. 15に示す。
測定原理を述べると、まず試料から発生した特性軟X線分光器によるX線は集光ミラーで集められ、回折格子に導かれる。この回折格子では不等間隔の溝が形成されているので、複数のエネルギーを持った特性X線を同時に分光できる点が特徴である。SXESでの炭素材料の点分析測定例を示す。Fig. 16にゼオライトのSXES測定を試みた結果を示す。本結果はゼオライトの酸素Kα線の3次線を示しており、ダメージを軽減するために低加速電圧での測定および低加速電圧で冷却(‒50°C)をしながら測定をした結果を記載している。これらの結果によると低加速電圧、低加速電圧+冷却(‒50°C)の順にダメージの影響を軽減したスペクトルが得られている。ダメージの影響を受けるにつれて、0.175 keV付近に現れるショルダーピークの減衰が確認され、結晶構造が崩れていることが示唆されている[11]。このように冷却機構と低加速電圧を組み合わせることで、ゼオライトのような熱に弱い材料でも化学状態分析が可能であり、化学状態分析FE-SEM技術の発展により、低入射電圧において高い空間分解能が得られるようになった。
Fig. 15 Principle of SXES system.
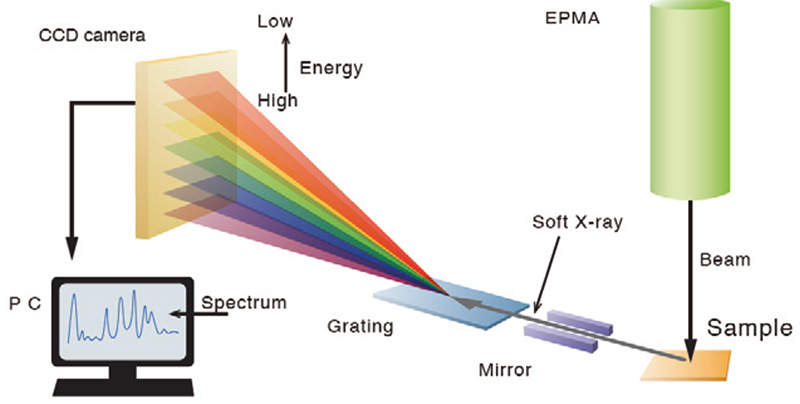
Fig. 16 SXES spectrum of Meso porous Zeolite LTA.

結論 (まとめ、おわりに)
現在、SEMは先端の基礎研究から工場での製品検査、一部の小学校においては理科の授業などでも使用されており、その活躍の場はますます広がっている。一方、筆者らはSEMに未だ大きな発展の余地があると考えている。今回、本稿ではSEMの基本、電子光学と低加速電圧SEMの構成、から出発して最新のFE-SEMを用いた表面構造観察、低加速電圧条件下で取得された像のコントラストの起源をAuger Electron Spectroscopy(AES)で、また組成および化学結合情報を特性X線分光器(EDSや軟X線分光器)などを用い取得しナノ構造材料が示す特性の理解に取り組んだ。今回の取り組みが、今後のSEM技術の発展とその利用拡大に繋がる事を願っている。
謝辞
本稿は上海科学技術大学(科技大)と日本電子の共同研究として進められた。両者から受けた強い支援に感謝すると同時に今後 SEM技術と基礎科学の発展を結びつける努力へ強く励まされた事を記す。
蝶のカラー写真を提供していただいた Dr Christian Mille に感謝する。
参考文献
- Z. Liu, N. Fujita, K. Miyasaka, L. Han, S. M. Stevens, M. uga, S. Asahina, B. Slater, C. Xiao, Y. Sakamoto, M. W. Anderson, R. Ryoo and O. Terasaki: A review of fine structures of nanoporous materials as evidenced by microscopic methods, Microscopy, 62(1): 109-146.(2013).
- L. Reimer: Image Formation in Low-Voltage Scanning Electron Microscopy, SPIE Press,(1993).
- M. Kobayashi, K. Susuki, H. Otsuji, Y. Sakuda, S. Asahina, N. Kikuchi, T. Kanazawa, Y. Kuroda, H. Wada, A. Shimojima, K. Kuroda: Direct Observation of the Outermost Surfaces of Mesoporous Silica Thin Films by High Resolution Ultra-Low Voltage Scanning Electron Microscopy, Langmuir, 33(9), pp 2148‒2156,(2017).
- 製品中に含まれる(超)微量成分・不純物の同定・定量ノウハウ - 試料前処理からデータ解釈まで - 第9章 極微小領域の構造観察 第10節 高分解能SEMによるナノ多孔質材の構造観察、技術情報協会(2014)(in Japanese).
- R. F. Pease; Proc. Of the 9th Symp. On Electron, Ion and Laser beam Technology, p. 176,(San Francisco Press, San Francisco, 1967).
- J. Frosien, E. Plies and K. Anger: Compound magnetic and electrostatic lenses for low-voltage applications, J. Vac. Sci. Technol. B7(6)(1989).
- Christian Mille, Eric C. Tyrode and Robert W. Corkery: Inorganic chiral 3-D photonic crystals with bicontinuous gyroid structure replicated from butterfly wing scales, Chem. Commun., 2011, 47, 9873-9875.
- D. Briggs, M. P. Seah, eds., "Practical Surface Analysis, vol. 1 Auget and X-ray Photoelectron Spectroscopy", John Wiley & Sons(1990).
- T. Wang, L. Shi, J. Tang, V. Malgras, S. Asahina, G. Liu, H. Zhang, X. Meng, K. Chang, J. He, O. Terasaki, Y. Yamauchi, J. Ye: Co3O4-embedded porous ZnO rhombic dodecahedron prepared by the use of zeolitic imidazolate frameworks as precursors for CO2 photoreduction, Nanoscale 8(12)(2016).
- S. Asahina, M. Suga, H. Takahashi, H. Y. Jeong, C. Galeano, F. Schuth, and O. Terasaki: Direct observation and analysis of yolk-shell materials using low-voltage high- resolution scanning electron microscopy: Nanometal-particles encapsulated in metal-oxide, carbon, and polymer, APL Materials 2, 113317(2014).
- C. Chen, Y. Kang, Z. Huo, Z. Zhu, W. Huang, H. L. Xin, J. D. Snyder, D. Li, Jeffrey A. Herron, M. Mavrikakis, M. Chi, K. L. More, Y. Li, N. M. Markovic, G. A. Somorjai, P. Yang, V. R. Stamenkovic: Highly Crystalline Multimetallic Nanoframes with Three-Dimensional Electrocatalytic Surfaces, Science, 343, 1339-1343,(2014).
- M. Terauchi, H. Yamamoto and M. Tanaka: Journal of Electron Microscopy, 50, 101,(2001).
- Y. Sakuda, S. Asahina, M. Ishizaki, T. Togashi and M. Kurihara: Analysis for Nano Porous Material by Scanning Electron Microscopy, ゼオライト, Vol. 34, No. 1(2017)(in Japanese).
