ビーム径とX線の発生領域の関係
WヘアピンフィラメントもしくはLaB6チップを電子銃にもちいた電子プローブマイクロアナライザ(EPMA)によるX線像の空間分解能は、1μm前後です。このため、3000倍以上の倍率では、X線像が滲んだような像になります。(図1.b)これは、主に試料に照射された加速電子が試料中で散乱することでX線の発生領域が、広がることに起因しています。X線の発生領域の広がりは、電子の散乱以外にも、ビーム径の太さ、X線の吸収やX線の蛍光励起の影響によって変化します。
電子線の散乱によるX線の発生領域の広がり
電子プローブマイクロアナライザ(EPMA)によるX線像の空間分解能は、1μm前後です。このため、3000倍以上の倍率では、X線像が滲んだような像になります。(図1.b)これは、主に試料に照射された加速電子が試料中で散乱することでX線の発生領域が、広がることに起因しています。X線の発生領域の広がりは、電子の散乱以外にも、ビーム径の太さ、X線の吸収やX線の蛍光励起の影響によって変化します。
電子線は、試料中で散乱され広がります。

図1 高倍率の二次電子像
(a)二次電子像
(b)X線像
分析条件
加速電圧 8kV
照射電流 10nA
分析領域 5μm×5μm

図2 電子の散乱による特性X線の発生領域の広がり
電子線が広がるのでX線の発生領域も広がります。
界面の測定における電子線の散乱の影響
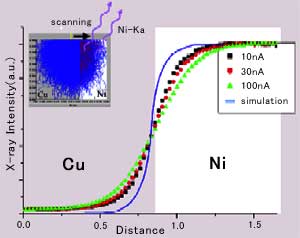
図3 Cu-Ni界面の線分析
プロットは、加速電圧15kVにてNiのK線を3種の照射電流10nA.30nA,100nAにてJXA-8100を用いて測定した結果です。 実線は、ビーム径がゼロの場合のモンテカルロシュミレーションの結果です。

図4 Cu-Ni界面の線分析結果の微分
左のグラフをZavitzky-Golay法にて微分した結果です。微分した結果は、グラフ上のX軸の座標でのX線の発生量に相当します。
X線の発生領域の広がりの変化は、異種金属の界面を測定した場合などに影響が大きくなります。この変化をCuとNiの界面の線分析により確認しました。この線分析の結果とシュミレーションの結果を紹介します。
図3は、NiをCu界面で電子ビームを走査してNiのK線を線分析した結果です。試料中で電子が散乱する効果により測定結果がブロードになり、たとえCuの領域に電子ビームが照射されている場合でもNiのX線が測定されています。
また、照射電流を変化させることでビーム径を変化させた場合の比較を行いました。照射電流が大きくなると図5のようにビーム径も大きくなります。10nA、30nA、100nAと照射電流を大きくすることでビーム径を大きくすると線分析の結果がよりブロードになっています。
次に、線分析がブロードになる効果をビーム径が、ゼロの場合についてモンテカルロシュミレーションを用いて計算しました。この条件でも試料の散乱により、界面はブロードになります。
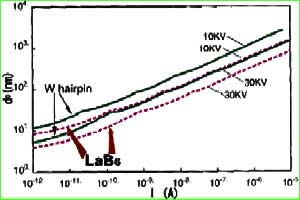
図5 JXA-8100/8200のビーム径の照射電流依存性
縦軸がビーム径、横軸が照射電流。照射電流が大きくなるほどビーム径も大きくなっています。
