FIB の像コントラスト
はじめに
FIBは比較的構造が似ているSEMと良く比較されるが、イオンと電子で固体との相互作用は異なり、得られる情報も一見似ているが、比較するとかなり異なっている。
試料へイオン照射したときに発生した二次電子は二次電子検出器で検出されSIM像として画像観察に用いられている。SEMとの比較を中心にしたSIM像の特性について説明する。
イオンの侵入深さ
イオンが固体に侵入する深さはSEMと異なり非常に浅い(Fig.1)ので二次電子などの情報も非常に浅い部分から発生する。
したがってSIM像は試料の極表面を観察していると言える。Fig.2にカーボン蒸着された隕石標本のSEM像とSIM像の比較を示す。
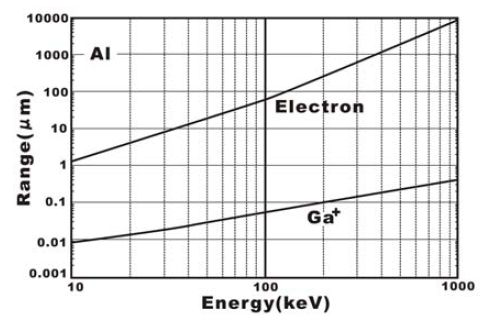
Fig.1 電子とGaイオンの飛程(レンジ)
入射イオンのエネルギーがゼロになるまでの深さを飛程と言う。Fig.1はアルミニウムにおけるGa+イオンと電子の飛程の比較を示す。30kVでは電子の飛程は約8μmに対し、Ga+イオンは0.02μmと非常に小さい。
SEM像では組織が観察されるが同一場所をSIM像観察すると無構造に見える。
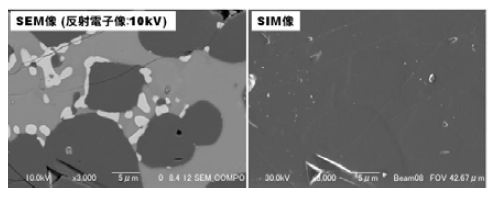
Fig.2 SIM像とSEM像で試料(試料:隕石の研磨面)の同一場所を比較した例。
導電性を得るためにカーボンコーティングを行っているため、SEM像では試料本来の表面構造を見ることができるがSIM像ではカーボンコーティングされた最表面の情報しか見ることができない。
イオンチャンネリング
イオンチャンネリングは電子チャンネリングとメカニズムが異なる。イオンは結晶の結晶軸に平行に入射すると結晶内部に深く侵入することができる。これをイオンチャンネリングと言う。このチャンネリングを起こす方位ではイオンは数10nmの深さまで侵入する。数eVの二次電子の平均自由行程は数nmであり、結晶の深い位置で励起された二次電子は結晶表面に到達できなくなり、結果的に二次電子が検出されない。
一方、結晶軸から外れたランダムな方位にイオンが入射するとイオンの侵入深さは数nmであり二次電子は多く検出される。一方、電子は回折現象なので波長を変化(加速電圧を変化)させるとチャンネリング方位が異なる。しかし、イオンの場合はチャンネリングの方位は結晶方位に依存し、イオンの種類やエネルギー(加速電圧)には依存しない。Fig.3は銅基板上にニッケルメッキさらに金メッキを行った試料をFIBで断面加工した試料である。この試料を加速電圧一定(30kV)でイオンの入射角度を変化させた場合と、イオンの入射角 度一定(60°)で加速電圧を変化させた場合とでそれぞれSIM像の撮影を行った。その結果、イオンの入射角度を変化させたときはチャンネリングの方位の変化が見られたが、加速電圧を変化させてもチャンネリングの変化は見られなかった。この結果からもイオンによるチャンネリング方位はエネルギー(加速電圧)変化に依存しないことがわかる。
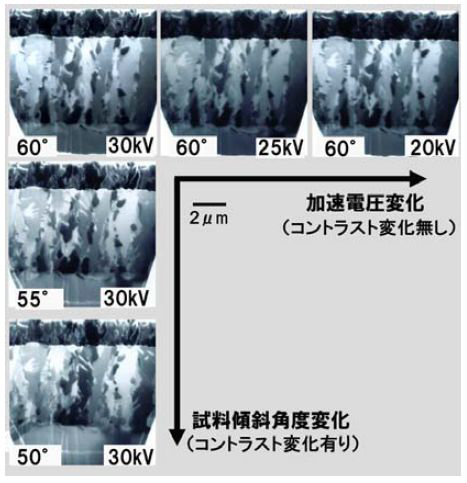
Fig.3 SIM像の結晶コントラストの変化
イオンの入射角を変化させた時と、加速電圧を変化させた時のコントラスト変化を示す。
入射角度を変えるとそれに伴い、コントラストが変化するが、加速電圧を変えてもコントラストは変化しない。
コントラストの原子番号依存性
SEM、SIM像は共に試料の構成元素の原子番号差によりコントラストが異なる。しかしそのコントラストを同一試料で比較すると逆転していることがわかる。実際の試料で比較するとその様子がわかる。Fig.4はイオン研磨されたニッケル同士のハンダ接合界面についてのSEM像とSIM像の比較である。同位置を対比するとコント ラストが逆転していることがわかる。

Fig.4 SEM像とSIM像のコントラスト逆転
イオン研磨で作製されたニッケルのハンダ接合界面のSEM像(左)とSIM像(右)の比較を示す。原子番号コントラストが逆転している様子がわかる。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 243KB
