FIB による試料作製概要
はじめに
FIBは高い位置精度で試料の矩形加工を行うことができる。また、SIM像で像観察が可能でありSEMやTEMの試料作製装置として多く利用されている。本解説ではFIBによる試料作製法の概要について紹介する。
FIBによる試料作製の概要
集束イオンビーム装置は液体金属イオン源として金属Gaが用いられる。真空中でこの液体金属イオン源と引き出し電極の間に高い電圧を印加すると電界蒸発によりGa+イオンが発生する。さらにカソードに電圧印加することによりGa+イオンを加速する(1~30 kV)。加速されたGa+イオンはコンデンサーレンズ、対物レンズ(いずれも静電レンズ)により試料上に集束させる。また、偏向板が途中に配置されておりSEMと同様に試料上で集束されたGa+イオンビームをX,Y方向に走査することができる。Ga+イオンビーム照射された試料表面からは 二次電子、二次イオン、スパッタリング粒子などが発生する。SEMと同様な二次電子検出器により表面の構造を反映した二次電子像を得ることができる。また、絞り径を調整することで試料表面に照射するGa+イオンの電流を調整することができる。比較的大きなイオン電流(数nA以上)ではGa+イオンのスパッタリング効果により試料に矩形の穴あけ加工(粗加工)を行うことができる。また比較的小さなイオン電流(数100nA以下)では精密な加工(仕上げ加工)や表面の像(SIM像: Scanning Ion Microscope image)観察を行うことができる。前述の矩形加工はこのSIM像上で加工位置を決めることができる。そのためFIBは高い加工精度を得ることができる。これによって異物や欠陥などのピンポイントな薄膜加工を簡単に行うことができる。断面加工、薄膜加工の基本的な考え方をFig.1に示す。FIBにより試料を矩形加工したときの観察面として側面を観察する(Fig.1上)。また、薄膜試料作製する場合は矩形加工を2箇所並べて行い、その間隔を100nm以下とするとTEM観察可能な薄膜(Fig.1下)を作製することができる。また、実際に矩形加工しステージを傾斜してSIM像観察した例をFig.2-1に示す。さらに、薄膜加工によりTEM観察した例をFig.2-2に示す。
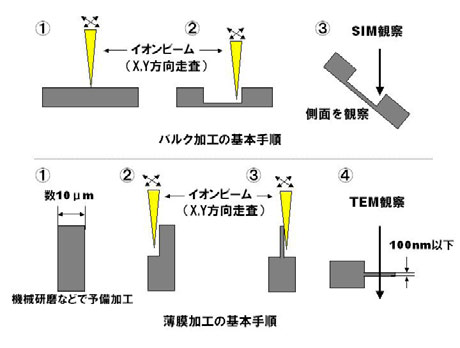
Fig.1 FIBによる試料作製法の基本的な考え方
上段は断面加工、SIM像観察プロセスを示す。FIB加工の場合、矩形の側面を観察する。底部はGa+イオンによりダメージがあり観察不可能である。 下段はTEM用の薄膜試料作製プロセスを示す。隣り合う矩形加工の間隔を100nm以下にすると電子線が十分に透過することができる薄膜試料となる。TEM試料作製のためには素材をあらかじめ数10μm幅まで機械研磨やダイシングソーなどで予備加工し、TEM試料ホルダー内に挿入できる大きさに事前加工が必要となる。
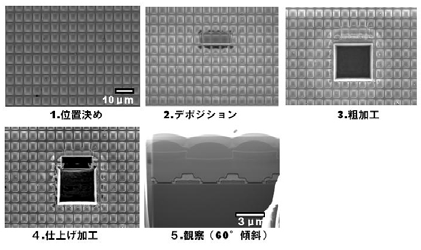
Fig.2-1 FIBによる矩形加工の基本
FIBによる矩形加工の基本手順を示す。
- 加工位置を決める。
- 断面加工する位置にカーボンなどの保護膜をデポジションする。
- 数nA以上のビーム電流で粗加工する。
- 最終目的位置を数100pA 以下で仕上げ加工する。
- ステージを傾斜してSIM像観察する(ビーム電流:数10pA)。
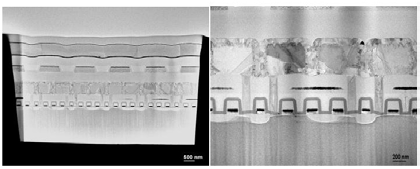
Fig.2-2 FIBによる薄膜加工の基本
Fig.1の下に示す手順により加工された薄膜試料のSTEM像を示す。写真左は薄膜加工された全体部分。写真右は部分拡大。FIBを用いた薄膜加工は一部分が薄膜化されているのが特徴である。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 333KB
