SEM-EBSD-引張試験機によるミクロ歪みのその場観察
SM2025-03
はじめに
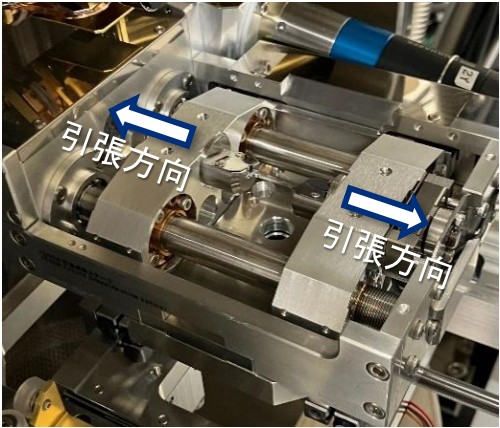
図1. JSM-IT810の試料ステージに取り付けた引張ステージの外観
走査電子顕微鏡(SEM)と電子後方散乱回折(EBSD)法は、材料科学や組織解析において欠かせない結晶粒の大きさや結晶方位、弾性歪み、微小方位差を解析することができる。また、SEM内で直接観察を行いながら材料の動的変化を評価できるin-situ引張り試験機を使うことで、機械的な変形を加えながら材料の挙動を評価することが可能である。本アプリケーションノートでは、引張試験における銅板のミクロな結晶粒の変化を動的に評価した結果を報告する。
実験系
本試験のプラットフォームとなるSEMには、EBSDに欠かせない大照射電流量を実現できるインレンズショットキーPlus電子銃を搭載するJSM-IT800SHLを採用した。EBSD検出器にはVelocity Ultra (EDAX製)、引張試験機には最大荷重 1500N のTS-1500(TSLソリューションズ製)(図1)を用いた。引張試験片はドッグボーン型に成形された銅板C1020P(1/2H)の1.0 mm厚を用意した。切り出された試験片をダイヤモンド1.0 umまで機械研磨した後、 大気炉にて500℃で焼鈍して残留歪みを取り除いた。最後にIB-19540CPクロスセクションポリッシャ™ を用いて広域平面ミリングを実施し、表面の研磨歪みと酸化膜を応力を加えずに除去した。
銅の引張EBSD試験
銅試験片に対して引張試験を実施し、破断に至るまでの挙動を評価した。図2に示す荷重-変位曲線から、試料は弾性域を経て塑性変形を示し、最終的に破断したことが確認できる。破断直前および破断後のSEM像を図2の(a)と(b)に示す。また、(a)から(b)までの破断前後におけるSEM像を記録した動画1を掲載する。動画では、変形の進行とともに銅試験片の変化を確認することができる。
変位量 0%, 5%, 12%, 20%, 36%の5つの変位ステージにおいてSEM像取得とEBSD解析を実施した。EBSD測定時のSEM条件は倍率750倍、加速電圧は20kV、照射電流量は70 nAを用いた。150 µm x 150 µmの範囲をステップサイズ0.1 µm, 収集速度は2000 ppsでEBSD測定を実施した。 各変位に対応するSEM像、IPF(Inverse Pole Figure)マップ、およびKAM(Kernel Average Misorientation)マップを図3に示す。SEM像からは、変位量 5%の段階で粒内すべり線が観察され、既にすべり変形が発生していることが確認でき、その後の変位量の増加に伴いすべり変形が進行している様子が観察された。IPFマップでは、変位量の増加に伴い結晶方位の変化が進行し、結晶粒内で色のグラデーションが顕著になっている。KAMマップは、隣接するピクセル間での方位差の平均値を示しており、局所的な結晶方位の変化を解析することができる。特に結晶粒界近傍において高いKAM値を示しており、結晶粒内よりも粒界近傍において転位密度が顕著に増加していると思われる。
このように、 In-situ 引張試験を実施しながらSEM像およびEBSDマップを取得することで、ミクロスケールにおける結晶方位の変化を連続的に観察することが可能となった。

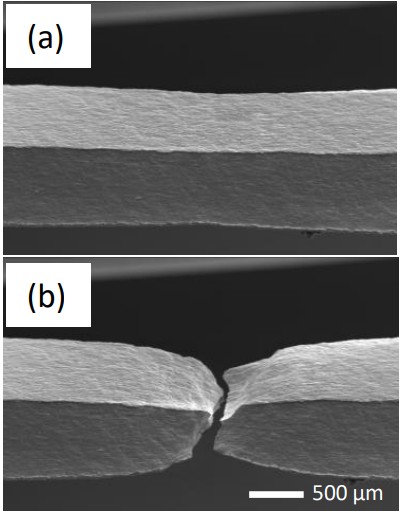
図2. 荷重ー変位曲線と破断前の低倍率SEM像(a)、破断後の低倍率SEM像(b)
動画1. 破断前後におけるSEM像
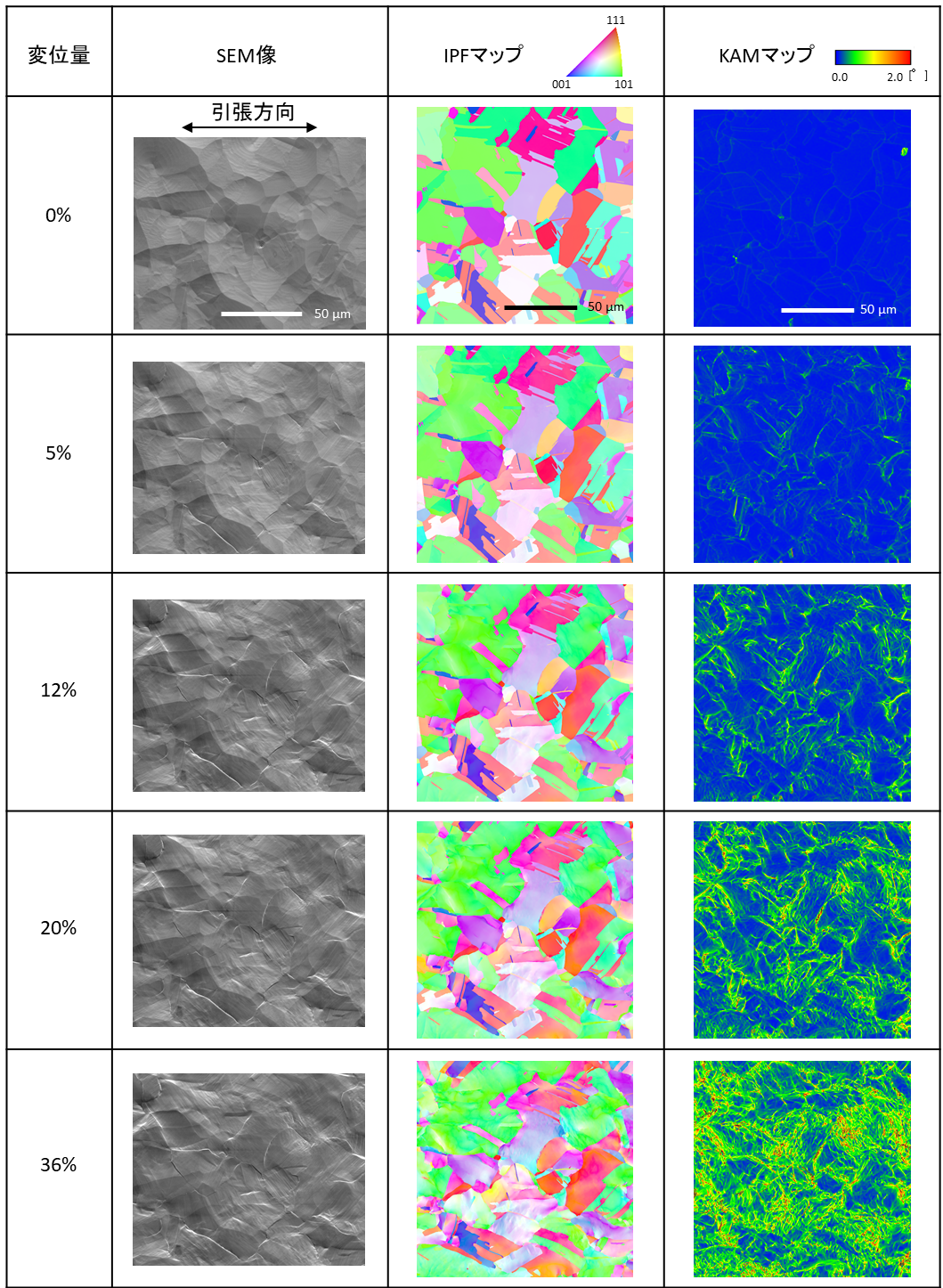
図3. 変位量0%から5%, 12%, 20%, 36%までのそれぞれにおけるSEM像、IPFマップ及びKAMマップ
