SEM-EBSDによる結晶解析
SM2022-01
走査電子顕微鏡 (SEM) と後方散乱電子回折 (EBSD:Electron Backscatter diffraction) を組み合わせることにより、試料の結晶方位・歪みなどを解析することができます。一般的に結晶方位解析には空間分解能が50 μm以上のX線回折装置 (XRD) が用いられます。一方、SEM-EBSDは高い空間分解能 (50~100 nm) を有しているので、結晶方位の局所的な変化や結晶粒界を解析できます。
SEM試料室内で試料を70°前後に大きく傾斜し、その傾斜した面に電子線を照射すると、ブラッグの法則を満たす反射電子が回折します。その結果、試料に向けて設置したEBSD検出器のスクリーンへ帯状の回折パターンが投影されます。これをEBSDパターンと呼びます。EBSDパターンに方位指数付けをすることで結晶方位の解析が可能になり、結晶方位マップも得られます。このEBSD測定による結晶構造の解析は金属やセラミックスなどの分析に広く用いられています。(EBSD原理の詳しい説明はJEOLのSEM用語集「後方散乱電子回折」を参照してください)
近年、EBSD検出器と解析法の進歩と解析を行うパーソナルコンピューターの高性能化により、EBSDパターンの取得および解析のスピードが向上し、短時間で広い領域の結晶情報を解析することが可能になりました。表1.に従来のEBSDと最新のEBSDの性能を比較しました。CCDセンサーと比較して、CMOSセンサーでは動作速度が上げやすく、最新のEBSD検出器では4500 pps (point per second) の取り込み速度が実現されました。その結果、高速にSEM-EBSDによる結晶解析ができるようになりました。
表1. 性能比較表
| 従来のEBSD | 最新のEBSD | |
|---|---|---|
| 検出器の素子 | CCD | CMOS |
| 取り込み速度 (pps) | 200 | 4,500 |
| 解像度 (ピクセル) | 1,392 × 1,040 | 1,244 × 1,024 |
| 低加速電圧時のパターン取得 | △ | ◎ |
(2022年4月調べ)
EBSDの試料作製
EBSD測定では試料表面から50 nm程度の浅い領域から発生した反射電子を収集してEBSDパターンを形成します。そのため、精度の高いデータを得るには、試料測定面が平坦で、加工ダメージも可能な限り少ないことが重要となります。例えば、機械研磨で試料作製時に形成されたダメージ層や酸化膜により、EBSDパターンの鮮明度が低下します。従来、コロイダルシリカスラリーを利用したCMP (Chemical mechanical polishing) を用いた試料作製が一般的でしたが、現在ではイオンビーム加工(製品情報を参照) による試料作製がEBSD測定にとって不可欠となっています。
大照射電流によるEBSDパターンの質向上および取得時間の短縮
鮮明なEBSDパターンを得るためには、小さいプローブ径で大照射電流が得られる電子光学系が適しています。図1は照射電流によるEBSDパターンの違いを示した例になります。照射電流を大きくすることで、鮮明なEBSDパターンが得られることがわかります。EBSDパターンのS / Nが良いほど、指数付けの精度も向上します。また、大照射電流にすることでEBSD結晶方位マップ像を短時間で収集することができます。
- 試料: Si単結晶
- EBSD: Oxford社製Symmetry (CMOS)
- 加速電圧: 20 kV
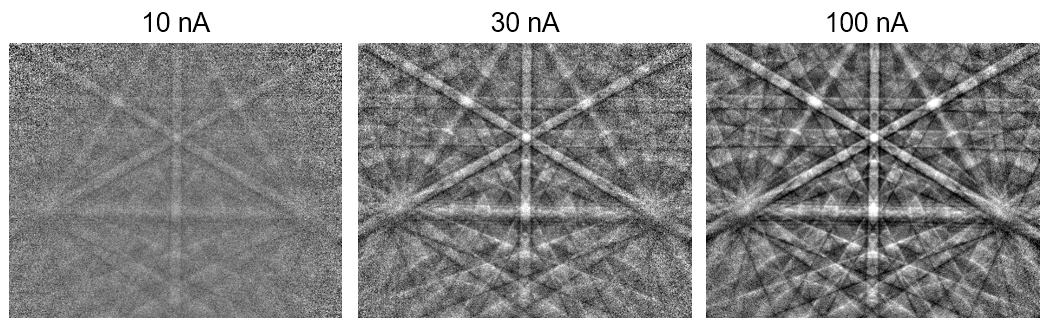
図1
ただし、照射電流を増やすと電子プローブの径は大きくなり、空間分解能が低下するので、実際の分析では照射電流を変更し最適値を選ぶことが必要です。JEOLのFE-SEM (製品情報を参照) には独自開発した電子光学システムNeo Engineと開き角最適化レンズが組み込まれているため、大照射電流下でも常に小さなプロープ径を維持できるようになっています。
低加速電圧による熱ダメージ低減
従来のEBSD測定はSEMの加速電圧を15~25 kV と高く設定する必要がありましたが、CMOSセンサー搭載のEBSD検出器は高感度であるため、3~5 kV 程度の低加速電圧の領域でもEBSD測定が可能となりました。低加速電圧で測定を行うことができるため、熱に弱い試料の測定や試料の極表面の結晶解析も行えるようになりました。
EBSDとEDSのインテグレーション
EBSDの解析にはSEM像と元素情報が必要になることが多く、その場合は傾斜された試料に対して、二次電子検出器とEDS検出器をSEM-EBSDに併設した装置を使用します。EBSDとEDSを併用することで、EDSから得られた元素情報を基に、組織解析だけではなく、相分離・相同定も同時に実施できます。
解析例
以下に実際の解析例を紹介します。
1.局所領域の方位マップ解析
EBSDによる局所領域の方位解析の例を図2に示します。この例では試料に亜鉛めっき鋼板を用いました。亜鉛めっき鋼板断面の反射電子像から、多結晶であることや結晶の大きさ、組成の違いがわかります。EBSD測定の結果から、亜鉛めっきおよび鉄の結晶方位マップが得られます。このように、SEM像だけではわからない局所の結晶情報をEBSDにより解析取得することができます。
- 試料: 亜鉛めっき鋼板
- 試料作製: CP
- EBSD: TSL社製 DigiView (CCD)
- 加速電圧: 15 kV
- 照射電流: 10 nA
- ステップサイズ: 100 nm
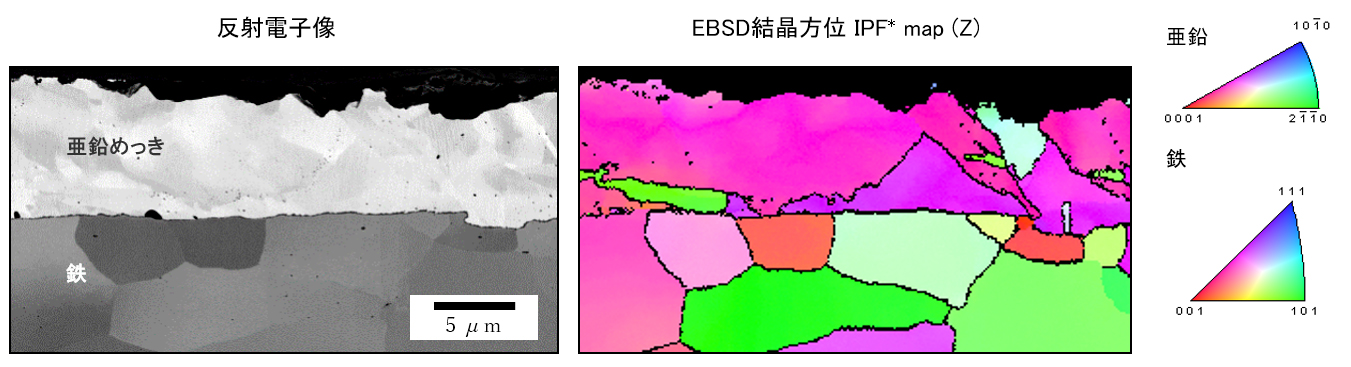
*IPF: inverse pole figure
図2
2.広領域の方位マップ解析
結晶粒が大きい試料を広領域測定した例を示します。図3は、多結晶Si基板の約30 mm × 13 mmの指定範囲内を倍率100倍の条件でステージを自動的に移動して測定した結果です。取得した多数のEBSD方位マップをつなぎ合わせることによって広領域の解析ができるようになります。
- 試料: 太陽電池用多結晶Si基板
- 試料作製: CP
- EBSD: TSL社製 DigiView (CCD)
- 加速電圧: 20 kV
- 照射電流: 20 nA
- ステップサイズ: 30 μm
- 測定領域: 29,040 μm × 12,870 μm
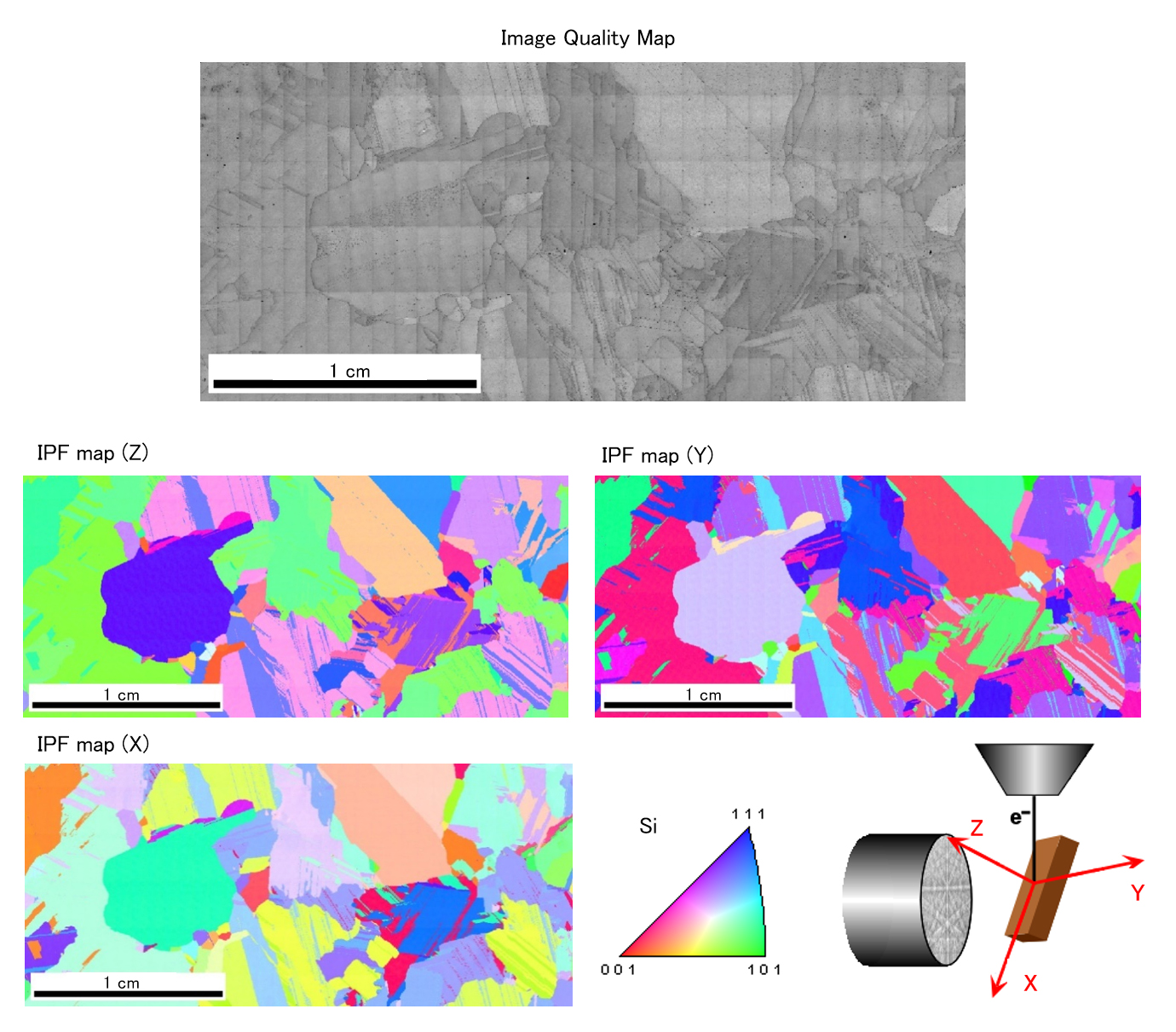
図3
3.サブミクロン結晶粒の高速・高精細方位マップ解析
SEM本体とEBSD検出器の進歩により、高感度CMOSセンサーでEBSDパターンを取り込めるようになり、高速で測定することが可能になりました。
図4に鋳鉄の例を示します。鋳鉄には数10 ミクロンからサブミクロンまで様々なサイズの結晶粒が存在しており、その様子を全体的に捉えるには高精細のEBSDマップを取得することが必要になります。下図 (左) は150 μm × 160 μmの領域で測定した結果です。この測定をステップサイズ60 nmで従来のCCDセンサーを搭載したEBSD検出器で行った場合、取り込み速度100 pps程度となり、測定時間は18時間以上かかります。ステップサイズを大きくすることで取得時間を短縮できますが、分析点の間隔が広がり、微細な結晶粒からのEBSDパターンが得られなくなるなどの理由から、粗い方位マップしか得られません。これに対し、最新のCMOSセンサーを搭載したEBSD検出器を使うと、3,000 pps 以上の高速スキャンが可能となり、33分で各結晶粒の結晶方位を正確かつ高速に捉え、超高精細の方位マップを取得できます。
- 試料: 鋳鉄断面
- 試料作製: 機械研磨+CP平面ミリング
- EBSD: Oxford 社製 Symmetry (CMOS)
- 加速電圧: 20 kV
- 照射電流: 200 nA
- ステップサイズ: 60 nm
- 測定領域: 150 μm × 160 μm
- 測定時間: 33 min
- 測定点数: 6,667,500
- 取得スピード: 3,335 pps
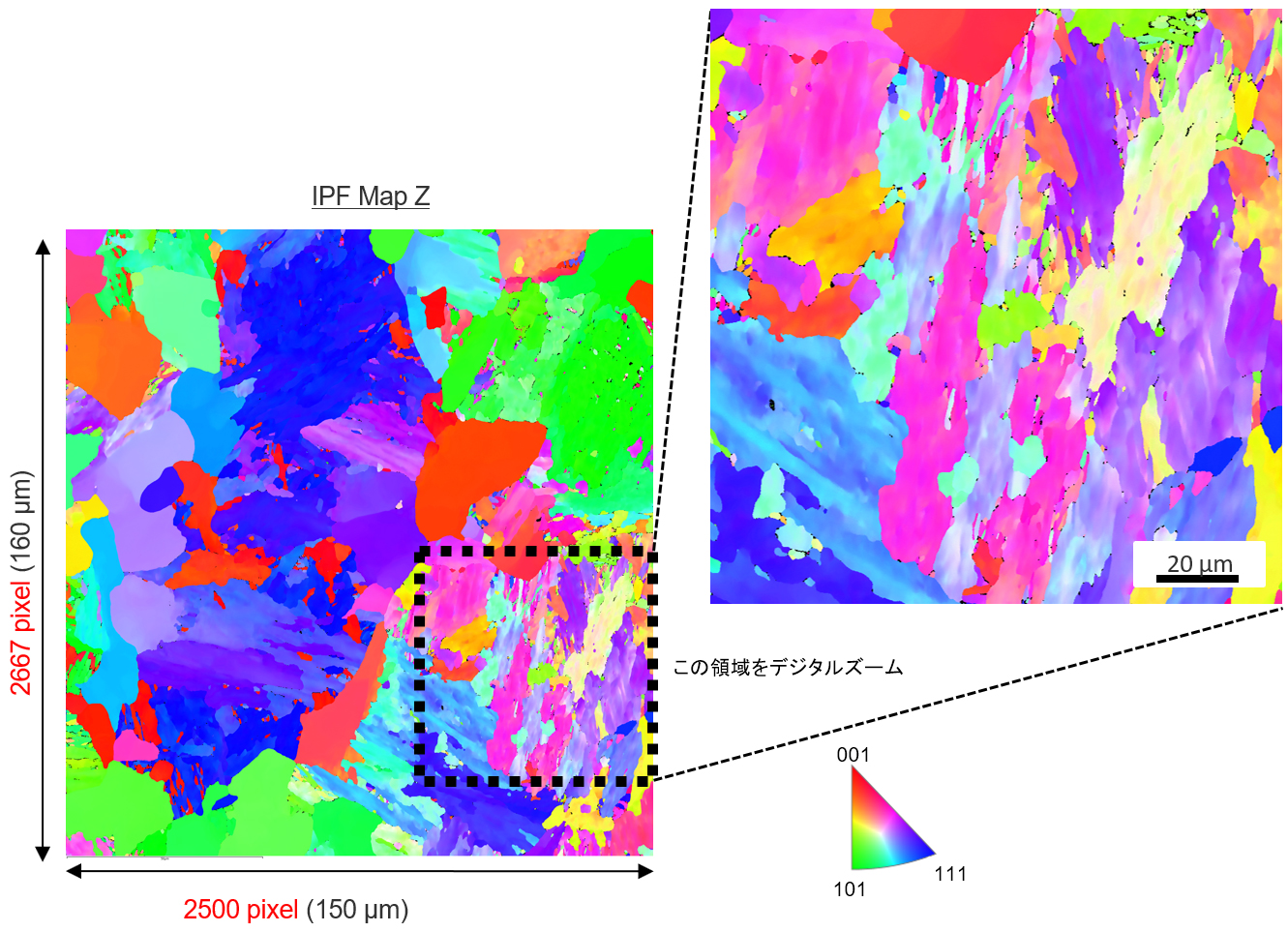
図4
4.EDS / EBSD同時測定による相分離方位マップ解析
EBSD測定は、結晶構造を特定した上で方位の違いを解析する方法です。しかし、同じ結晶系でも組成が異なるものが多数存在するため、EBSD測定のみで物質の相を識別することは困難です。図5に酸化アルミニウム (Al2O3)、タングステン (W)、モリブテン (Mo) で構成されているセラミックス基板の構造解析の結果を示します。WとMoは同じ体心立方構造をとるため、EBSD方位マップからは区別ができません。これに対してEDS / EBSDの同時測定を行うと、元素マップと結晶方位マップを組み合わせることができるため、同じ結晶系でも物質ごとに分離した方位マップを得ることができます。
- 試料: セラミックス基板
- 試料作製: エッチング+CP
- EBSD: TSL社製 DigiView (CCD)
- EDS: ドライSD™
- 加速電圧: 20 kV
- 照射電流: 10 nA
- ステップサイズ: 100 nm
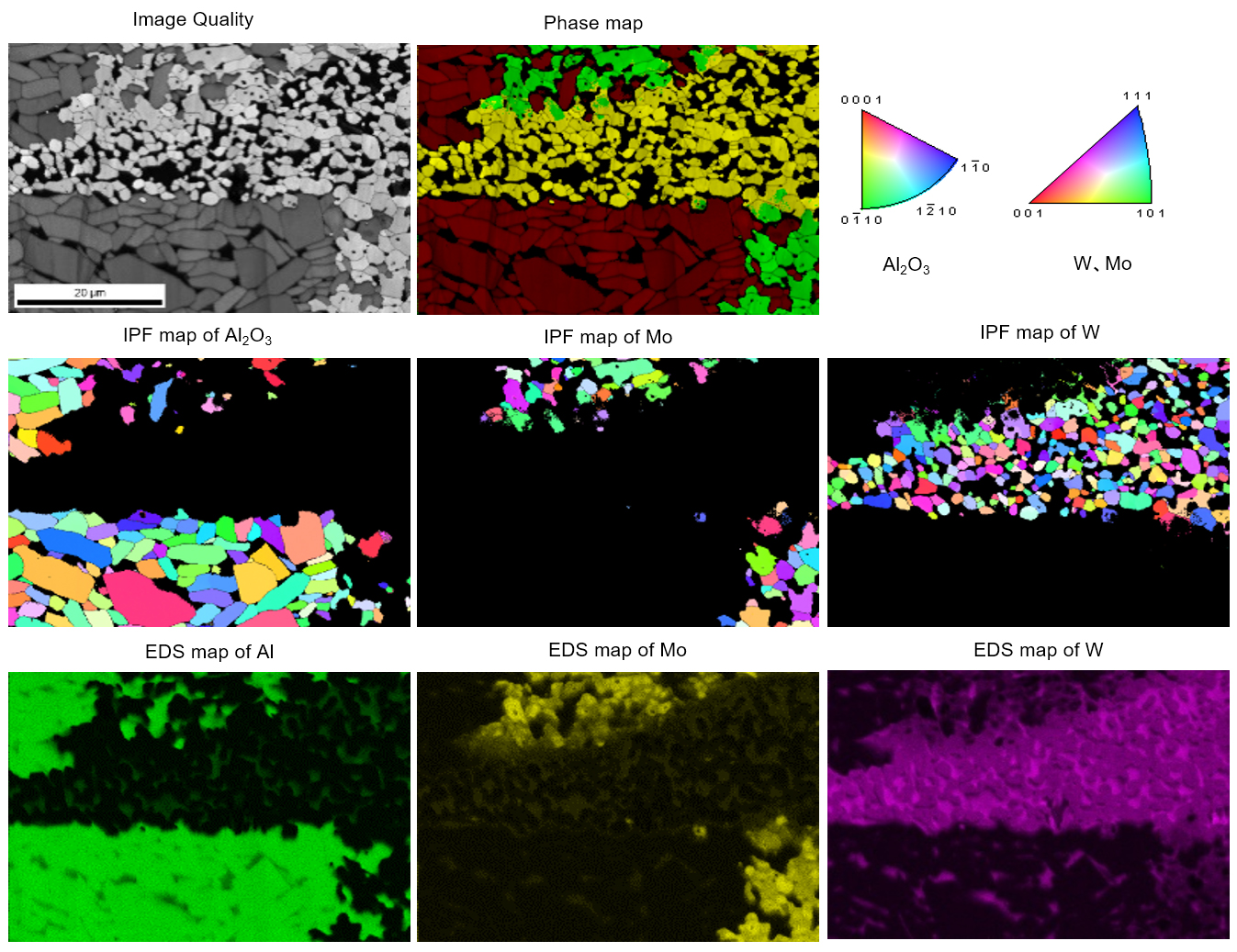
図5
5.低加速電圧による熱ダメージを低減した方位マップ解析
従来、生体試料のような電子線照射によりダメージが発生しやすい試料では、高加速電圧によるEBSD測定は難しいとされていました。図6 (左) は板状のアラゴナイト結晶と有機物の膜が交互に積層して生成された真珠層を加速電圧10 kVでEBSDを測定した結果です。10 kVでは電子線照射によるダメージが発生するため、EBSDパターンが検出されず指数付けが行えない領域が存在しています。特にアラゴナイト結晶の界面部では顕著です。右図は5 kVでEBSD測定を行った結果です。最新のCMOSセンサー搭載のEBSD検出器により低加速電圧5 kVの条件でもEBSD解析を行えますので、電子線によるダメージを軽減でき、高解像度のマップが取得できます。
- 試料: アワビ貝真珠層
- 試料作製: CP
- EBSD: Oxford 社製 Symmetry (CMOS)
-
測定条件 1 2 加速電圧 10 kV 5 kV 照射電流 1 nA 5.7 nA ステップサイズ 200 nm 100 nm
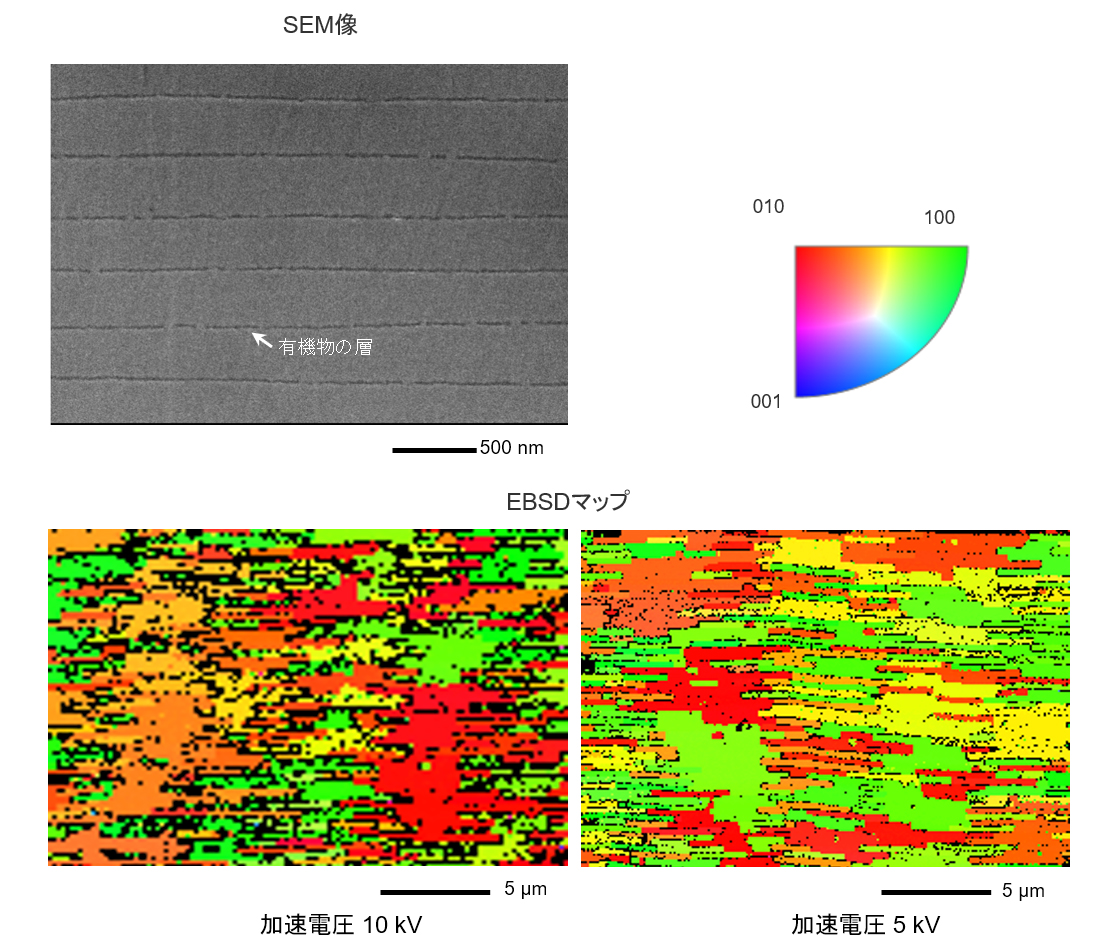
図6
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 6.61MB
