JEM-2500SE:ナノメートル領域解析ツール
高分解能SEMを用いたバルク試料の観察や分析に限界を感じていませんか!?
高分解能 SEM を用いたバルク試料での材料評価は、手軽で迅速なフィードバックができる反面、ナノメートル領域の微細部分の解析は限界に近いと言えます。その理由は、高分解能 SEM といえども分解能の限界があることと、半導体デバイスの薄膜構造などでは材料の違いによるコントラストが十分に得られないということです。
また、バルク試料では元素分析を行うとき、入射電子が試料内部で侵入拡散するために、分析領域が場合によっては数ミクロンという広がりを持ってしまいます。一方、FIB (集束イオンビーム装置) を使って試料作製 (薄膜加工) をして、出来あがった薄膜試料を TEM や STEM で観察すれば
- 高分解能 SEM に比べ、飛躍的に分解能が向上します(原子レベルの分解能)
- 分析領域を小さくできます(ほぼビーム径と等しい分析領域)
- 結晶情報が一目で分かります(単結晶 ・ 多結晶 ・ アモルファスの区別、結晶欠陥の存在)
しかし、一般的に TEM はオペレーションが難しいことや暗い部屋が必要などの理由から、現場に近い部署では敬遠されがちでした。でも、つぎのようなコンセプトの複合解析ツールがあったらどうでしょうか !
- 高性能な SEM、STEM、TEM の各像が簡単に得られる
- 明るい部屋で使い慣れた SEM の感覚でオペレーションできる
- 高感度 EDS などの分析機能が充実している
- FIB との試料ホルダーの互換性を高めたため試料前処理と観察のスループットが良い
JEM-2500SE はこのようなコンセプトに基づいて創られた、新しいナノメートル領域の解析ツールです。図.1 に JEM-2500SE の外観を示します。
本装置は、観察場所の特定や表面形状観察のための SEM 機能と、 SEM と同じ感覚のオペレーションで高分解能像が得られるとともに EDS との組み合わせによって元素分析ができる STEM 機能、 さらに原子分解能での高分解能像観察と原子分解能での観察に必須である電子回折パターンを得ることができる TEM 機能を合わせ持っています。
SEM 像 ・ STEM 像 ・ TEM 像の切り替えは、観察画面上の GUI 上から容易に行えます。また、本装置は、 従来型の TEM のような像観察室(蛍光板上で像を観察)を持たず、全ての画像は観察用の液晶モニター上に表示されます。
したがって SEM 像 ・ STEM 像 ・ TEM 像の全てが明るい部屋で観察できます。
図.2 に JEM-2500SE の構成を示します。
 図.1 JEM-2500SEの外観 |
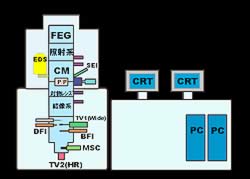 図.2 JEM-2500SEの構成 |
図.3(a)(b) に JEM-2500SE で得られた半導体デバイス(フラッシュメモリ)の STEM 明視野(STEM-BF)像と STEM 暗視野(HAADF)像を示します。デバイスを構成する薄膜構造が鮮明に観察されています。
図.3(c) は同一視野の TEM 像、また図.3(d) はその一部を高倍率で観察した TEM 像(格子像)です。STEM 像と TEM 像を得るために、電子回折パターンを見ながら試料傾斜をコントロールして、試料の単結晶基板を完全に水平に置きました。
図.4(a)(b)(c)(d)(e)(f) はフラッシュメモリの STEM-BF 像と HAADF 像に加えて、シリコン(Si)、窒素(n)、酸素(O)、タングステン(W)の EDS による元素マップを示します。この EDS を使ったナノメートル領域の元素分析のために、X 線の取り込み角度を大きくすることで EDS の高感度化を図りました。
また、微量元素のマッピングには時間がかかりますが、その際のドリフトを防止するためのドリフト補正機能も有しています。
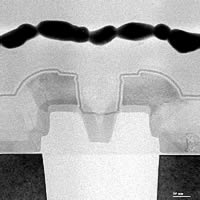 図.3 (a) フラッシュメモリ STEM-BF像 |
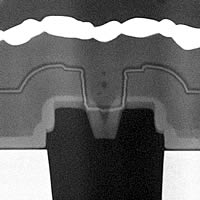 (b) HAADF像 |
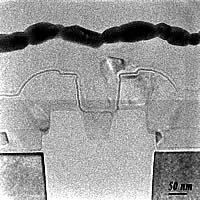 (c) TEM像 |
 (d) TEM像 |
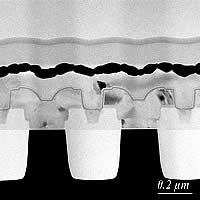 図.4(a) STEM-BF像 |
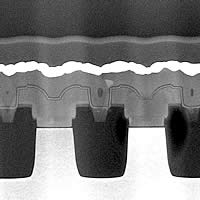 (b) HAADF像 |
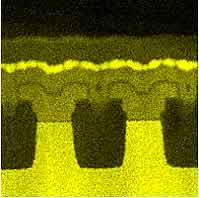 (c) Siマップ |
 (d) Nマップ |
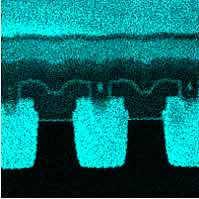 (e) Oマップ |
 (f) Wマップ |
図 .3 および図 .4 のデータ収集の手順を以下に示します。
- 試料を JEM-2500SE に挿入後、SEM モードでFIBによって薄膜加工された部分を探しました。
- 電子回折モードに切り替えて(GUI 上よりマウスで選択)、基板が水平になるように回折パターンを見ながら試料のX、Y 軸傾斜を調整しました。
- STEM モードに切り替え (GUI 上よりマウスで選択)、形状観察、EDS による元素分析を行いました。
- TEM モードに切り替え (GUI 上よりマウスで選択)、さらに高分解能観察を行いました
さて、使い勝手のよい性能の解析用ツールがあっても、目的に合った試料が作れなければ、解析用ツールは役に立ちません。 日本電子は STEM/TEM 用の薄膜試料を誰でも高スループットで作製することのできる FIB(JEM-9310FIB)を開発いたしました。
また、FIB による試料作製と JEM-2500SE を使用た観察 ・ 分析をスムースに行うために、JEM-9310FIB と JEM-2500SE の試料ホルダーの互換性を高め、さらなる高スループット化を実現しました。
JEM-2500SE は、日本電子の熟成された電子光学技術を新しいコンセプトに基づき再構築し、高性能 ・ ハイスループットを実現したナノメートル領域解析ツールです。
