FIB の加工特性:加工ダメージ
はじめに
FIBによるTEM用薄膜試料作製は、その加工精度の高さや従来法であるイオンミリング法と比較して遥かに簡便であるため多くのTEMユーザーが行っている。しかし、Ga+イオンによる試料へのダメージが懸念される。そこでSi単結晶のTEM試料作製時に薄膜両面に導入されるアモルファス層の厚みが加工条件によってどのように変化するか紹介する。
Ga+イオン加工によるダメージ導入
Fig.1~2にはSi単結晶の薄膜加工時に導入されるアモルファス層のGa+イオンビームの電流、加速電圧変化と厚みの関係を示す。 Fig.1はGa+イオンビームの加速電圧一定(30 kV)でGa+イオンビームの電流を変化させた時のアモルファス層の厚さ測定結果を示す。実用的な範囲でのGa+イオンビーム電流ではアモルファス層の厚みは23nmと一定であることがわかる。 Fig.2はGa+イオンビーム電流が一定で加速電圧を変化させた時のアモルファス層の厚み変化を示す。さらにFig.3は実際にアモルファス層の厚さ測定を行った試料の断面TEM像を示す。加速電圧に対しアモルファス層の厚みはほぼ線形に変化することがわかる。

Fig.1 イオンビーム電流とSiにおけるアモルファス層の厚みの関係(JEM-9320FIB、加速電圧:30 kV)
加速電圧一定(30 kV)でイオンビームの電流を変化させても薄膜両側に形成されるアモルファス層の厚さは変化しない。

Fig.2 オンビーム電流一定、加速電圧とSiにおけるアモルファス層の厚みの関係(JEM-9320FIB の場合、イオンビーム電流:100 pA)
イオンビーム電流一定で加速電圧を増加させるとアモルファス層の厚さは増加する。Arイオンにより2 kVで仕上げ加工を行うとアモルファス層の厚みはさらに減少する。
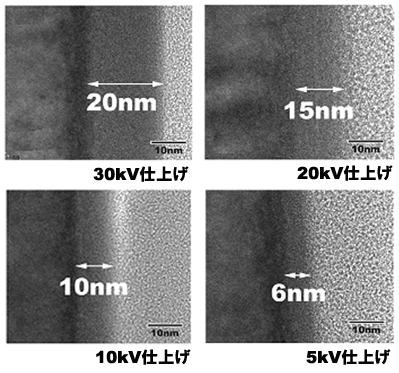
Fig.3 加速電圧変化によるSi薄膜に導入されるアモルファス層の厚み変化のTEM像
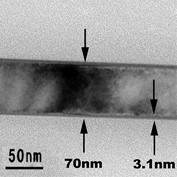
Fig.4 2 kVのArイオンで仕上げた時のアモルファス層の厚み
さらに2 kVのAr+イオンで仕上げた場合のアモルファス層の厚みをFig.4に同時に示す。その厚みは約3nmであり非常に薄くなっている。したがってTEM像のコントラストを低下させるアモルファス層の軽減にはGa+イオンビームの加速電圧を下げると効果的であることがわかる。また、低加速(2 kV)のAr+イオンで仕上げるとさらに効果的であることもわかる。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 385KB
