第13回 SEMユーザーズミーティング
第39回 EPMA・表面分析ユーザーズミーティング
第3回 イオンビーム試料作製セミナー
本年は SEM / EPMA・表面分析 ユーザーズミーティング、イオンビーム試料作製セミナーをオンラインで開催します。
開催期間中、ご都合の良い時間に動画や資料をご覧いただけます。
WEBに接続できる環境であれば、パソコンからだけでなく、スマートフォンやタブレットからも視聴できます。
本年も例年と同様、外部講演の先生方の発表を含め、さまざまな分野を網羅した新技術情報や実践的技術情報をお届けします。
アプリケーションポスター、パネル / カタログなどの製品情報、キャンペーン情報もご覧いただけますので、ぜひご活用ください。
公開期間は2020/10/30をもって終了しました。
講演
低加速電圧走査電子顕微鏡で見る最表面
SEM_1
実験研究者にとって、走査電子顕微鏡は様々な材料の形状・表面観察、さらには組成分析などを行うことのできる非常に強力なツールです。
本講演では、ナノ材料の合成及び観察を行う立場から、低加速電圧走査電子顕微鏡をどのように活用すれば試料の最表面を観察できるか、具体例やノウハウを紹介したいと思います。

講師
髙見 誠一 様
名古屋大学
大学院工学研究科
美麗な像が未来をつくる ~JSM-IT800‹SHL›の各検出器による情報選択~
SEM_2
JSM-IT800‹SHL›は情報選択を可能とする多種検出器を光軸上に搭載した最新のハイエンドFE-SEMです。
SEMは電子線の照射により試料から放出された電子を取得して像を形成します。しかし、試料が持つ様々な情報は、電子のエネルギーや放出角度によって異なり、多種類の検出器を使い分けることで必要な情報を選択することができます。一方、多種類の検出器の歴史は浅く、それを用いた応用紹介が少なく、オペレータはその検出器選択に困惑することがありました。
本セミナーでは、各検出器の特長と各検出器での情報選択について応用例を交えて紹介します。

講師
山口 祐樹
日本電子株式会社
EP事業ユニット
あの難試料が冷やすと見える!LV冷却ホルダのすすめ
SEM_3
含水試料とソフトマテリアルはSEM観察が難しい試料です。
近年、この難試料をSEMの低真空(LV)機能と冷却ホルダを用いて簡便に観察する手法を提案しています。今回、この手法を用いて、シイタケ、大葉、柔軟剤、プラスチック消しゴムのSEM観察を行い、冷却ホルダ不使用の場合と比較しました。
その結果、シイタケ、大葉、柔軟剤では試料形態の保持時間が長くなり、プラスチック消しゴムでは電子線由来の試料ダメージを軽減することができました。

講師
池谷 綾美
日本電子株式会社
EP事業ユニット
新製品紹介 JSM-IT800SHL
SEM_4
FE-SEMでは高空間分解能観察だけではなく、高い操作性が求められます。重要な要素は明るいSEM像と直感的に操作できるGUIです。
これらを実現するために、JSM-IT800(SHLバージョン) では高いS/Nで明るい像取得が可能な新型検出器を搭載し、さらに光学像とSEM像をシームレスにつなぐZeromagや、SEM観察とEDS分析操作を統合したEDSインテグレーションといった機能を持つGUIを搭載しました。

講師
村上 諒
日本電子株式会社
EP事業ユニット
新製品紹介 JSM-IT700HR
SEM_5
微細化に伴い観察が難しくなる試料を日常的に測定しなければならないという声から、走査電子顕微鏡(SEM)を楽に操作するニーズが高まっています。
リサーチ目的だけでなく、さらに早く、高画質なデータを取得したい、分析を意識しないで、より簡単に組成情報を確認したいというニーズに応えるために、<「見える」よりも「楽に見える」>をテーマに誕生した SEM JSM-IT700HR を紹介します。
最高分解能1 nm、最大照射電流300 nA (従来機15倍) を発揮する電子銃は観察・分析に余裕を感じさせてくれます。楽な操作で誰でも自由自在に高分解能と多用途の分析機能が利用できるようになります。

講師
三島 了太 / 坂田 隆英
日本電子テクニクス株式会社
開発部
川砂試料の面分析 ~鉱床探査への応用~
EPMA・表面分析_1
鉱床探査の初期においては、地表の岩石や川砂の化学組成や特定の鉱物などを調べる地化学探査が必要となります。全岩化学組成から元素異常を求めることが迅速かつ低コストですが、分析機器によっては微量に産出する鉱物の特定や、鉱物量比の定量も可能です。
本講演では、鉱山下流から採取した川砂試料を対象に、EPMAとMLA(Mineral Liberation Analyzer)による分析結果の比較などについて紹介します。

講師
実松 健造 様
国立研究開発法人
産業技術総合研究所
地圏資源環境研究部門
マクロからミクロまで 手早く正確な分析の新しい形
XRF - EPMA インテグレーションのご紹介
EPMA・表面分析_2
XRF (JSX-1000S)はバルク試料の主要元素から微量元素の分析を、非破壊で簡便に行える装置ですが、ミクロンオーダーの局所分析は苦手です。一方、EPMA (JXA-iSP100/iHP200F)は局所の微量分析が得意ですが、試料全体の構成元素を把握するには時間がかかります。
今回、お互いの長所を活かした新機能である「XRF - EPMAインテグレーションシステム」について分析例を交えながら紹介します。

講師
村谷 里香 / 脇元 理恵
日本電子株式会社
SA事業ユニット
これぞ電子分光!二次電子から反射電子までくまなく使用
~Spectrum Imageによるオージェの新たな活用事例~
EPMA・表面分析_3
昨年度UMで産総研田口様より紹介のあった各ピクセルにスペクトル情報が格納されたSpectrum Imageが実行できるソフト”EFSEMViewer”がこの度正式にリリースされました。
本発表では、この新測定手法の有用性を紹介し、データ処理で任意のエネルギーフィルターをかけたSEM像の取得、反射EELSによるバンドギャップの測定など、元素分析にとどまらないオージェの新しい活用方法について紹介します。

講師
伊木田 木の実
日本電子株式会社
SA事業ユニット
品質管理を目的としたXPS深さ方向分析の注意点
~鉛直方向からの広範囲エッチングの有用性~
EPMA・表面分析_4
XPS測定とArイオンスパッタを組み合わせた深さ方向分析は、簡便に膜厚や層構造を評価できるため、様々な用途で用いられています。しかし、深さ方向分析を品質管理に用いる場合にはいくつかの注意点があり、エッチング方法によっては試料点数をこなさなければ、間違った結果を招く恐れがあります。
本発表では鉛直イオン照射可能な日本電子製XPSのJPS-9030を用いて、品質管理を目指した再現性の高いデプスプロファイルのコツを紹介します。

講師
村谷 直紀
日本電子株式会社
SA事業ユニット
EPMA EDSポート用軟X線分光器はじめました ~WDS 5chのままSXESの導入~
EPMA・表面分析_5
軟X線分光器(SXES)として、現在SXES-LR(Lower-energy Range)およびSXES-ER(Extended Range)が販売されています。このほどEPMAのEDS Portに設置できる新しいSXES-ERを開発し、WDS 5 chのEPMAにその性能を活かしたままSXES-ERが導入可能となりました。
今回、この新しいSXESと共にSXES Handbook Ver. 6について紹介します。

講師
村野 孝訓
日本電子株式会社
SA事業ユニット
EPMA分析の留意点 ~定性分析におけるピーク分離~
EPMA・表面分析_6
近年、高い波長分解能と微量元素分析能力を有するEPMAは固体表面の微小領域の非破壊分析装置として幅広い分野で使用されています。EPMAは定性分析・定量分析・面分析・線分析などが行えますが、どの分析を行うにしても最初に行うべきは定性分析で、ここで元素同定を誤ると、後の分析結果に大きく影響します。
本発表では定性分析を行う際に重要なピークの重なりへの対処法を中心に、定性分析で注意すべきことを紹介します。

講師
土門 武
日本電子株式会社
フィールドソリューション
事業部
特定箇所をCP加工するための試料調製
~精密加工位置合わせ顕微鏡TYPE2のアプリケーション~
イオンビーム_1
CPはイオンビームを用いて断面を得る手法の中では、比較的広い領域を高速で処理できる装置として知られています。
最近では、光学顕微鏡とホルダーを組み合わせた精密加工位置合わせ顕微鏡TYPE2により、数マイクロ程度の目的物に対して狙って断面を得る事が出来るようになりました。そのため、基板のパターン解析や異物または異形箇所の前処理装置として利用される事が増えてきました。
今回、特定箇所を狙って断面加工するために必要な調製方法を紹介します。

講師
金子 剛
日本電子株式会社
EP事業ユニット
FIB試料作製でお困りの方へ ~FIBによるTEM試料の作り方~
イオンビーム_2
FIBでのTEM試料作製は、前処理の工程が少なく、試料表面を観察しながら加工できるため、狙った部位に対して任意の厚みに加工することができます。しかし、原子分解能で観察できるような高品質の試料を作製するためには、適切な加工条件とノウハウが必要になります。
本セミナーでは、FIBによる試料作製の中でも特に重要度の高いTEM観察用薄膜試料作製に焦点を当て、基本知識と最適な加工条件の決め方について解説します。

講師
山田 晶子
日本電子株式会社
EP事業ユニット
イオンスライサによるTEM試料のダメージについて
イオンビーム_3
イオンスライサはアルゴンイオンビームを用いたTEM用の試料作製装置です。
イオンビームを使って試料を削る以上必ず問題になってくるのが、イオンビームダメージによる試料の非晶質化です。
今回は、イオンスライサとシミュレーションを使って実際にどの程度のダメージ層が試料上に生成されているのかに注目してみました。また、ダメージ層を観察するのと合わせて「仕上げ」についても検証し、その効果を見てみます。

講師
河原 尚
日本電子株式会社
フィールドソリューション
事業部
構造が壊れやすい材料のCP加工 ~構造色を有する生物のOM・SEM観察~
イオンビーム_4
クジャクの体色は、光の反射等によって金属光沢色を呈する構造色です。このような自然界に存在する構造色は、断面を電子顕微鏡観察することでその色の要因を見つけることができます。しかし、動植物の構造色は、構造が微細で脆く壊れやすいため、カミソリ等での切断では機械的ダメージをともない、原型を保ったままの観察が難しいです。
今回、機械的ダメージのないCPによる断面作製を行い、光学顕微鏡とSEMを用いて観察した結果を紹介します。

講師
長谷部 祐治
日本電子株式会社
EP事業ユニット
FIB-SEMによる三次元測定の注意点 ~三次元観察について~
イオンビーム_5
FIB-SEMは集束イオンビーム加工装置(FIB)と走査型電子顕微鏡(SEM)の複合装置で、TEM試料作製や断面作製、観察、分析などが行えます。さらに加工・観察を自動で繰り返し一連のデータ群を取得する機能があり、取得したデータ群を三次元再構成ソフトで再構築することにより試料の三次元観察が可能となります。このFIB-SEMによる三次元測定は長時間になるため、安定した測定を実現する前処理や測定条件の設定が重要です。
本発表では三次元観察における、それら注意点を紹介します。

講師
松島 英輝
日本電子株式会社
EP事業ユニット
装置導入方法に関するご提案
その他
限られたご予算で成果を上げることを求められている昨今、従来のように装置をご購入頂くことだけが装置導入方法ではありません。これまでとは異なる装置導入方法をご紹介いたします。

講師
浅冨 華恵 / 増田 裕洪
日本電子株式会社
科学・計測機器営業本部
アプリケーションポスター
-
SEMユーザーズミーティング

JSM-IT700HRで広がる微小な世界
公開期間は終了しました

美麗な像が未来をつくる ~JSM-IT800<SHL>の各検出器による情報選択~
公開期間は終了しました
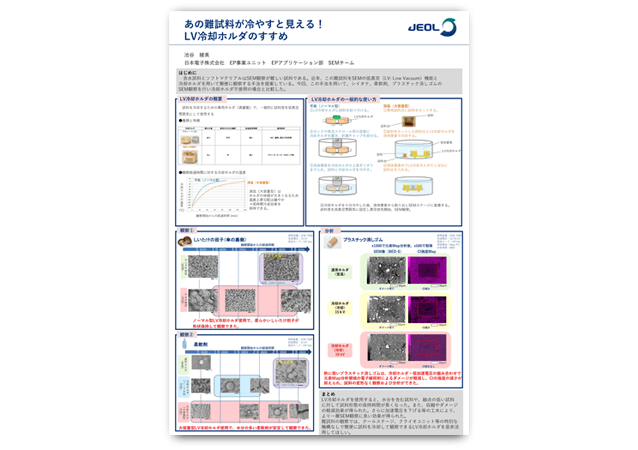
あの難試料が冷やして見える!LV冷却ホルダーのすすめ
公開期間は終了しました

JSM-7610FPlusによる 半導体積層デバイス電位コントラスト観察条件の探索
公開期間は終了しました

粒子解析のすすめ 粒子解析は何ができるのか?
公開期間は終了しました
-
EPMA・表面分析ユーザーズミーティング

JXA-ISP100, JXA-IHP200Fの便利な新機能紹介
公開期間は終了しました

テレワークをサポート!EPMAオフラインデータ処理ソフトウェア
公開期間は終了しました

マクロからミクロまで手早く正確な分析の新しい形 XRF-EPMAインテグレーションのご紹介
公開期間は終了しました
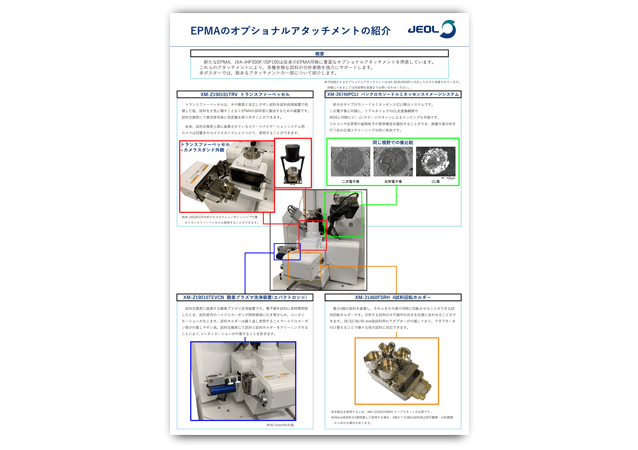
EPMAのオプショナルアタッチメントの紹介
公開期間は終了しました

これぞ電子分光!二次電子から反射電子までくまなく使用 ~Spectrum Imageによるオージェの新たな活用事例~ ①
公開期間は終了しました
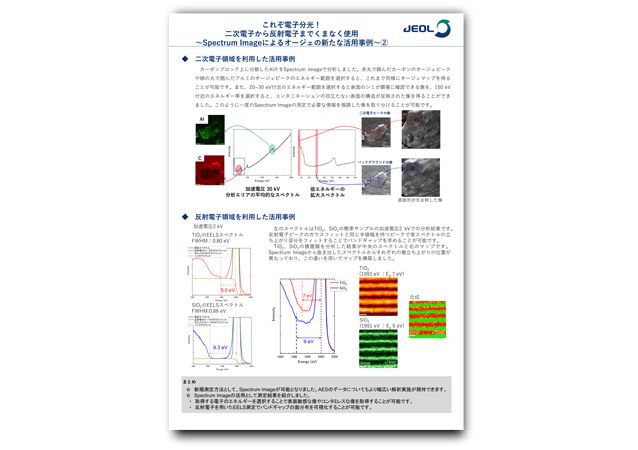
これぞ電子分光!二次電子から反射電子までくまなく使用 ~Spectrum Imageによるオージェの新たな活用事例~ ②
公開期間は終了しました

新オプションソフト Spectrum Image
公開期間は終了しました

品質管理を目的としたXPS深さ方向分析の注意点 ~鉛直方向からの広範囲エッチングの有用性~ ①
公開期間は終了しました

品質管理を目的としたXPS深さ方向分析の注意点 ~鉛直方向からの広範囲エッチングの有用性~ ②
公開期間は終了しました

EPMA EDSポート用軟X線分光器はじめました ~WDS 5chのままSXES導入~
公開期間は終了しました
-
イオンビーム試料作製セミナー

Arイオンビーム断面加工装置を用いた構造色を有する生物の断面作製方法の検討
公開期間は終了しました

CPとFIBによる断面試料作製
公開期間は終了しました

FIB-SEM / EDS システムを用いた日本刀の非金属介在物の三次元元素マッピング
公開期間は終了しました

イオンスライサTMによるFIB試料のArイオン照射仕上げ
公開期間は終了しました
パネル
-
走査電子顕微鏡(SEM)

JCM-7000 NeoScopeTM
公開期間は終了しました

JSM-IT700HR
公開期間は終了しました

JSM-IT800
公開期間は終了しました

JSM-IT800 Super Hybrid Lens〈SHL〉
公開期間は終了しました
-
集束イオンビーム加工観察装置 (FIB)

JIB-4700F
公開期間は終了しました

JIB-4000PLUS
公開期間は終了しました

自動TEM試料作製システム STEMPLING
公開期間は終了しました
-
断面試料作製装置 クロスセクションポリッシャTM(CP)

クロスセクションポリッシャTM IB-19530
公開期間は終了しました

冷却クロスセクションポリッシャTM IB-19520CCP
公開期間は終了しました
-
薄膜試料作製装置 イオンスライサTM

EM-09100IS イオンスライサTM
公開期間は終了しました
-
特殊試料ホルダー&アダプター

特殊試料ホルダー&アダプターのご紹介
公開期間は終了しました
カタログ
公開期間は終了しました
キャンペーン

SEM/EPMA・表面分析ユーザーズミーティング 消耗品ご優待販売キャンペーン
公開期間は終了しました

イオンビーム試料作製セミナー 消耗品ご優待販売キャンペーン
公開期間は終了しました

特殊ホルダー製作事例のご紹介
公開期間は終了しました
アンケート
公開期間は終了しました
お問い合わせ
日本電子株式会社
ユーザーズミーティング事務局
E-mail: jeolum[at]jeol.co.jp
[at]は@に、ご変更ください。
