新しい試料作製ソリューション
JIB-PS500iは、TEM試料作製をアシストする3つのソリューションを提供します。
試料作製からTEM観察まで、確実かつ高スループットなワークフローで作業することができます。
特長

TEM-LINKAGE
二軸傾斜カートリッジ※とTEM ホルダー※によりTEM ⇔ FIBのリンクを容易にします。
カートリッジは専用のTEM 試料ホルダーにワンタッチで装着できます。
●二軸傾斜カートリッジ※による試料搬送フロー

●OmniProbe 400※

Oxford Instruments 社製のOmniProbe 400※を採用し、正確かつ迅速にピックアップ作業が行えます。また、JIB-PS500i のソフトウェアはOmniProbe 400※の操作をインテグレーションしています。

試料: 5 nm デザインルール半導体デバイス (FinFET)
観察条件: (左) 加速電圧2 kV、検出器SED 二次電子像、(中央、右) 加速電圧200 kV、TEM 像、撮影JEM-ARM200F
CHECK-AND-GO
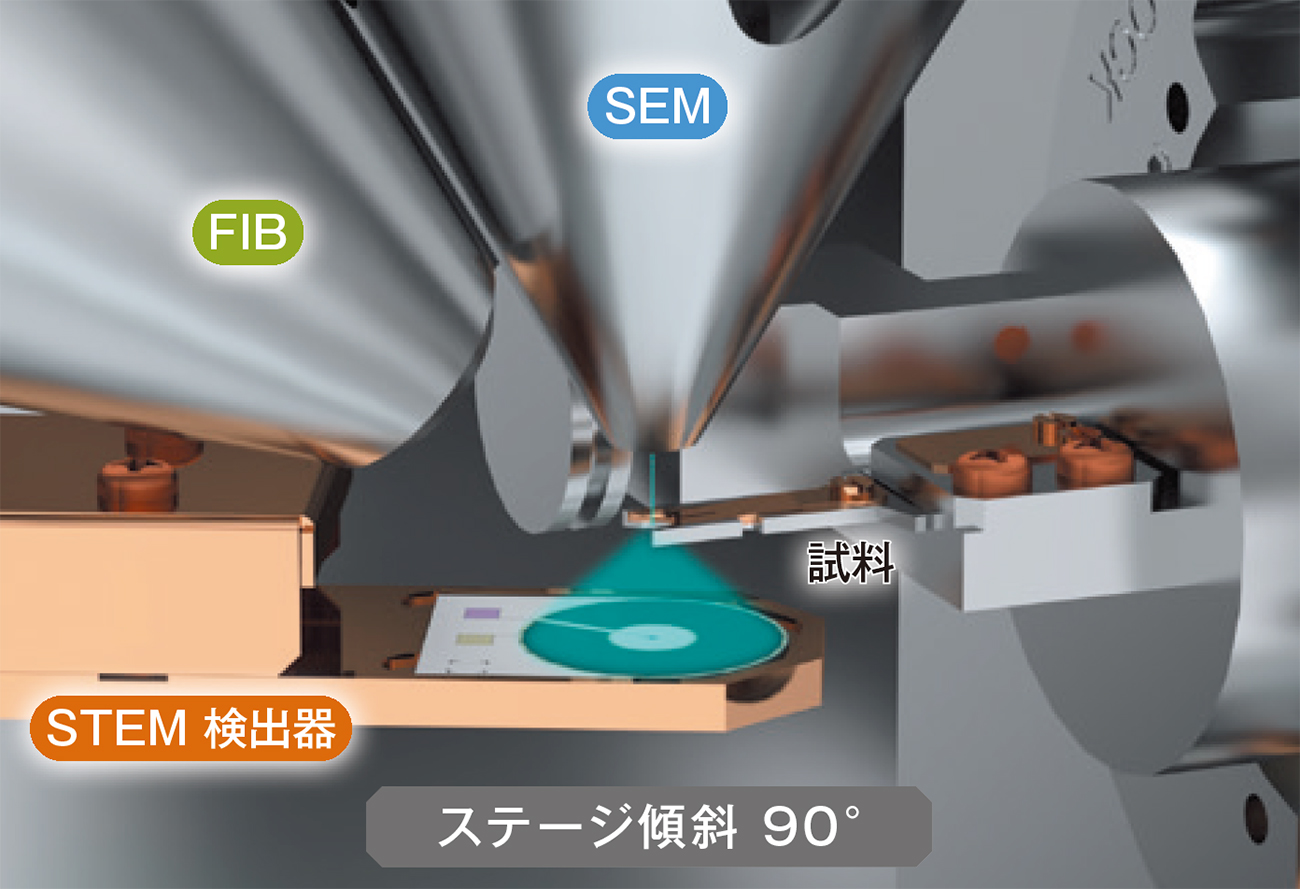
TEM 試料を確実に作製するためには、作製した試料をその場でチェックできることが重要です。
JIB-PS500i では、TEM 試料作製からシームレスにSTEM観察に移行できます。
薄片加工⇔STEM観察の繰り返しにより、納得のいく試料作製が行えます。
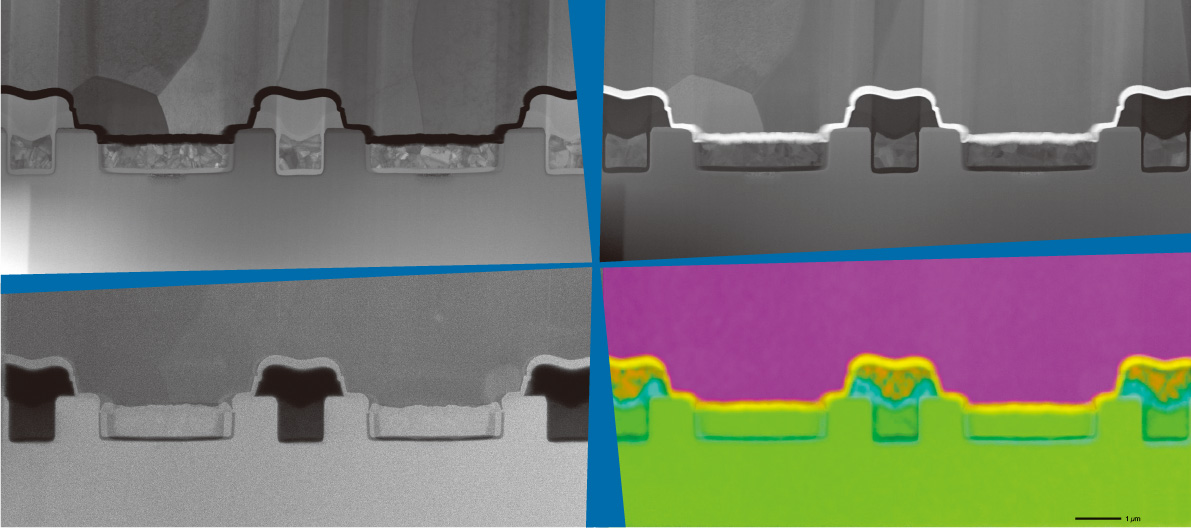
試料: SiC パワー半導体デバイス 観察条件: 加速電圧30 kV、
検出器 (左上)STEM-BF、(右上) STEM-DF、(左下) SED 二次電子像、(右下) EDS マップ 紫: Al 黄: Ti 橙: P 水色: O 緑: Si
AUTOMATIC PREPARATION
自動TEM試料作製システムSTEMPLING2※により、TEM試料作製を自動化します。
自動で試料作製を行うので、オペレータースキルによる品質のばらつきがありません。
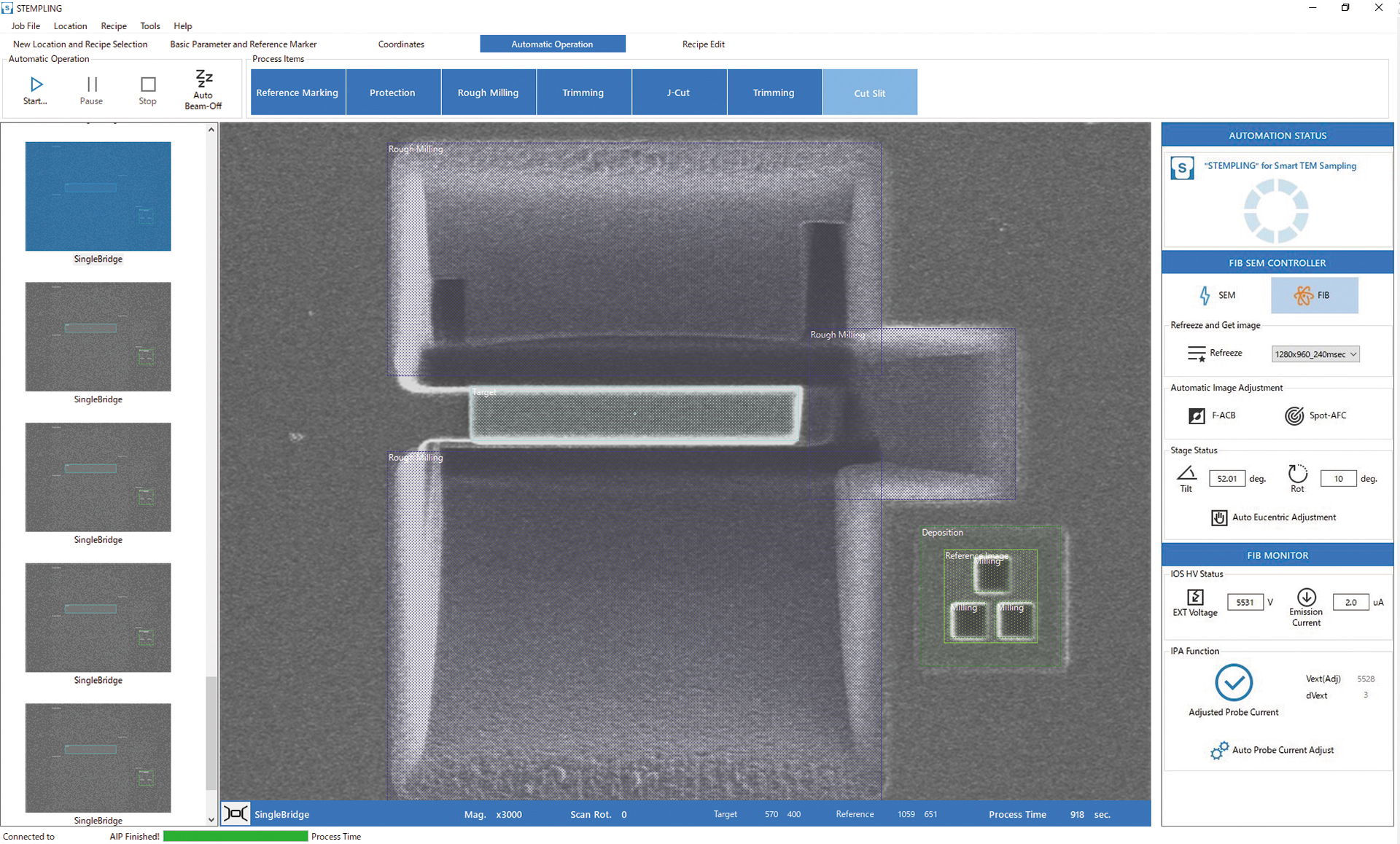
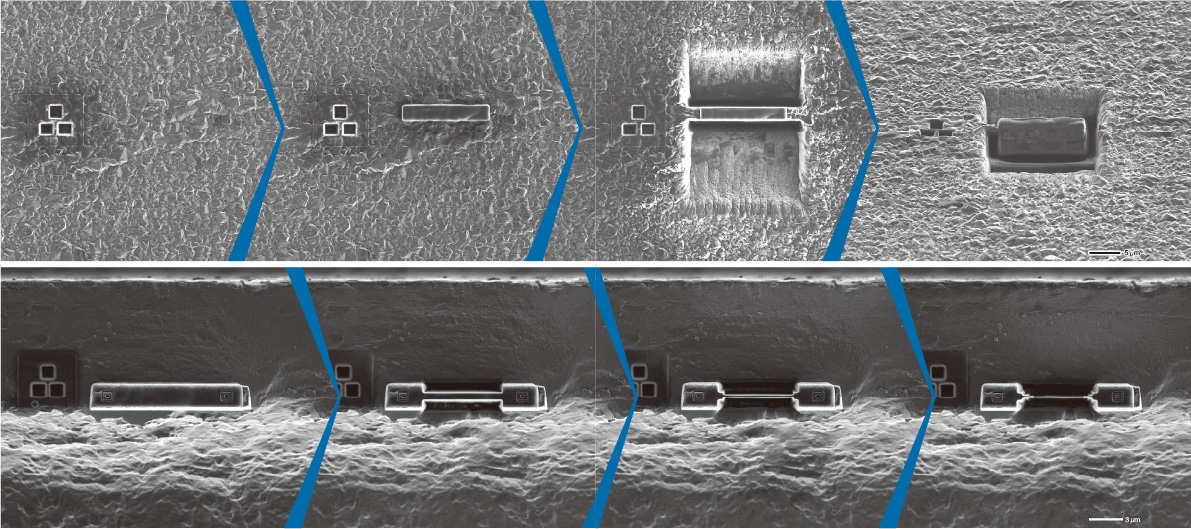
試料: 銅メッキ
(上段) 試料ブロックの自動作製、(下段) 自動加工による試料ブロックの薄片化
観察条件: 加速電圧30 kV、検出器SED (SIM像)
HIGH-RESOLUTION & HIGH-CONTRAST SEM Imaging
もう迷わない 加工終点を見逃さない 高画質なSEM画像
Signal detection system
標準装備のSED、UED、iBEDを含み複数の検出器を用意。
用途に応じて最適な検出器を選択することで、様々な試料に対して効果的な観察が可能です。
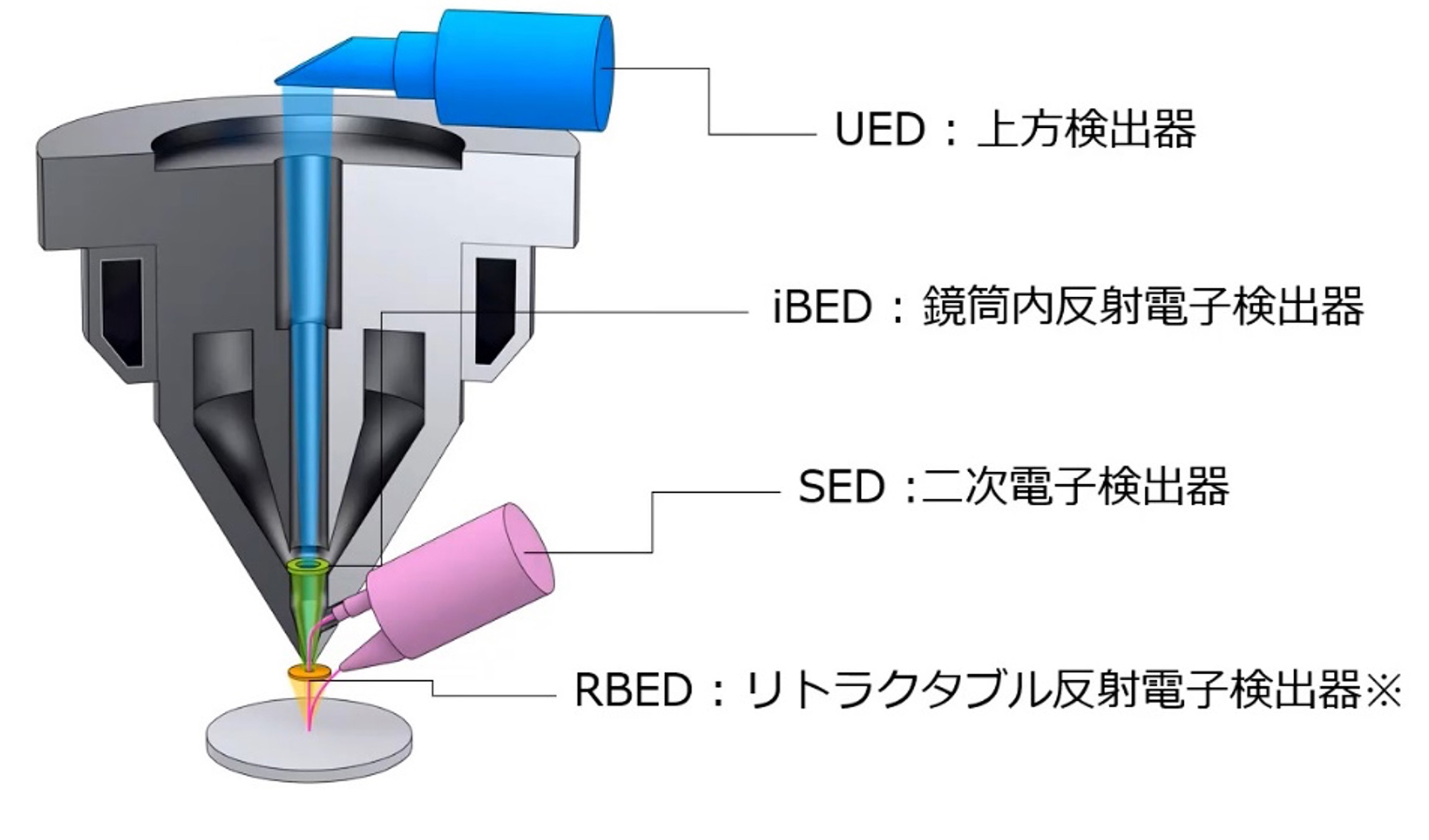
High resolution SEM imaging
SEM 鏡筒に新開発のスーパーコニカルレンズシステムを搭載したことにより低加速電圧の観察性能が大きく向上しました。
薄片加工の終点確認用SEMとして、加工終点を見逃さないコントラストの良い鮮明な像を取得できます。
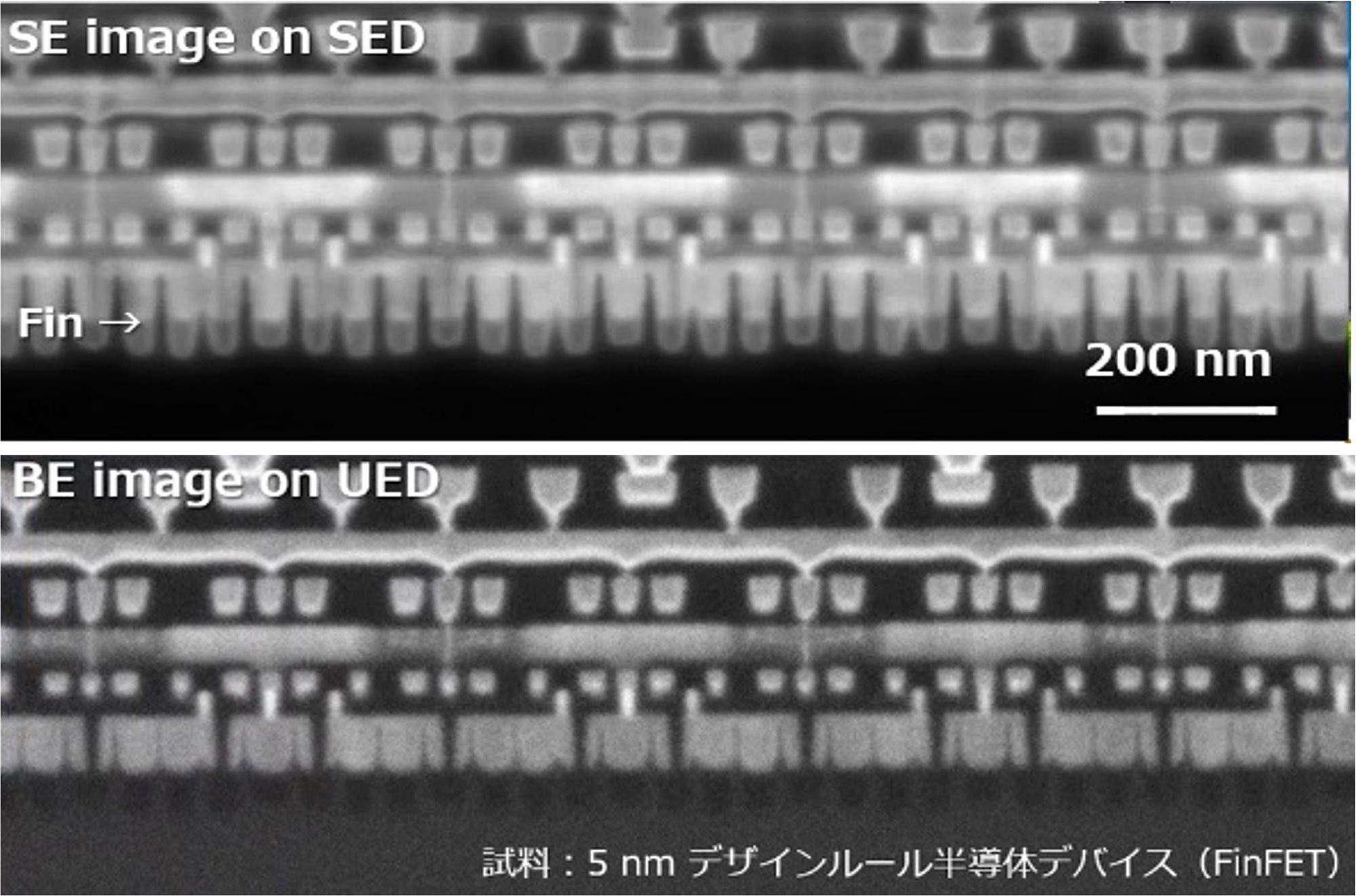
SEM imaging of FIB-prepared cross section
超小型・薄型のリトラクタブル反射電子検出器RBED※は、ステージ傾斜時でも使用可能です。試料表面の観察のみらならず、傾斜観察が必要なFIB断面の観察においても、二次電子検出器SED、上方検出器UEDと合わせて、さまざまな検出器で最適なSEM観察が行えます。

試料: 3D NANO フラッシュメモリーデバイスのFIB断面
観察条件: 加速電圧 2 kV、検出器 (左) SED 二次電子像、(中央) RBED 反射電子像、(右) UED反射電子像
EDS integration software*
本体制御ソフトウェアにEDS 分析機能を組込みました。
試料の元素分析がソフトウェアの切り替えなしに行えます。(日本電子社製EDS※搭載時のみ可能です。)

HIGH-POWER & HIGH-QUALITY FIB Processing
最良な試料作製のために よりパワーアップしたFIB加工
Large-area, Fast FIB processing
最大電流100 nAのGaイオンビーム照射ができるFIBカラムを採用しています。
大電流での加工は、特に大領域の観察・分析に必要な試料作製に威力を発揮します。
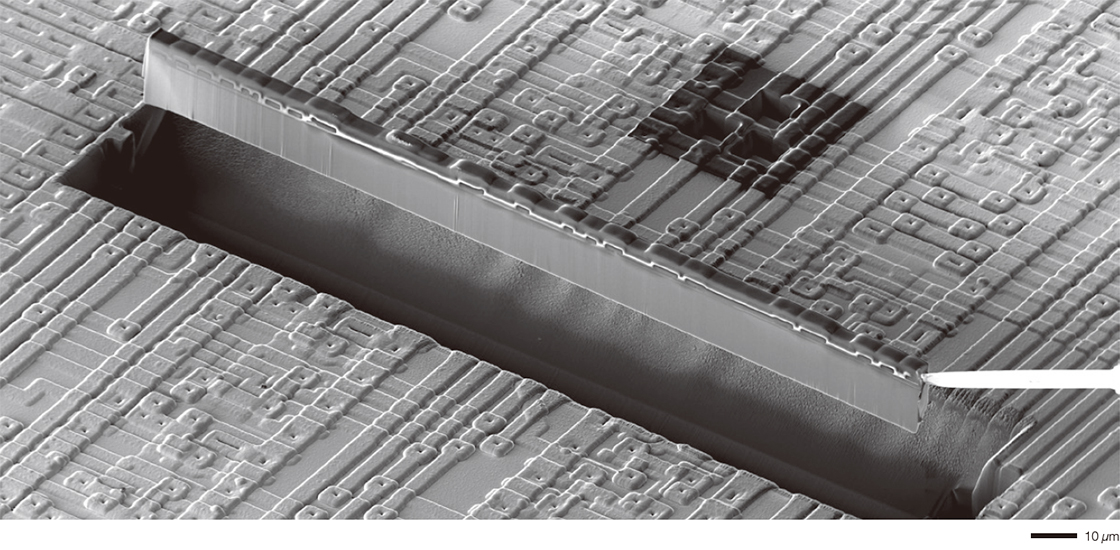
試料: 半導体デバイス
観察条件: 加速電圧 3 kV、検出器 SED 二次電子像
200×4×15 μmの試料ブロック。OmniProbe400※を使用して試料ブロックを取り出し。
Damage-layer removal by low-kV processing
従来機よりも短いワーキングディスタンスでFIB カラムを配置し、新開発の電源により低加速域の性能が向上しました。
新制御系も合わせ、薄膜作製で重要な低加速仕上げ加工を高精度に行えます。
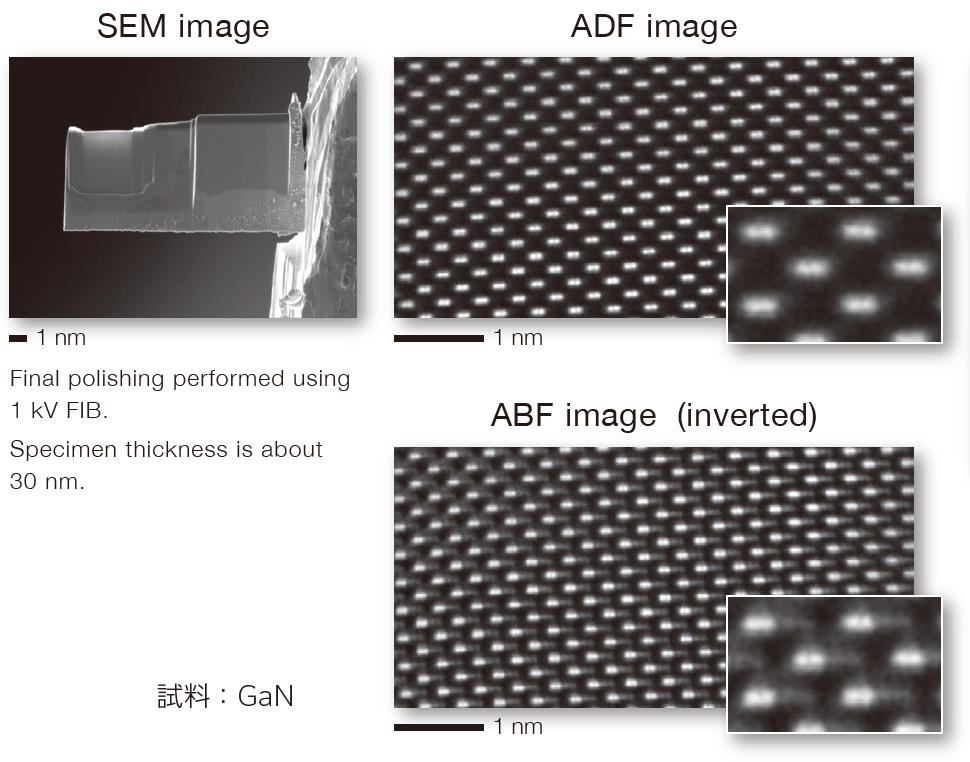
New Chamber & Stage Design
あらゆる要求に応える 自由度の高い 高傾斜 & 大型ステージ
Loading a large specimen
大型試料室および新開発の5軸フルユーセントリック大型モーターステージを採用し、可動範囲を増やし大きな試料にも対応しました。130 mm φの試料の全面で加工・観察が可能です。また、最大で 高さ80 mmの試料まで搬入できます。
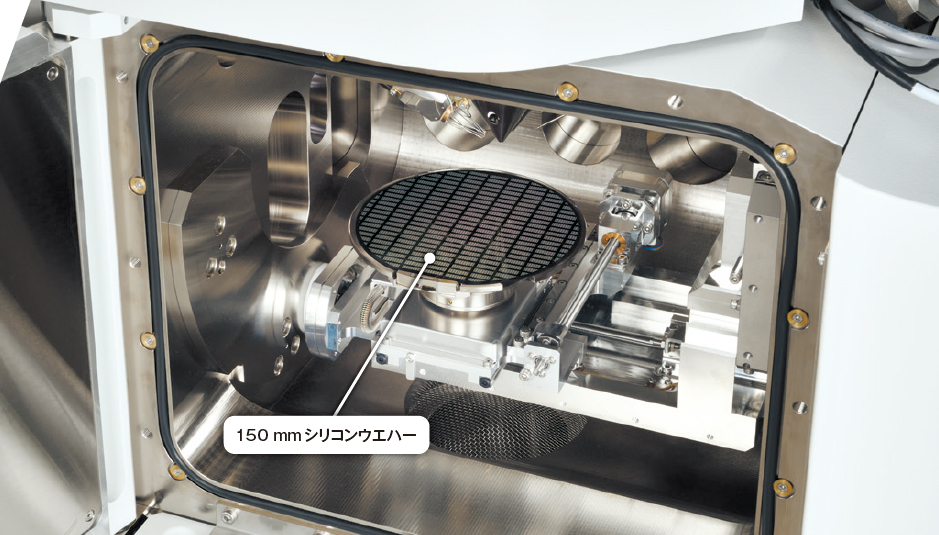
150 mmシリコンウエハーを試料室内にセットした様子。

AVERT Engine to determine movement limit using 3D models
試料ホルダー、ステージやチャンバー内構造物の3Dモデルを使用し移動制限を判断します。
いかなる状況に於いても試料は検出器や対物レンズに干渉することなく使用できます。試料室カメラを見ながらの操作から解放されます。
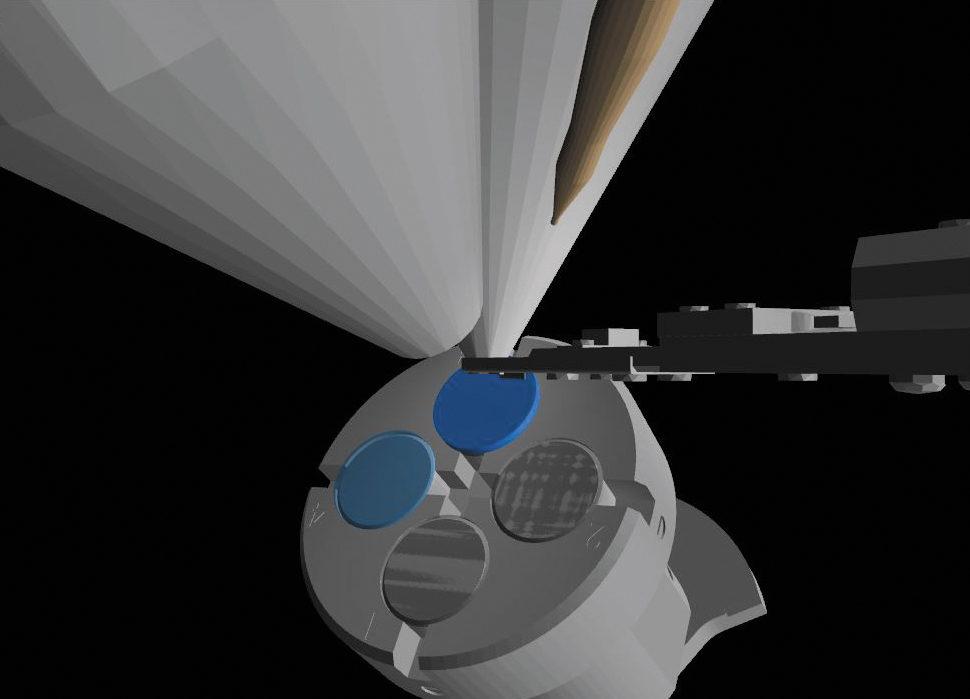
TEM 試料を確実に作製するためには、作製した試料をその場でチェックできることが重要です。
JIB-PS500i では、TEM 試料作製からシームレスにSTEM観察に移行できます。
薄片加工⇔STEM観察の繰り返しにより、納得のいく試料作製が行えます。
※はオプションです
仕様・オプション
SEM
| 像分解能 | 0.7 nm (15 kV) 1.4 nm (1 kV) 1.0 nm (1 kV、BD モード) |
|---|---|
| 倍率 | ×50 〜 ×1,000,000 (STD モード) ×1,000 〜 ×1,000,000 (UHR モード) ×10 〜 ×19,000 (LDF モード) (128 mm × 96 mm 写真サイズ表示時) |
| 入射電圧 | 0.01 〜30 kV |
| ビーム電流 | 約1 pA〜500 nA以上 |
| 試料バイアス電圧 | 0.0 〜- 5.0 kV |
| 電子銃 | インレンズショットキーPlus 電界放出電子銃 |
| 開き角最適化レンズ (ACL) |
組込み |
| 対物レンズ | スーパーコニカルレンズ |
| 長焦点距離 (LDF) モード |
組込み |
| 標準検出器 | 二次電子検出器 (SED)、 上方電子検出器 (UED)、 インレンズ反射電子検出器 (iBED) |
FIB
| 像分解能 | 3 nm (30 kV 時) |
|---|---|
| 倍率 | ×50 〜 ×300,000 (加速電圧により制限あり) |
| 加速電圧 | 0.5 〜30 kV |
| ビーム電流 | 1.0 pA 〜100 nA、 13段階切り替え (30 kV) |
| 可動絞り | モーター駆動16段切り替え (内、3段は予備) |
| イオン源 | Ga 液体金属イオン源 |
| 加工形状 | 矩形、円、多角形、点、線、 ビットマップ図形 |
試料ステージ
| 方式 | フルユーセントリックゴニオメーターステージ |
|---|---|
| 制御 | コンピューター制御 5軸モーター駆動 3D 干渉判定 AVERT Engine |
| 試料移動範囲 | X:130 mm |
| Y:130 mm | |
| Z:1.0 mm 〜40 mm | |
| T:- 40.0 〜93.0° | |
| R:360.0°エンドレス |
カタログダウンロード
ギャラリー