FIB の概要
はじめに
FIBとは Focused Ion Beam System (集束イオンビーム装置)の略語である。本装置はFig.1に示す通り、まずGa液体金属イオン源(LMIS)から引き出し電極の電界により Ga+イオンビームを発生(電界蒸発)させ、カソードの電界で加速させる(加速電圧)。さらにこのイオンビームを2組の静電レンズ(コンデンサーレンズ、対物レンズ)によって縮小し試料上に集束する。また、SEMと同様にGa+イオンビームは偏向板により試料上をX,Y方向に走査させる。Ga+イオンが試料に照射されるとSEMと同様に二次電子やスパッタリング粒子など種々の粒子が発生する(Fig.2)。また、Ga+イオンビームは対物絞りの径を調整することによりそのビーム電流を数pA以下~数十nAの範囲で可変することができる。また、SIM像の最高分解能は5nm以下を得る事ができる。

Fig.1 FIBのイオン光学系
質量の大きいイオンでは磁界型レンズでは集束が難しいため、静電型レンズを用いるのが一般的である。
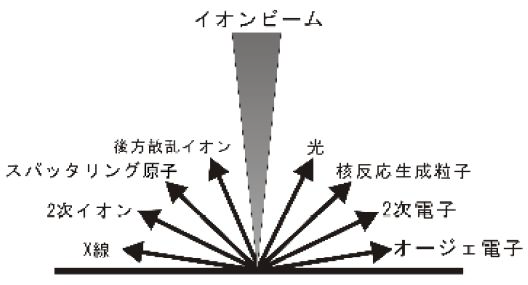
Fig.2 イオン照射時に発生する粒子
イオンビームを固体に照射すると、種々の粒子が発生する。SIM像は主に二次電子を用い画像化する。
FIB の基本機能
FIBは前述の通りGa+イオンビームを試料にX,Y方向に矩形に走査しながら照射することができる。イオンビームにはスパッタリング効果があり試料をおよそ0.1μm程度の精度で矩形の加工を行う事ができる。
また、Ga+イオンビームの照射に伴い試料表面より二次電子が発生し、SEMと同じような表面形状の観察をすることができる。これをSIM(Scanning Ion Microscope)像と呼ぶ。また、W(CO)6などの有機金属ガスを導入しながらGa+イオンビームを走査することにより試料表面にWなどの膜を成長させることも可能である。以上をまとめるとFIBには、1.像観察機能、2.加工機能、3.成膜機能(Fig.3)の3つがある。これらの機能を利用してFIBは断面加工およびSIM像あるいはSEM像観察、TEM(透過電子顕微鏡)用の薄膜試料作製、特に位置精度が要求される欠陥部位などの薄膜化には必要不可欠である。また、半導体の回路修正などにも幅広く活用されている。
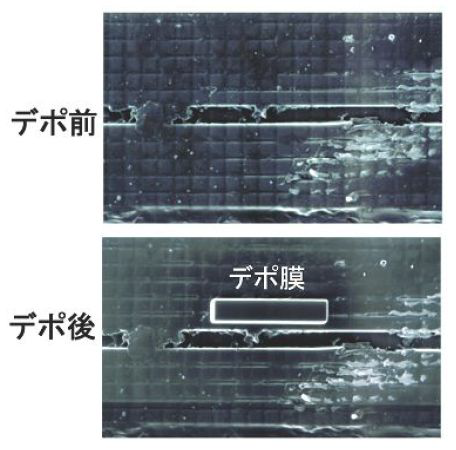
Fig.3 FIBの成膜
有機金属ガス雰囲気中でイオンビームを走査し、成膜されたカーボンの保護膜。
複合イオンビーム装置(マルチビーム)
また、FIB単体のカラムを備えたシングルビーム装置に対し、最近ではFIBカラムとSEMカラムを同一のチャンバ内で一定の角度を持たせて配置した複合イオンビーム装置(Fig.4)が普及している。本装置はFIB加工面を即SEM観察や元素分析が可能な装置(Fig.5)であり、試料作製の他に一定間隔でFIB加工/SEM観察を自動的に行い試料の三次元情報を得る事ができる3D-view機能(Fig.6)を備えており、その応用範囲はさらに多様になっている。

Fig.4 複合イオンビーム装置(マルチビーム)
マルチビームはSEMとFIBを同一チャンバに備えている。また、EDSやEBSDなども装着可能であり様々な用途に活用できる。
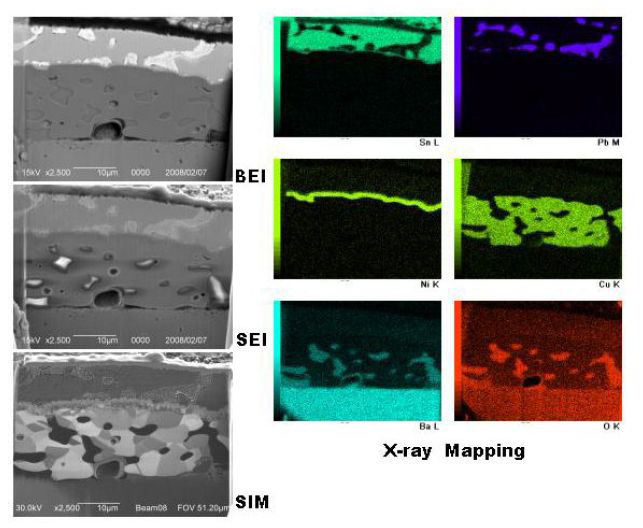
Fig.5 複合イオンビーム装置の特徴1
複合イオンビーム装置(マルチビーム)は試料をFIBにより断面加工後、この試料を大気にさらすことなくSEM観察、元素分析などを行うことができる(試料:チップコンデンサ)。
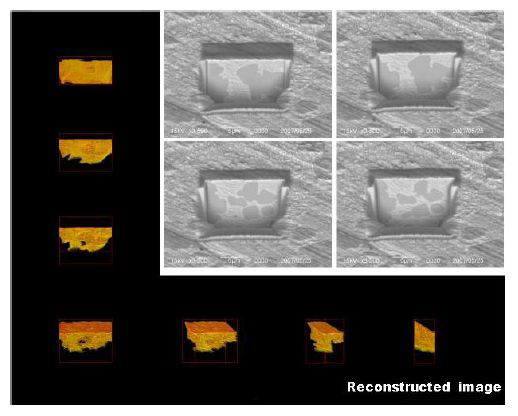
Fig.6 複合イオンビーム装置の特徴2
マルチビームでは試料を一定のステップで複数回加工しステップ毎にSEM像を自動的に取得する機能がある。本機能を用いることにより試料の三次元的な構造を正確かつ直感的に把握することができる。また、三次元再構成ソフトを利用することにより三次元再構成像を作成することも可能となる。本機能(3D-view)はマルチビーム最大の特徴である。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 330KB
