4D-STEMとSTEM-EELSを用いたFinFETのplan-view観察
EM2022-01
はじめに
4D-STEM法 (4 Dimensional-Scanning Transmission electron microscopy) は、試料上での電子線プローブの二次元の走査に同期して、試料下に配置される二次元の検出器 (カメラ) を使用し、各画素に対応する回折図形を記録、試料の解析を行う手法である (Fig. 1)。4D-STEM法では、走査位置に対応する回折図形が漏れなく保存されるため、後処理により試料上の任意位置の電子回折図形を確認、解析が可能である。また、後処理により任意形状のROI (Region Of Interest) を設定し、適用することでさまざまなSTEM画像を再取得することなく、再生することが可能である。例えば、擬似的に暗視野像や明視野像を作製することや、さまざまな位相回復手法などを利用することが可能となる。
本アプリケーションノートでは、多くの半導体素子で用いられている高集積度の三次元構造をもったFinFET (Fin Field-Effect Transistor) の試料を作製し、解析を行った例を紹介する。現在では、FinFETを構成するFinの幅が10 nm以下に達しており、プロセスの制御、故障解析などにおいて、高い空間分解能を持つTEM (Transmission electron microscope) による解析が必須となっている。またFin構造が三次元であるため、FIB (Focused Ion Beam) 装置 (Fig. 3) を用いて、三次元位置と観察方向を指定し、薄膜試料を作製することも必要とされている。
本報告では、大規模集積回路の構成要素であるFinFETを対象とし、4D-STEM法による像観察とEELS法による元素情報を取得し、総合的な試料の解析を行った。4D-STEM dataの取得には、STEM-X module (Gatan Inc., USA), OneView CMOS camera (Gatan Inc., USA)を用いた。
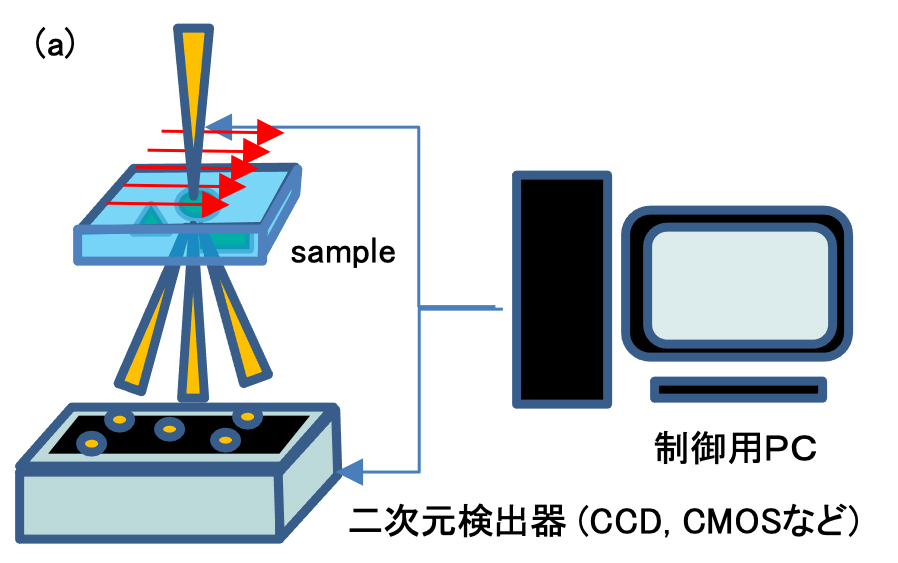

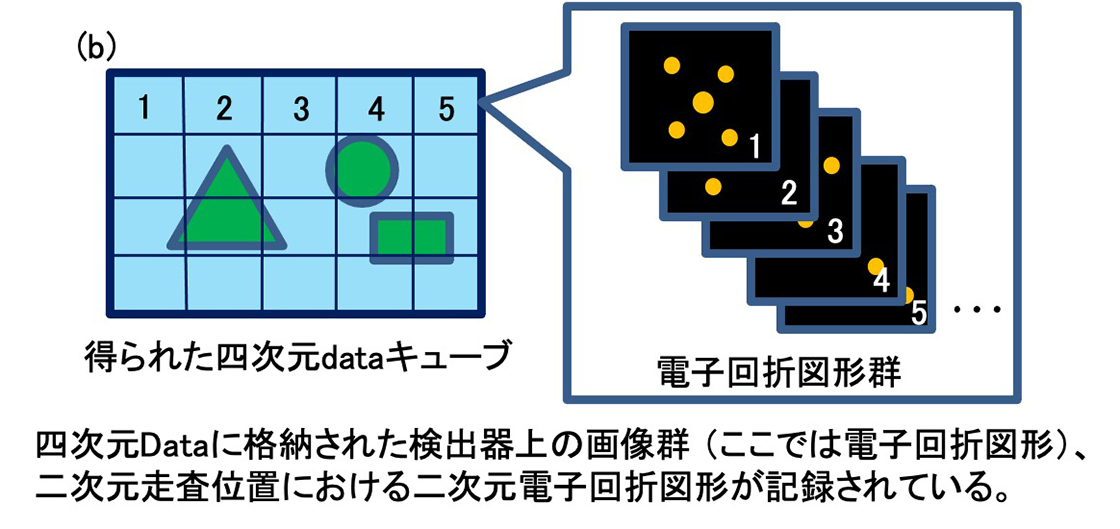
Fig. 1 4D-STEMの模式図 (a) 4D-STEM data取得および (b) 取得された4D-Dataの模式図
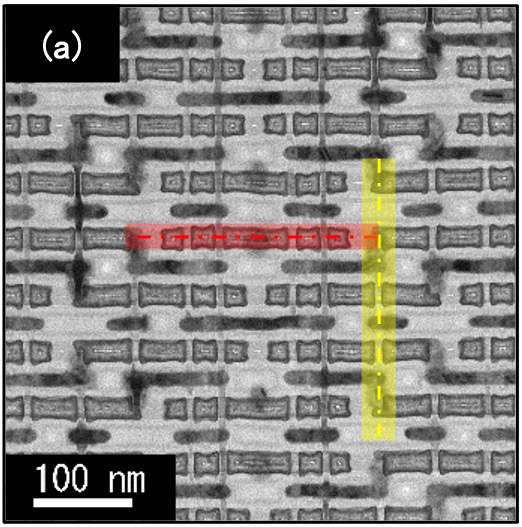
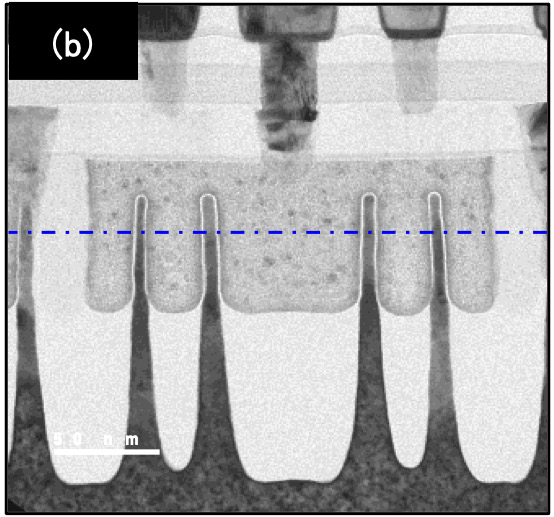
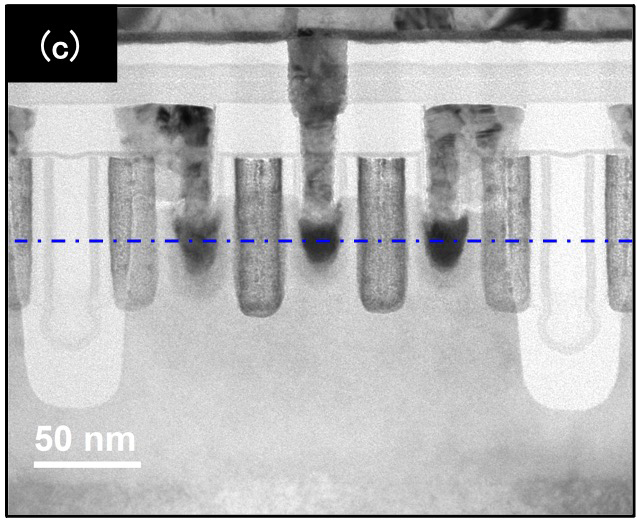
Fig. 2 FinFETのTEM明視野像 plan-view (a)、cross-section (b, c) 方向。
図 (a) に示す赤、黄色線はそれぞれのcross-section (b, c) の観察方向を示す。(b, c) に示す青線は、aのplan-view観察位置を示している。TEM画像取得は、JEM-ARM200F, 200 kV, UHR pole-pieceで行った。

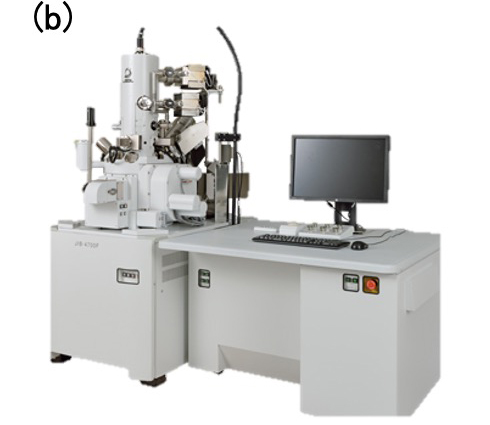
Fig. 3 集束イオンビーム加工観察装置の例 (a) JIB-4000PLUS, (b) JIB-4700F
FinFETのplan-view STEM観察とEELSによる元素分布の可視化
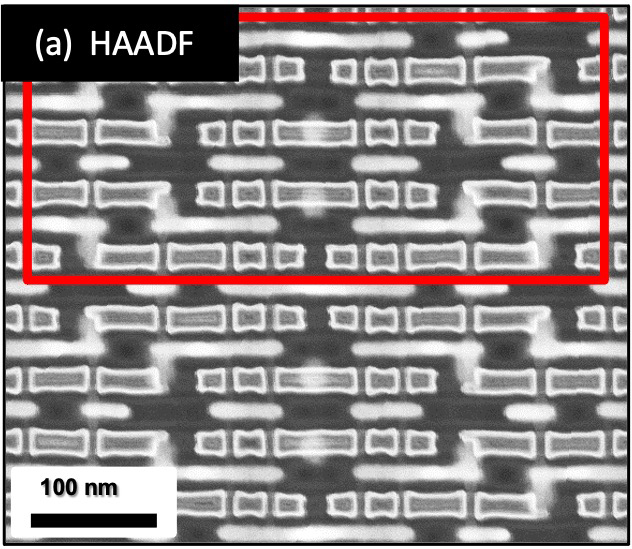
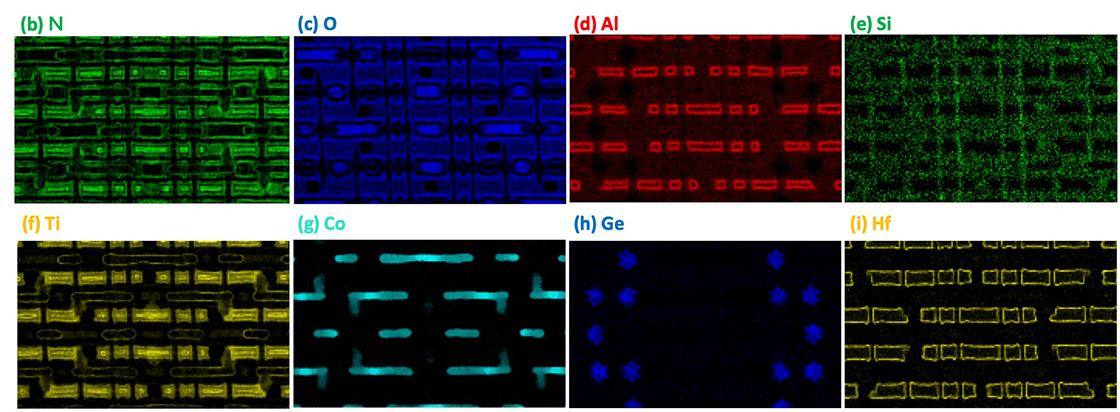
Fig. 4 Fin FETのSTEM HAADF像 (a), STEM-EELSによる元素分布像 N (b), O (c), Al (d), Si (e), Ti (f), Co (g), Ge (h), Hf(i)。
JEM-ARM200F, 加速電圧200 kV, Gatan社製GIF-Quantum-ERで取得。
FinFETのplan-view試料について、画像コントラストが原子番号に依存するHAADF (High Angle Annular Dark Field)-STEM法による形態観察像とSTEM-EELS (Electron Energy Loss Spectroscopy) 法によって得られた元素分布を示す。EELSを用いた元素分布像から、軽元素から重元素まで広い原子番号範囲の元素情報が可視化されており、絶縁層、Siチャンネル、プラグ配線、Ge/Siストレッサーなどの位置が明瞭に確認できる。
4D-STEM取得時の収束角
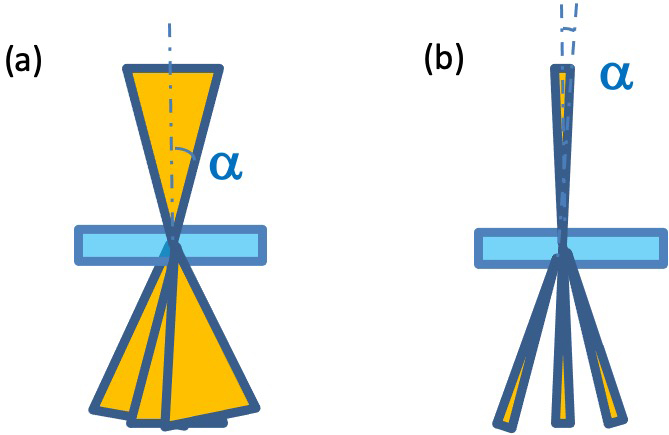
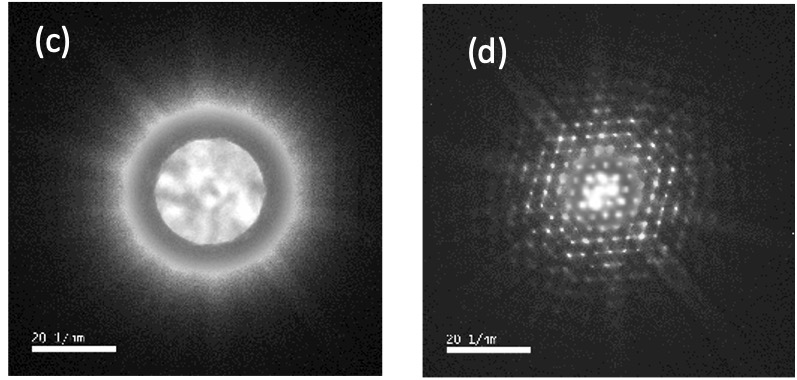
Fig. 5 収束角を変えたときの模式図と実際の電子回折図形の例
(a, c) 通常のSTEM観察時 (収束角 α: 大)
(b, d) 角度分解能が高い平行照射に近い条件 (収束角 α: 小)
実際の電子回折図形 (c, d) では外角の高次の反射の強度が弱いため、周辺部分と中心付近を円周上に二分割し、画像の明るさを調整している。
Fig. 5に通常のSTEM観察に用いた電子プローブ (収束半角 α~30 mrad) と平行照射に近い電子プローブ (半角 α~μrad程度) の模式図 (a, b) とそれぞれの条件で取得した電子回折図形の例を示す (c, d)。試料はSi単結晶[110]入射である。
通常観察に用いる大きな収束角 (c) では、隣接する回折Discが重畳し、回折角の解析が困難である。一方、平行照射条件に近い小さな収束角 (d) では、制限視野電子回折に近い回折図形が得られており、各回折斑点が明瞭に分離している。
本報告ではこれ以降に示す4D-STEM dataは、(b, d) で示す小さな収束角の条件下で取得を行っている。
Fin-FETの4D-STEM取得、解析例 1
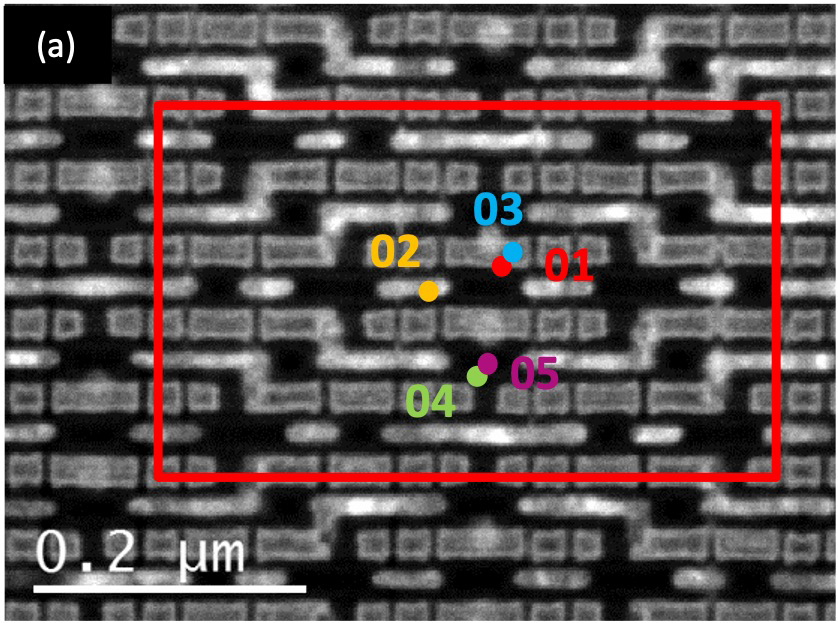
Fig.6 FinFETの4D-STEM dataの取得例。HAADF-STEM像 (a) と4D-STEM dataを用いて再構成した電子回折図形 (b-g)。
(b) は4D-STEM dataを取得した全領域から積算した電子回折図形、(c-g) はHAADF-STEM像に示す各点に相当する電子回折図形を示す。

4D-STEM 法では、すべての画素で電子回折図形を取得、保存してあるので、後処理により任意の画素の電子回折図形を引き出し、解析することが可能である。
Fin-FETの4D-STEM取得、解析例 2
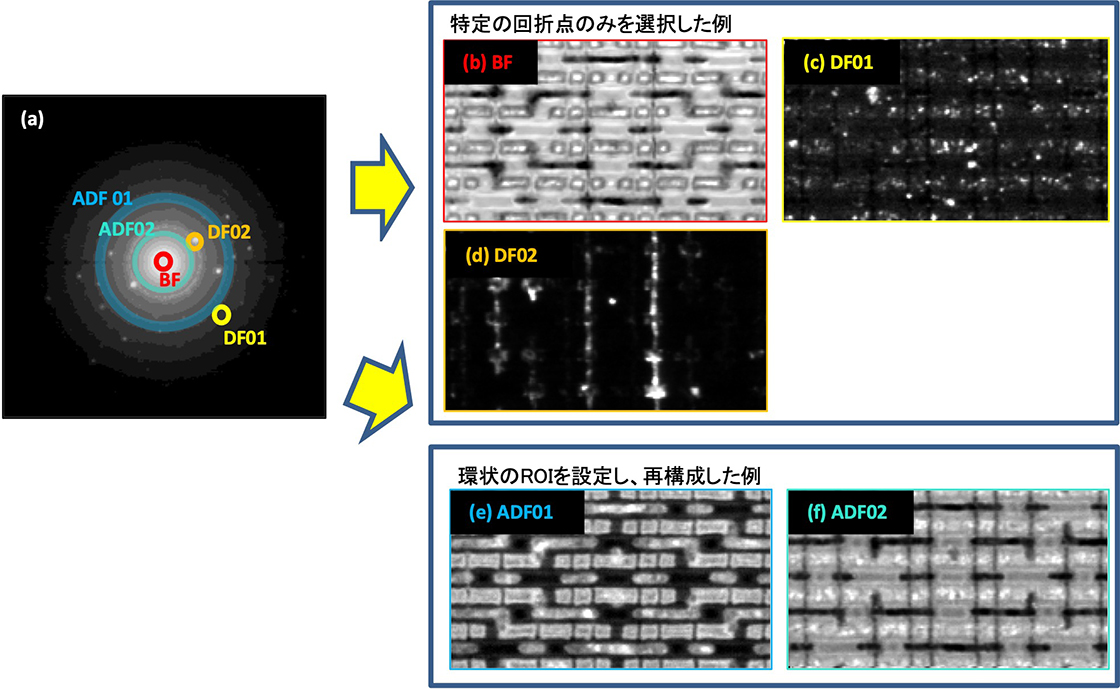
Fig. 7 FinFETの4D-STEM dataを用いて再構成されたSTEM画像の例。
4D-STEMでは電子回折図形上の任意の範囲にROIを設定し、STEM画像を再構成できる。
(a) には電子回折図形上に設定したROIを示す。
右図上段には、特定の回折点のみの強度から再構成したSTEM明視野像 (b) と暗視野像 (c, d)、右図下段には環状のROIから再構成したADF-STEM像 (e, f) を示す。
4D-STEM法を用いる事で、Fig. 7に示すように後処理によるdata解析により、BF, DF, ADFなど種々のSTEM画像を再構成できる。Siチャンネル (d, DF02)、非晶質の絶縁層 (f, ADF02) を選択的に可視化することや、多結晶部分における結晶分布、結晶粒の大きさ (c, DF01) や原子番号の比較的大きな金属部分などを分離して観察することができる。
まとめ
本アプリケーションノートでは、4D-STEM法を用いた材料解析手法の紹介を行った。本手法の特色は一度データを後処理で様々な解析を行うことが可能である。他の手法と組み合わせることで、材料解析においては非常に強力なツールとなると思われる。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 1.7 MB
