FIBによる断面試料作製とSIM像のコントラスト
IB2020-04
FIB (Focused Ion Beam)
集束イオンビーム (FIB) は集束したGaイオンビームを応用した加工観察装置である。
SEM 、STEM 、または、TEM で観察するための断面試料が作製できる。
サブミクロン以下の高い加工位置精度により、半導体デバイスなどの不良解析の試料作製に有効である。さらに、イオンビームで試料を走査したときに放出される二次電子を検出して、SIM(Scanning Ion Microscope)像による観察が行える。
一般に、SIM像はSEM像とは異なるコントラストの画像となる。チャンネリングコントラストが明瞭に観察できるため、金属組織の観察に有効である。
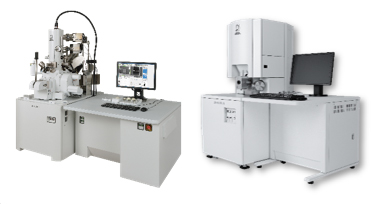
Fig.1 日本電子社製 FIB のラインナップ
左: JIB-4700F 、右: JIB-4000PLUS
FIB による断面試料作製の特長
FIBによる断面試料作製は、ブロードイオンビームを用いたCP (Cross section polisher) 法とは異なり、多くの試料の場合、研磨などの前処理は不要で、試料を試料ホルダーに固定すれば※、試料面の任意の位置で作製可能である。また、断面試料を作製する領域のみFIBによるミリング加工を行うため、 簡単かつ短時間に作製できる。
(※試料が絶縁材料の場合は、導電処理が必要である。)

Fig.2 FIB による断面試料作製の特長
FIBは高い位置精度で断面試料が作製可能であり、特に、不良解析のアプリケーションに有効である。
SIM像のコントラストの特徴
SIM像のコントラストには、下記の3つの特徴がある。
① 結晶性の試料ではイオンビームのチャンネリング現象により、結晶方位を反映したコントラスト (チャンネリングコントラスト) を強く生じる。
② イオンビームは電子ビームに比べ試料内部への侵入深さが非常に浅いため、試料最表面が観察される。
③ イオンビームによる二次電子の発生過程は電子ビームとは異なるため、SEM像とは異なる組成コントラストを生じる。
上記の特徴から、Fig.3のCCDセンサー断面のSIM像とSEM像の比較のように、一般的に、SIM像では高コントラストの画像が得られる。
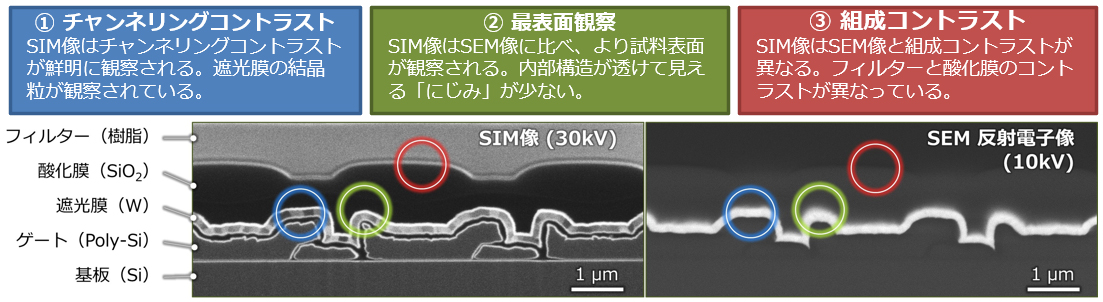
Fig.3 CCDセンサーのFIB断面の観察像
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 1.09MB
