SIM像によるIRカットフィルターの三次元欠陥解析
IB2020-06
SIM像による三次元観察
集束イオンビーム (FIB) は集束したGaイオンビームを応用した加工観察装置である。
FIBによる断面試料作製の手法を拡張することで、試料の内部構造を三次元的に観察することが可能となる。FIBによる三次元観察は、等間隔にスライス加工を繰り返し、それぞれのスライス断面観察像を収集する。三次元画像は、得られた連続スライス断面観察像を順番に積み重ねることにより再構築することで得られる (Fig. 1)。

Fig.1 FIBによる三次元観察の測定原理
一般に、FIBによる三次元観察は走査電子顕微鏡(SEM)とFIBの両機能を持ったFIB-SEMで行い、SEM像が観察像として使用される。
しかしながら、シングルビームFIBのJIB-4000PLUS (Fig.2) はFIB機能のみの装置であるため、 FIBの観察像であるSIM像 (Scanning Ion Microscope像) による三次元観察となる。
SIM像は、SEM像とは異なる下記に示した特徴を持ち、数万倍の倍率で高コントラストの観察が行える。①のチャンネリングコントラストや②の最表面観察の特徴から、 SIM像による三次元観察は、特に、金属材料を中心とした工業製品への応用が有効である。
① SEM像に比べ、チャンネリングコントラストが鮮明に観察される。
② SEM像に比べ、より表面近傍が観察される。
③ 組成コントラストがSEM像と異なる。

Fig.2 JIB-4000PLUS
IRカットフィルターの欠陥解析
近年、光学製品の高性能化に伴い光学薄膜においても、より高い品質管理技術が求められている。中でも異物混入は製品の性能を著しく劣化させるため、異物発生原因の究明と対策として異物の形態観察を正確に行うことが重要となる。SIM像による三次元観察により、酸化シリコンと酸化チタンの多層膜構造を持つ赤外線(IR)カットフィルター上の欠陥の発生原因の解析を行った。
IRカットフィルター上の4つの欠陥を対象として三次元観察を実施した。三次元観察を行う前に、欠陥部の表面観察を行った (Fig.3)。観察像から、欠陥部の表面形状は欠陥AとBは円錐状であり、欠陥Cは筋状、欠陥Dは円板状であった。Fig.4とFig.5に欠陥A~Dの三次元再構築像を示す。三次元再構築像から、欠陥Aでは多層膜中に酸化シリコンの異物の存在が確認され、欠陥BとCでは、多層膜の最下層に酸化シリコンの異物が確認できた。また、欠陥Dは試料表面上に外来異物が付着したものであった。
表面観察では欠陥部の試料表面形状を確認できるが、三次元観察では異物の材質と発生部位の情報を視覚的に確認できるため、三次元観察は欠陥の発生原因を解析できる測定法であることが分かる。

Fig.3 IRカットフィルター上の欠陥の表面観察像 (SIM像)
上段:上面観察、下段:傾斜観察。表面形状から欠陥A~Dは、「円錐状」、「筋状」と「円盤状」の3種類に分類できる。
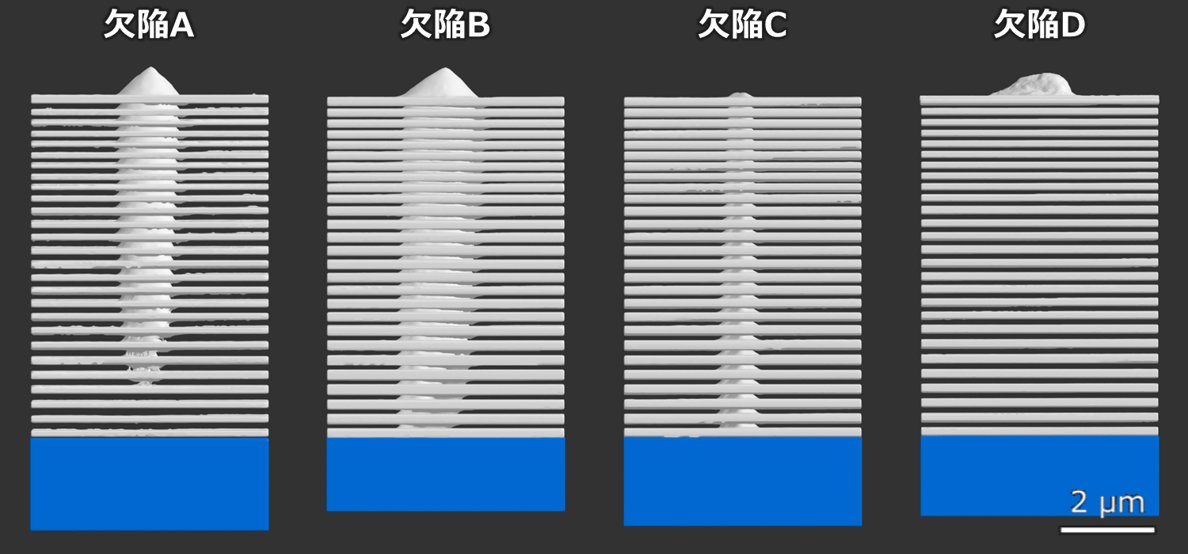
Fig.4 IRカットフィルター上の欠陥の三次元再構築像 (断面観察像)
白色部:誘電体多層膜の酸化チタン、透明色部:誘電体多層膜の酸化シリコン、青色部:ガラス基板部
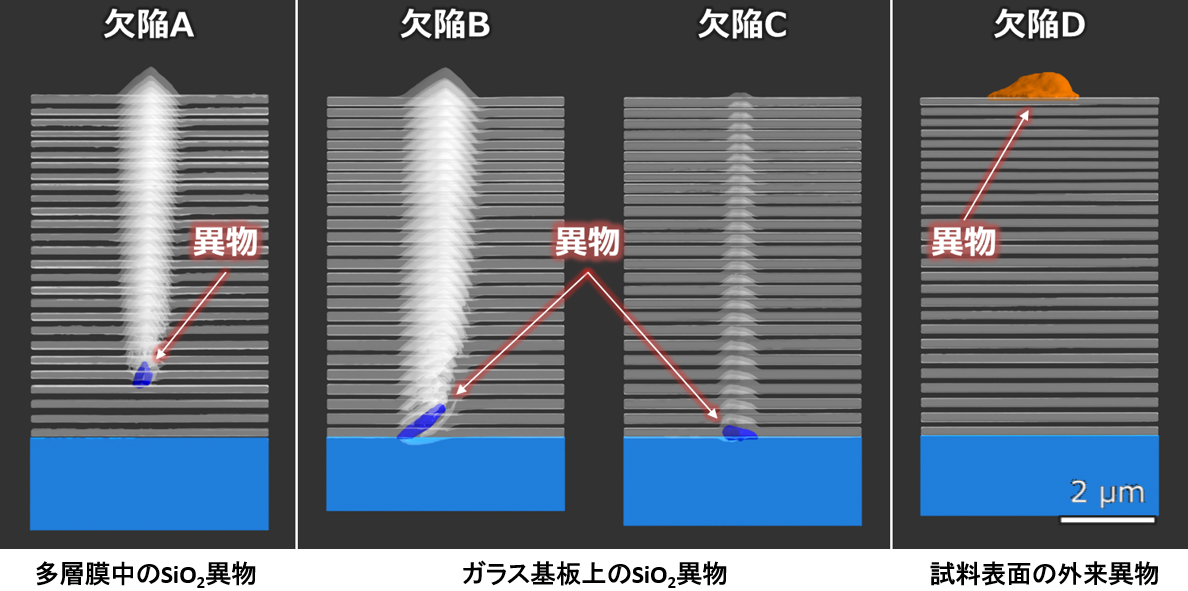
Fig.5 IRカットフィルター上の欠陥の三次元再構築像 (透過表示した断面観察像)
三次元再構築像から、欠陥Aは多層膜中、欠陥BとCはガラス基板の上、欠陥Dは試料表面上の異物であることが分かった。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 1.01MB
