FIB-SEMによるFin FETデバイスのTEM試料作製
IB2021-01
はじめに
半導体デバイスの故障解析は、検査の対象となる構造が微細であるためTEMによる検査が必須である。また、その試料作製には、通常、FIB-SEMが使用される。TEM試料においては、デバイスのテクノロジーノードと同程度の厚さまで薄くする必要があり、さらに、検査対象のパターンの位置で正確に作製する必要がある。このため、試料作製に使用されるFIB-SEMには、正確な位置で低ダメージの加工が行えるFIB性能と加工終点を確実に捉えられるSEM性能が求められる。
今回、FIB-SEMにより、Fig. 1のような立体構造を持つテクノロジーノード22 nmのFin FETデバイスに対しトランジスタ部の断面構造を観察できるTEM試料を作製した。作製した試料のTEM観察により、高分解能で観察が行える高品質なTEM試料であることを確認したので報告する。
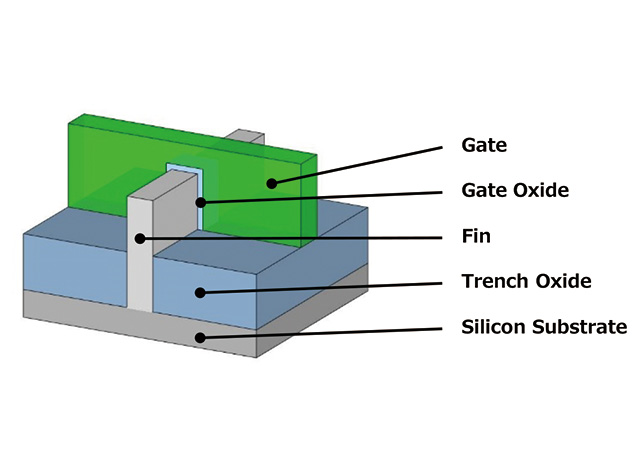
Fig. 1 Fin FET の基本構造
TEM試料作製と結果
テクノロジーノード22 nmのFin FET構造を持つ市販のCPUをサンプルとして、最大イオン電流90nAのハイパワーFIBとスーパーコニカルハイブリッドレンズを持つSEMを備えた日本電子社製 FIB-SEMの複合ビーム加工観察装置 JIB-4700F (Fig. 2)を使用しTEM試料作製を行った。
目的の位置で正確にTEM試料を作製するには試料の構造や寸法を正確に把握する必要がある。始めに、対象のFin FETデバイスの構造を確認するため、Gateレイヤーの平面構造を観察できる薄片試料を作製し、JIB-4700FによりSTEM観察を実施した。取得したSTEM像をFig. 3に示す。目的のFin FET構造を観察するためには、目的位置前後の構造を含まない膜厚にする必要がある。Fig. 3のSTEM像からTEM試料の厚みは40 nm以下が最適であることが分かった。

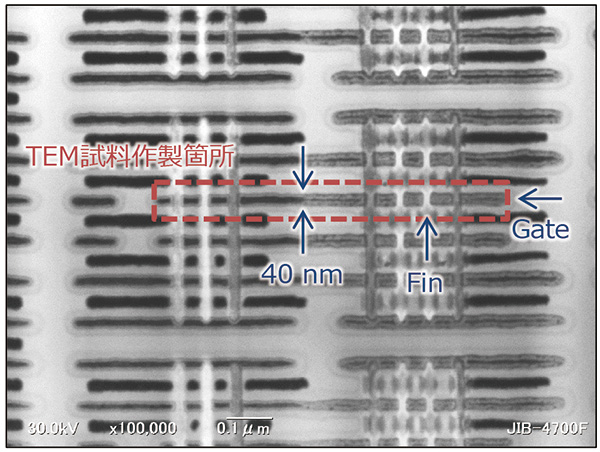
Fig.3 Gateレイヤー部の平面観察用薄片試料のSTEM像(撮影:JIB-4700F)
左側:薄片試料の全体像。右側:Fin FET部の拡大像であり、試料作製箇所を図中に点線枠で示した。(加速電圧:30kV)
Fig. 4の断面図のようなGateラインに平行でフィンに直交したFin FET部の断面をTEM観察できるように試料作製を行った。FIB-SEMのカーボンデポジションにより保護膜を形成し、FIB加工により周辺加工とボトムカットを行い、ピックアップする試料ブロックを作製した。ナノマニピュレーターによって、作製した試料ブロックを試料母材からピックアップし、TEMグリッドに固定した。その後、試料作製位置(Fig.3)で薄片加工を行った。FIBの最終仕上げ加工は5kVのイオンビームで行い、また、FIB加工中にリアルタイムでSEM観察を行い加工位置の調整(加工終点確認)を行った。JIB-4700FはFIB加工中のSEM像をリアルタイムで観察できるため、容易に加工終点の確認が行える。作製後、作製した試料の確認のため、JIB-4700FでSTEM観察を行った(Fig.5)。STEM観察像により、Fin-FET構造の位置で薄片試料が作製できていることが確認できた。
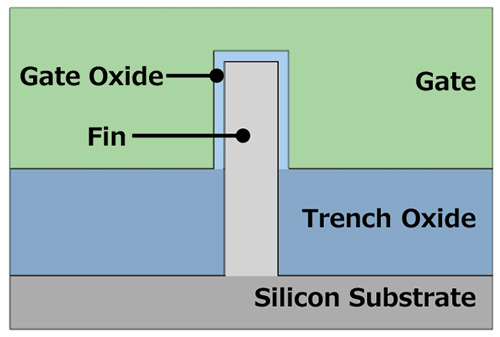
Fig.4 Fin FETの断面図
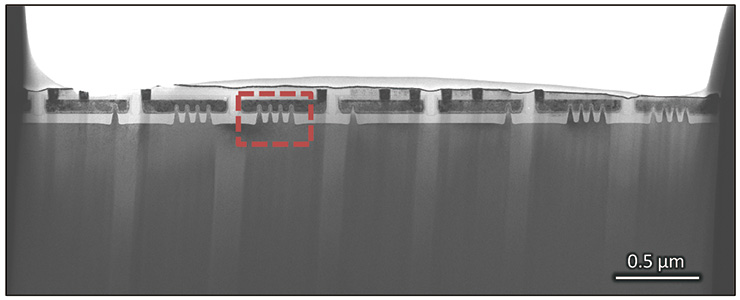
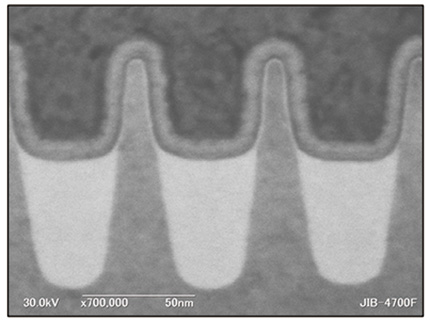
Fig.5 Fin FET断面の薄片試料のSTEM像(撮影:JIB-4700F)
左側:薄片試料の全体像。右側:Fin FET部の拡大像。(加速電圧:30kV)
作製したTEM試料を日本電子社製 多機能電子顕微鏡 JEM-F200 でTEM観察を行った(Fig.6)。TEM像には奥行き方向にある周辺の構造が全く観察されていないので、Fin FET構造の正確な位置で膜厚が40nm以下の薄片試料が作製できていることが確認できた。また、シリコンの格子像が明瞭に観察できているため、非晶質化のダメージが低減された高品質な試料であることが確認できた。
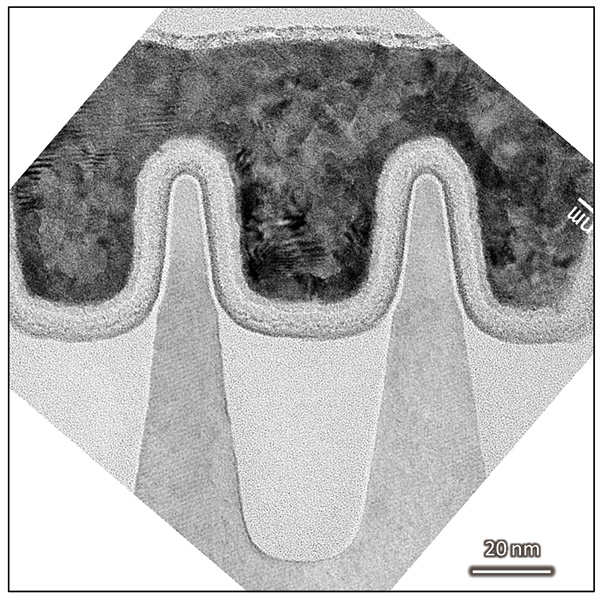
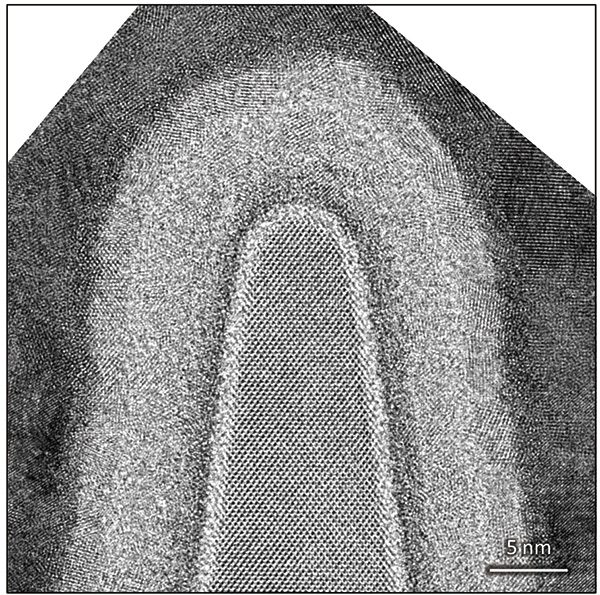
Fig.6 Fin FET断面の薄片試料のTEM像(撮影:JEM-F200)
左側:Fin FET部のTEM像。右側:Fin先端の拡大像。(加速電圧:200kV)
左側の画像から、Fin-FET構造の位置で奥行き方向にある周辺の構造を含まない試料が作製できたことが分かる。
右側の画像から、シリコンの格子像が明瞭に観察できているため、非晶質化のダメージが低減された高品質な試料であることが分かる。
まとめ
テクノロジーノード22 nmの Fin FETデバイスのTEM試料を作製した。複合ビーム加工観察装置 JIB-4700Fは、高精度で低ダメージのFIB加工が行え、さらに、FIB加工中のリアルタイムSEM観察やSTEM観察が行えるため、正確な位置でダメージを低減した高品質なTEM試料を作製できる。
- このページの印刷用PDFはこちら。
クリックすると別ウィンドウが開きます。 
PDF 3.4MB

