ナノ解析電子顕微鏡 JEM-2500SEの開発:JEM-2500SE
大崎光明、松下光英、近藤行人
日本電子(株)電子光学機器技術本部
はじめに
半導体デバイスは、微細化技術、多層配線技術の進歩によって益々、高集積化、高性能化が進んでいます。さらに将来の技術必要条件を示したロードマップ1)によると、最少加工寸法が 100nm 以下になると従来技術を打破する材料開発、製造プロセス開発が必要と指摘されており、Cu 配線、低誘電率 (Low-k) 材料、新しいゲート絶縁膜を使用したデバイス開発が進められています。
従来、半導体デバイスの不良解析における形態観察は集束イオンビーム装置 (FIB) を用いて不良個所を削り、走査電子顕微鏡 (SEM) を用いて観察、分析するというのが代表的な検査方法でした。しかしデバイスの微細化が進み、薄膜層界面の結晶形態観察、組織分析などを原子レベルで、しかもルーチンで行うとなると、SEM の分解能および機能だけでは観察が不可能になってきています。
この問題を解決するため、我々はナノ解析電子顕微鏡 JEM-2500SE(図 1)を開発しました。

図 1 JEM-2500SE 外観
以下にJEM-2500SEの特長を説明します。
JEM-2500SEの特長
JEM-2500SE は半導体デバイスをはじめとするナノレベル領域の形態観察および分析を目的とした電子顕微鏡です。
このため、その必要条件である、『素早く結果が得られ、それを製造プロセスへ迅速にフィードバックする』、すなわち高スループット機能を備えるために次の 3 点を JEM-2500SE 装置の特長として挙げます。
- 容易な操作性
- 高分解能機能
- 高感度分析機能
容易な操作性
SEM が半導体の形態観察装置として多用されていることから、JEM-2500SE においても SEM 並の操作性を実現しています。
操作の簡素化
オペレータのレベル(User、 Expert、Engineer)にあわせて LCD 上に 3 種類の GUI (Graphical User Interface)を準備し、マウスで簡単に操作できます(図 2)。
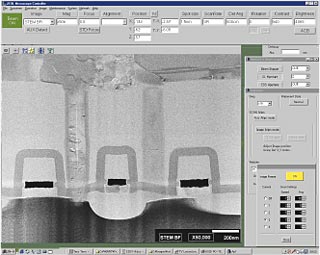
図 2 LCD上に表示されたGUI(グラフィカルユーザーインターフェース)
選択された画像と共に上部にマウスで操作できるオペレーションスイッチボックスが表示されます
さらに、焦点合わせ、倍率の可変など使用頻度の高い操作に関しては操作パネルからも操作できる併用方式を採用しています(図 3)。
また、各像モードごとのレンズデータやアライメントデータのプリセット値を詳細に PC に記憶させ、走査透過像(STEM)、走査二次電子像(SEI )、透過像(TEM)、回折(DIFF)パターンをワンタッチ操作で LCD 上に表示することが可能です。

図 3 コントロールパネル
使用頻度が高い倍率、焦点合わせなどのノブが設けられています
全ての絞りはモータ駆動で、位置調整操作は像モードごとにより最適なサイズ、位置をあらかじめ PC に記憶させています。このため、オペレータは絞り位置調整という操作を行う必要はなくなりました。
高輝度FEGの使用
電子銃は長安定でかつ高輝度、微小ビームを実現するためサーマルタイプの電界放出形電子銃を使用しています。これにより微小領域の X 線分析である EDS 分析の感度およびデータの信頼性を得られると同時に、鏡筒と電子源室の間のバルブを GUI からの操作により開くことで瞬時に電子ビームが得られます。これは即座に、本装置を使用できることを意味しています。
暗室不要
JEM-2500SE は透過像(TEM)を観察できるにもかかわらず、通常の透過電子顕微鏡で備えているシートフィルム用カメラ室、蛍光板はありません。
その代わり透過像(TEM)観察用として広視野用、高分解能用 TV ディテクタを標準装備しており、他の像同様 LCD 上に表示させています(図 4)。
このため、JEM-2500SE を操作する部屋も暗室にする必要はなく、当然、フィルム現像という操作は不要となりました。
なお、広視野用、高分解能用 TV ディテクタの選択は倍率により自動選択となっており、さらに高分解能 TV 像を記録する SLOW SCAN CCD カメラをオプションとして用意しています。
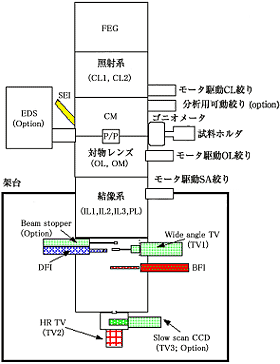
図 4 鏡筒断面図
像検出検出器として、二次電子像(SEI)用、
TEM像検出用としてWide angle TV、
High resolution TV、Slow scan CCD(オプション)、
STEM像検出用として明視野(BFI)、
暗視野(DFI)用が鏡筒に取付けられています
クリーンルーム環境対応
装置の高さは 2.1m で、設置室天井の高さは 2.6m あれば据付け、メンテナンス空間を確保できます。
装置の除振器は空圧ダンパを用い、試料ホルダに近い位置で支持する上部支持方式を採用することにより耐震性を向上させています。
また、前述の通り、絞りは全てモータ駆動であり、その調整操作はPCから行う方式を採用しているので、装置全体をカバーすることが可能となり、騒音、圧力変化対策などが可能になりました。
チップオンカートリッジホルダを使用することによるFIBとの共通化
試料ホルダは試料をセットする先端部を取外すことができるチップオンホルダカートリッジ方式を採用しています(図 5)。
このため、カートリッジ部を試料ホルダから外して試料作成用 FIB のステージに取付けることで、あらゆる試料作成用 FIB で試料加工できるようにしています。
なお、JEOL 製集束イオンビーム試料作製装置 JEM-9310FIB では JEM-2500SE と同じタイプのゴニオメータステージを備えています。このため、試料ホルダを JEM-9310FIB でも JEM-2500SE でも使用でき、試料作成時間の短縮を可能にしています。
 |
 |
|
| 図 5 チップオン試料ホルダ | JEM-9310FIB | |
| 必要に応じて先端部をFIB用シャトルリテーナに交換可能。 また、試料ホルダはJEM-2500SEと同タイプのゴニオメータを搭載するJEM-9310FIBにも使用できます |
集束イオンビーム試料作成装置 |
測長機能
LCD 上に表示される走査透過像(STEM)、走査二次電子像(SEI)、透過像(TEM)、回折パターン(DIFF)は全てデジタル信号であり PC に画像を記憶することができ、得られた画像から簡単に測長することが可能です。透過像(TEM)または走査透過像(STEM)を使って得られる高分解能格子縞を基準として目的の膜厚を知ることも可能です。
高分解能機能
半導体デバイスにおける原子レベル領域観察の必要性から電子顕微鏡に求められる機能は高分解能機能です。さらに、JEM-2500SE では迅速にかつ簡単に高分解能像が得られます。
走査透過像(STEM)、走査二次電子像(SEI)
STEM 像の分解能は 0.2nm(図 6)、SEI の分解能は 1.0nm(図 7)を備えています。
STEM 像、SEI はいずれも走査像であり、今まで SEM を操作していた人にもなじみが深いものとなっています。
 |
 |
|
| 図 6 STEM分解能写真 | 図 7 SEI分解能写真 | |
| 試料 : シリコン(111)0.192nm格子像が明瞭に観察できています | 試料 : カーボン膜上の金粒子 電子による二次電子像であるため、後ろの金粒子のエッジからの信号が発生していることがわかり、深さの情報が得られることを示しています |
形態観察を行う場合、FIB で作成した試料観察薄位置を JEM-2500SE で見付け出すという操作が最初に行われます。この時、 SEI を観察することにより FIB で削った試料位置を迅速に見出すことができます。また、200kV の高加速電子による二次電子像は低加速電圧による二次電子像に比べ深さ情報も含んでおり、観察目的部分の薄膜化に有効な手段です。
STEM は高分解能観察、EDS 分析操作における分析点を決める操作の容易さから必要な機能です。また、STEM における焦点合わせ、非点補正を容易に行うために、試料面上の Spot 形状を直接見る Ronchigram 技法を取り入れています(図 8)。さらに STEM には明視野像(BFI)、暗視野像(DFI)の 2 種の像を得るために各ディテクタを標準装備しており、特に DFI はデバイス構成元素による散乱角の違いに生じる Z コントラスト効果よって高コントラスト像が得られます(図 12)。
 |
 |
|
| 補正前 | 補正後 | |
| 図 8 Ronchigramパターン | ||
| 結像系レンズを使用して試料のSPOT形状を観察する手法で、その形状が最小になる値が正焦点であり、真円であれば非点が補正されていることを示しています | ||
TEM機能
半導体デバイスにおける Si 基板の格子像は膜厚測定における基準で、格子像が簡単に得られる TEM 機能は半導体における原子レベル観察には不可欠な機能です。JEM-2500SE では積極的に取り入れています。
JEM-2500SE では装置の高さを 2m 近くにしているため、架台下に通常の透過電子顕微鏡と同じ結像系レンズを備えており、その分解能は 0.14nm です(図 9)。
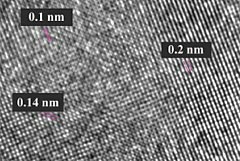 |
| 図 9 TEM分解能写真 |
| 試料 : 単結晶金 0.2nm、0.14nm格子像が明瞭に観察でき0.1nm格子像も撮影可能です。 |
私達は、良く軸合わせされた TEM 機能は、簡単に高分解能像が得られる手法であることをよく知っています。上述のように JEM-2500SE では TEM における軸合わせ用アライメント値、非点補正値を詳細にコンピュータに記憶させているので GUI 上の Image 選択 SW を TEM に選択するだけで TEM の高分解能 TV 像が LCD 上に表示されます。
回折(DIFF)パターンによる結晶方位合わせ機能
高分解能領域の観察並びに EDS 分析では正確に結晶方位を合わせる必要があります。特に FIB で試料を薄膜にしたとしても 30~10nm の厚さがあり結晶方位が正確に合っていない状態での観察並びに EDS 分析結果は正確なものとはいえません。
JEM-2500SE では通常の透過電子顕微鏡同様、結像系レンズを備えています。回折パターンは TV ディテクタで取り込み LCD 上に表示させています (図10)。
オペレータは回折パターンを見ながら試料を傾斜することで結晶方位を合わせることが可能となります。なお、操作を簡易にするため、すでに JEM-2010F で実績がある回折パターンから試料を自動的に傾斜するソフトを組込み実験中です。
 |
| 図 10 GUI 上に表示されたDIFFパターン |
| 結晶方位を正確に合わせることが可能です |
高感度分析機能
EDSの高感度化
JEM-2500SE における X 線分析に関し、高い分析空間分解能を保ちつつ、かつ大きな検出立体角を得るために対物レンズポールピースおよびコリメータ組込みタイプX線検出器の新設計を行いました (図11)。
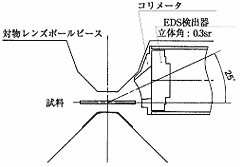 |
| 図 11 対物レンズポールピースおよびコリメータ組込みタイプX線検出器の新設計 |
これにより従来の EDS に比較して 2.5 倍感度が高い (当社比)検出立体角 0.3sr の X 線検出器を取付けることが可能となり、微少含量材料の検出、および短時間で EDS マッピング、点、ライン分析が行えるようになりました。さらに EDS マッピング操作で必要なドリフトフリーシステムを EDS システムの標準装備として組込み微量元素分布の観察を可能にしています(図12)。
 |
| 図 12 STEM 明視野像(BFI)/暗視野像(DFI)とEDSを使用した元素マッピング像 |
| 試料 : 64M DRAM 暗視野像におけるコントラストは元素質量に依存し重元素であるWが明瞭に観察できます。EDSマッピング法により、微量元素の分布が得られます |
Imaging PEELS、PEELS
取り付け可能
半導体材料の化学的結合状態の分析を目的とした Imaging PEELS、PEELS を装置の底部に取付けることが可能です。
まとめ
SEM を操作していた人にとっては TEM、STEM という機能はなじみが薄いかもしれません。しかし、半導体デバイスの微細化に伴って高分解能像を観察する手段としては今や不可欠な機能となってきており、研究所レベルの一部の専門オペレータによって操作されていました。
しかし、JEM-2500SE は『素早く結果が得られ、それを製造プロセスへ迅速にフィードバックする』という高スループット機能を実現するため上記の特徴を備え、あらゆる人にナノレベル領域における高分解能 TEM、STEM、SEI のそれぞれの像をワンタッチ操作で得ると共に高感度分析結果を得ることを可能にし、微細化が進む半導体デバイスをはじめとした微細構造評価装置として十分適合した装置です。
参考文献
1. ITRS: International Techology Roadmap for Semiconductor (Nov. 1999)
