半導体ウェハの欠陥評価 極低温測定の重要性
ER240003
はじめに
半導体を組み込んだデバイスが様々な電子製品部品として利用されています。その性能を左右するのが、半導体製造の際に生成する恐れのある欠陥です。不対電子が存在する欠陥は常磁性を持つため、ESRによる評価が可能であることが知られています。 図1は、シリコンウエハーを測定して得られる典型的なESRスペクトルです。同定のパラメーターとして、g=2.0058、線幅:0.56 mT が示されています。この信号強度が小さいウェハーほど、欠陥が少なく高性能のデバイスが作成できると予測されます。
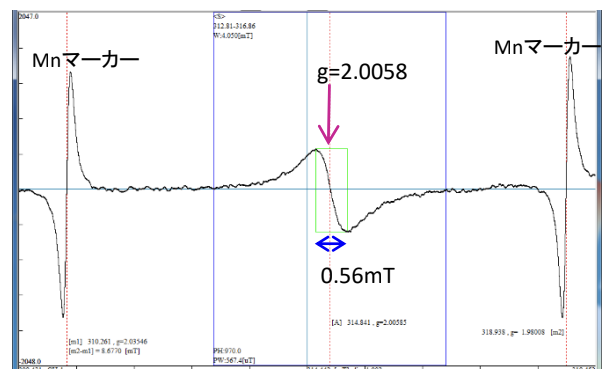
図1 シリコンウェハーに観測される欠陥のESRスペクトル
測定温度決定の重要性
半導体ウェハーの測定の場合、測定温度の設定が重要です。ESRは絶対温度に反比例して信号強度が増加するため、高感度に測定するためには試料温度を下げることが有効です。
ただ、欠陥が比較的多い試料では温度設定に注意が必要です。温度によっては、格子の熱運動は抑制されるものの欠陥の不対電子の運動性を抑えるには不十分となるケースがあるためです。この場合不対電子のふるまいが伝導電子的になり、マイクロ波のロスを引き起こして感度低下につながってしまいます。そのためには更に温度を下げ、不対電子を欠陥に局在化させると測定が可能となります。このような評価には、低温測定用アタッチメントである液体ヘリウム使用の温度可変装置 (最低到達温度 : 2.5K)を使用し、極低温測定を行う必要があります。
マイクロ波ロスの温度依存性の例
高感度なESR測定のためにはマイクロ波の調整が重要です。これはディスプレイ上のオシロスコープに表示される Qディップの形状でモニターできます。Qディップが、深くかつシャープになるよう調整するのが大切ですが、伝導電子が多い試料ではマイクロ波のロスが高まり十分に調整することができません。図2に例として、あるシリコンウェハ測定の際のマイクロ波ロスを、Qディップの形状として観察した結果を示します。試料温度を 100K, 50K, 25K, 10K として、マイクロ波調整後のQディップを示しました。
100KではQディップが極めてブロードになってしまいました。50Kでもかなりブロードであり測定は困難と判断されました。温度を25Kに下げるとかなり良好な形になり、10KではQディップがよりシャープになりました。更に 4Kでも良好なQディップが得られましたので、3点の極低温で測定して得られた信号強度を、4Kの場合を100%として図3に表示しました。
概ね絶対温度の逆数に比例して、高感度化できることが示されました。

図2 シリコンウェハーのQディップ形状の温度依存性の例
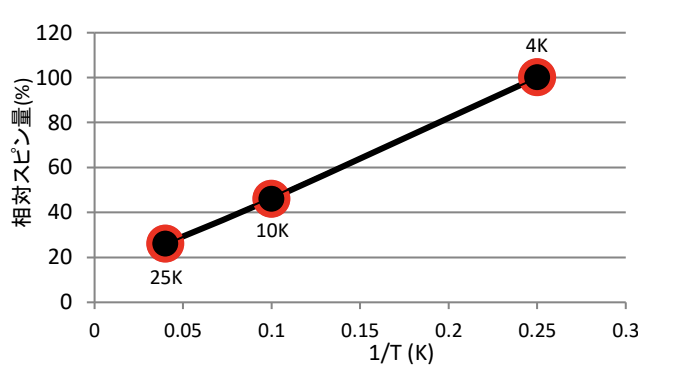
図3 シリコンウェハーの欠陥信号強度の温度依存性
試料調製上の注意
上記で扱った試料はシリコンウェハー単体です。
種々の酸化膜等の評価を行うにあたって、何らかの担体上に製膜して試料とする場合には、担体として高抵抗タイプのものを選択すると観測しやすくなります。低抵抗タイプでは伝導電子が多すぎるため、極低温でもマイクロ波のロスが大となり信号が得られない恐れがあるためです。

