マニュピレーターの応用 ナノプロービングと故障解析
SM2024-01
走査電子顕微鏡(SEM)の試料室内で微細なプローブを半導体素子の回路に直接接触させるナノプロービング装置(図1)は、半導体素子の評価、故障個所の特定や故障原因の把握をするために用いられます。半導体素子中にあるトランジスタの電極へプロービングすれば、そのトランジスタのIV特性を評価できます。また、電子線誘起電流(Electron Beam Induced Current:EBIC)を可視化したEBIC像を取得することにより、半導体素子のpn接合部の空乏層の位置を可視化できます。更に、半導体素子中の配線へプロービングした状態で、配線に流れる吸収電流(Electron Beam Absorption Current: EBAC)像を取得することによって、配線のショートやオープン箇所を可視化することもできます。これらの測定では、特に適切な加速電圧の設定が重要になります。例えば、トランジスタへの電子線入射によるIV特性の変化を防ぐため、低加速電圧下のプロービングが要求されます。近年、低加速電圧でのSEMの分解能と信号検出量の向上により、加速電圧1kV以下においてもプロービングが行うことが可能になりました。
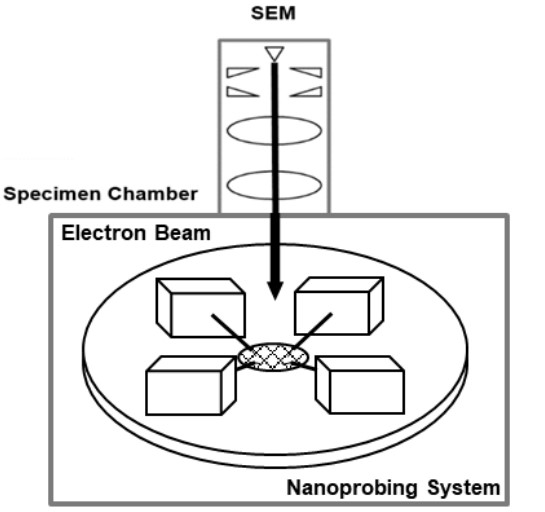
図1 ナノプロービング装置の模式図

図2 半導体素子(SRAM 22 nmノード)へのナノプロービング
試料 SRAM 22 nmノード、コンタクト層まで剥離済み
SEM
日本電子製 ショットキー放出型走査電子顕微鏡 JSM-IT800<i>
加速電圧: 1 kV、検出信号: 二次電子プロービング装置
Imina Technologies社 Nanoprobing Solution with integrated Point Electronic EFA module
ナノプロービングによるトランジスタのIV出力特性
図2のように半導体素子中の単一トランジスタにプローブを接触させた後、トランジスタの出力特性評価を行います。図3は、SRAMのトランジスタにナノプロービングすることによって得られたトランジスタの出力特性の例を示しています。
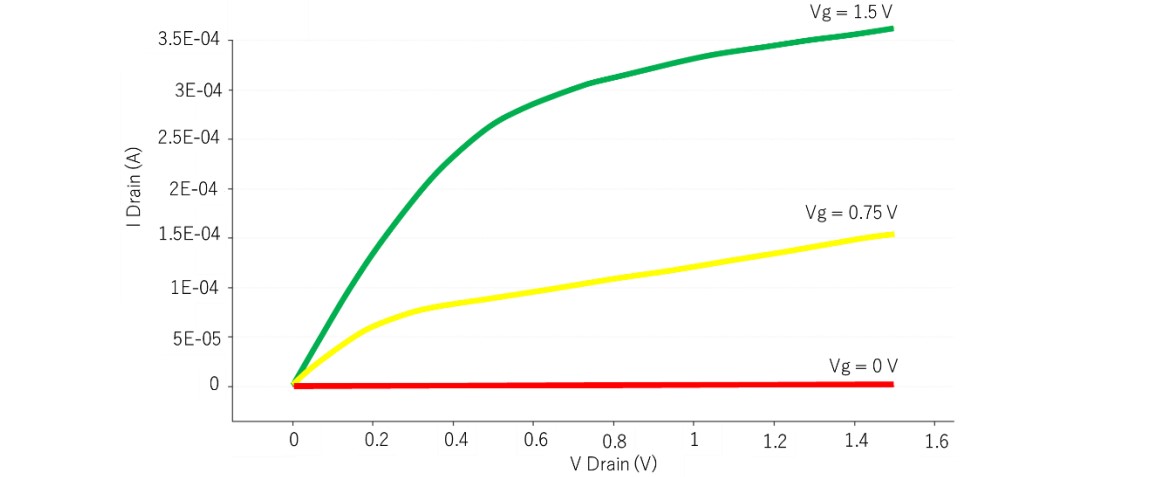
図3 SRAMのトランジスタへのIV出力特性
電子線誘起電流(Electron Beam Induced Current: EBIC)
半導体デバイスのpn接合部に生じる空乏層に入射電子を照射した場合、電子が非弾性散乱する過程で電子-正孔対が誘起されます。
このとき空乏層内の内蔵電位によって電子と正孔は分離されドリフトします。この過程で発生する電流をEBICと呼びます。このEBICを像として取得するためにトランジスタと繋がる電極などにプロービングし、電流を測定することでEBICを可視化する事ができます。図5は半導体チップ表面の二次電子像にEBIC反応を重ね合わせた合成像です。赤で示されているのがEBIC反応です。このEBICと二次電子像等のSEM像と重ね合わせることによりpn接合の位置や拡がりを確認することができます。

図 4 EBIC発生の模式図
(a) pn接合部の空乏層と内蔵電位
(b) 電子ビーム照射により誘起される電子-正孔対
(c) EBICの発生とプロービングによる検出

図 5 半導体素子の表面方向から得られたEBIC
コンタクト下部トランジスタのP+とN-well間のPN接合部で発生したEBICを可視化している。
試料 シリコンセンサーチップ
SEM
日本電子製 ショットキー放出型走査電子顕微鏡 JSM-IT800<i>
加速電圧: 10 kV、照射電流: 3 nA、検出信号: 二次電子とEBICの合成プロービング装置
Imina Technologies社 Nanoprobing Solution with integrated Point Electronic EFA module
電子線吸収電流(Electron Beam Absorption Current: EBAC)
電子線を試料に照射した際に弾性もしくは非弾性散乱を繰り返す過程で、一部の電子は試料に吸収されます。そして、試料に導電性があれば試料に電流が流れます。この電流をEBACといいます。このEBACは配線にプロービングし、プローブを経由してアンプに流れてくる電流を増幅することで、プローブとつながっている配線を可視化することができます。これにより、配線のショートを含む高抵抗箇所やオープン箇所を特定する事ができます。図6はプロービングした2か所の配線の間に高抵抗の欠陥箇所があった場合に得られるEBAC像のコントラストから、その欠陥箇所を検出する方法について示しています。プローブのひとつを電気的に接地させ、もうひとつをアンプへ接続します。この場合、高抵抗箇所からアンプ側のプローブが接している箇所で発生したほとんどの電流は、アンプで検出されます。しかし、高抵抗箇所から接地されたプローブが接している箇所で発生したほとんどの電流は、接地側へ流れます。したがって、アンプで検出する電流は小さくなります。このアンプで検出する吸収電流の変化から高抵抗箇所を特定できます。図7は、配線中のオープン箇所を二次電子像とEBAC像の合成像から検出した例です。

図6 EBAC像による配線内の高抵抗箇所検出方法
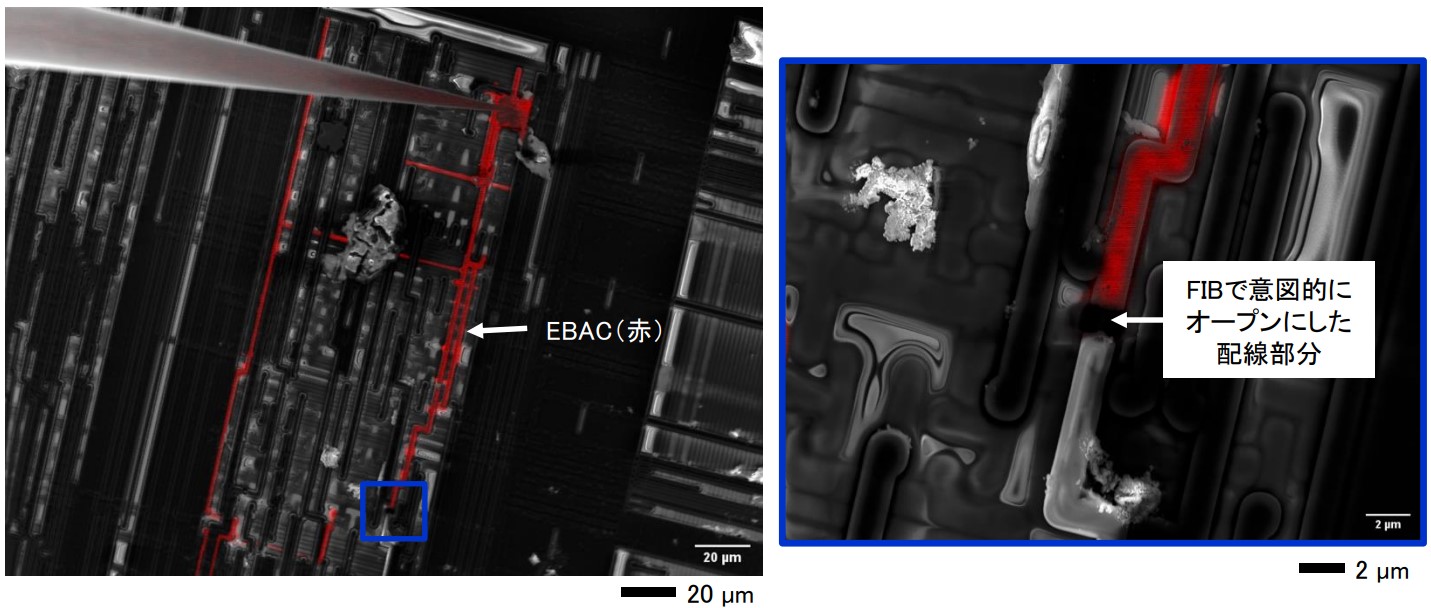
図7 EBACによる配線内のオープン箇所(高抵抗箇所)検出例
Passivation層に穴を開け、W(タングステン)を埋め込み済み。そのW部をプロービングして、電流アンプにつないでいる。また画面外でもうひとつのプローブを試料中のグラウンドパッドにプロービングしている。画面上のプローブとつながっている配線を可視化している。
試料 層剥離未処理の半導体チップ(Passivation層あり)
SEM
日本電子製 ショットキー放出型走査電子顕微鏡 JSM-IT800<i>
加速電圧: 10 kV、照射電流: 3 nA、検出信号: 二次電子とEBACの合成プロービング装置 Imina Technologies社 Nanoprobing Solution with integrated Point Electronic EFA module
